Как выбрать гостиницу для кошек
14 декабря, 2021
На основные фотоэлектрические параметры солнечных элементов, такие, как вольт-амперная характеристика и спектральная чувствительность, влияют как оптические, так и электрофизические свойства полупроводника. Лишь детальный анализ позволяет определить, чем^ вызванзг недостаточно высокая эффективность данного солнечного элемента. Однако для этого прежде всего необходимо измерить основные его характеристики, что даст возможность понять причины возникновения, природу и преобладающий вид потерь.
Вольт-амперная характеристика
 |
 |
|
Уже в первых работах, посвященных теории и экспериментальному изучению свойств солнечных элементов, было показано, что вольт — амперная характеристика солнечного элемента отличается от вольт — амперной характеристики полупроводникового диода появлением члена /ф, обозначающего собой ток, генерируемый элементом под действием освещения, часть которого /д течет через диод, а другая часть / — через внешнюю нагрузку:
обычная темновая характеристика, в которой /0 — обратный ток насыщения р—«-перехода; д — заряд электрона; Т — абсолютная температура; К — постоянная Больцмана; [/ — напряжение. При разомкнутой внешней цепи, когда ее сопротивление бесконечно велико и 7=0, по уравнению (1.14) можно определить напряжение холостого хода солнечного элемента:
Uxx=ln (h/Io+i)KT/q.
Для реального солнечного элемента характерно наличие последовательного сопротивления /?п, которое складывается из последовательно включенных сопротивлений контактных слоев, сопротивлений каждой из р — и п-областей элемента, переходных сопротивлений
2ММ Колтун
металл—полупроводник, а также шунтирующего сопротивления НШ1 отражающего возможные поверхностные и объемные утечки тока по сопротивлению, параллельному р—и-переходу. Учет этих сопротивлений и рекомбинации в р—тг-переходе приводит к развернутому
 Рис. 1.17. Эквивалентная (а) и измерительная (б) электрические схемы солнечного элемента
Рис. 1.17. Эквивалентная (а) и измерительная (б) электрические схемы солнечного элемента
 |
 |
|||
выражению для вольт-амперной характеристики, в которое введен коэффициент А:
|
r. r г (________ 4(V+IRa) * -*0 1 ®Хр ^ I |
Уравнение (1.16) можно записать в более удобном для практического использования виде:
ентную и измерительную схемы
геристик по формуле (1.17) [67] лияние последовательного и шун — ойства солнечных элементов Рены на рис. 1.18. Выходная мощенного элемента, может быть оце — ффициентом заполнения вольт-ам — ает степень приближения формы ^ прямоугольной: £^0,8—0,9 озна- <ой выходной мощностью. У совре — элементов коэффициент £ обычно 1 шунтирующего сопротивления от лого, как і? ш=100 Ом, сравнитель — ьт-амперной характеристики (см. входную мощность солнечного эле — з изменение последовательного содо 7?п=5 Ом, приводит к резкому эй характеристики и значительно-
I.
В дальнейшем как световая, так и темновая вольт-амперные характеристики солнечного элемента подверглись еще более детальному анализу. Было обнаружено, что в зависимости от уровня напряжения механизм протекания обратного тока насыщения через р—п-переход меняется. Как правило, этот ток представляет собой сумму двух токов. В связи с этим предложено записывать уравнение вольт-амперной характеристики солнечного элемента в следующем виде [68]:
—l) + /02(expги)~ 1)~“
где /о! — обратный ток насыщения, определяемый диффузионным механизмом протекания тока через тонкий р—/г-переход [69]; 102 — обратный ток насыщения, возникающий вследствие рекомбинации в области р—^-перехода [70], при этом обычно коэффициент А =2.
Разработан ряд достаточно точных методик, позволяющих по измеренным световым и темновым вольт-амперным характеристикам солнечных элементов рассчитать значения /0, і? п, коэффициента А [15, 16, 21, 71] и выявить тем самым физические процессы, приводящие к недостаточно высокой эффективности солнечных элементов из определенного полупроводникового материала.
На рис. 1.19 представлена типичная вольт-амперная характеристика: световая (измеренная на имитаторе внеатмосферного Солнца) ‘и темновая (измеренная с приложением внешнего смещения в темноте в прямом (IV квадрант) и обратном (II квадрант) направлениях). Часть световой характеристики, расположенной в I квадранте, и ее продолжение (IV квадрант) представляют собой прямую линию. Наклон этой прямой к оси токов характеризует последовательное сопротивление солнечного элемента
 |
пр с»
где At/np с и Д/Пр с измеряются в области, близкой к Uxx.
Часть световой характеристики в I квадранте и ее продолжение (II квадрант) тоже являются прямой линией. Наклон ее к оси напряжений характеризует собой шунтирующее сопротивление солнечного элемента
jRm — A U пр — с/Д/
где Д£/прс и А/др с измеряются в области, близкой к /кз.
В связи с тем, что на световой вольт-амперной характеристике наклон прямой около точки /кз измерить трудно, определение і? ш обычно проводят по наклону темновой вольт-амперной характеристики (штриховая кривая во II квадранте):
#ш= Д£^обр /А^обр •
Построение темновой характеристики позволяет также найти обратный ток насыщения /0. Отрезок на оси ординат от начала коор-

 |
 |
Рис. 1.19. Типичная вольт-амперная характеристика современного кремниевого солнечного элемента при измерении на имитаторе внеатмосферного Солнца
1 — световая,
2 — темновая
динат до точки пересечения с продолжением линейного участка обратной ветви темновой характеристики дает значение h.
Поскольку, однако, р—тг-переход солнечного элемента в рабочем режиме включен в прямом направлении (воздействие светового излучения, появление благодаря ему избыточного количества неравновесных носителей в областях полупроводника по обе стороны р—п-перехода аналогичны подключению напряжения в прямом направлении), правильнее определять ток насыщения, а также рас
считывать коэффициент А по прямой ветви темновой вольт-ампер — ной характеристики или по световой вольт-амперной характеристике (называемой также нагрузочной световой характеристикой элемента) .
Для первого из этих методов можно воспользоваться темновой характеристикой диодаг представляемой выражением (1.15), записав его в виде уравнения прямой в отрезках:
In (/« + /о) = In /о -j—акт ^*
%
Это уравнение применяется при расчетах только в случае больших токов (когда /д>/0), а также рекомбинационного механизма протекания обратного тока насыщения через р—^-переход [70], в связи с чем в знаменатель показателя экспоненты в уравнении (1 15) вводится, как уже указывалось, коэффициент А. Участок больших токов и напряжений (характерных для рабочей нагрузочной точки солнечного элемента) прямой ветви темновой характеристики используется для построения зависимости 1п/д=/(£/). Тангенс угла наклона этой прямой равен q/AKT, а отрезок, отсекаемый на оси ординат, дает значение 1п/0.
Имеется еще один метод определения /о и А в условиях, близких к рабочим условиям использования солнечного элемента. При этом методе световая вольт-амперная характеристика измеряется при нескольких (хотя бы двух) разных плотностях падающего излучения от имитатора Солнца.
Запишем уравнения (1.14) и (1.15) с учетом падения напряжения на последовательном сопротивлении и рекомбинации в р—п — переходе:
1=1 о (exp (q(U-IRn) /АКТ) -1) -7ф. (1.18)
В режиме ‘холостого хода 7=0, ії~ихх, а при Rn=0 фототок /* можно считать равным /кз. Тогда
In (IK3+I0)=lnh+qUxJAKT.
При каждом новом значении плотности потока излучения имитатора Солнца, устанавливаемом с помощью эталонного солнечного элемента с линейной зависимостью тока короткого замыкания от освещенности, измеряются значения /«з и Uxx исследуемого солнечного элемента. Строится зависимость 1п/кз от Uxx. Тангенс угла наклона этой прямой равен q/AKT, а на оси ординат ею отсекается значение In/о.
Таким образом, из световых вольт-амперных характеристик удается также определить параметры А и /0, причем именно те их значения, которые характерны для солнечных элементов в рабочем режиме
Уточненный и вместе с тем достаточно простой метод определения Ей, /?ш, А и /0 предложен в работе [71]. Необходимо изме-
рить вольт-амперную характеристику солнечного элемента лишь при •одном значении плотности потока излучения и затем вычислить: обозначаемую Р0 площадь под кривой зависимости £/=/(/), представляющей собой вольт-амперную характеристику; наклон кривой U=f(I) при /=0, определяющий tga=AKTIqIK3+Rn; площадь Pi под кривой зависимости мощности элемента IU от тока /. Последующий расчет производится по формулам, указанным в публикации [71].
Оптические излучения различных длин волн проникают на разную глубину (поскольку эта величина существенно зависит от энергии квантов) и создают свое пространственное распределение рожденных светом пар электрон—дырка (см. рис. 1.1, 1.2). Дальнейшая судьба рожденных пар зависит от их диффузионной длины в данном полупроводниковом материале. Если она достаточно велика, то созданные светом избыточные неосновные носители заряда успеют (даже без участия тянущего электростатического поля) только за счет процесса диффузии дойти до области р—тг-перехода и будут разделены его полем. Решающую роль в эффективности этой стадии преобразования оптического излучения внутри полупроводника играет соотношение между диффузионной длиной L и расстоянием от р—w-перехода Z, на котором создаются светом пары электрон — дырка.
Рассмотрим два крайних случая расположения р—/г-перехода в полупроводниковом кристалле по отношению к направлению падения оптического излучения: перпендикулярно (рис. 1.15, а) и параллельно (рис. 1.15,6). Условимся, что в первом случае свет проникает на всю глубину кристалла и Z равно толщине полупроводниковой пластинки, а во втором — освещается вся поверхность пластинки шириной d.
Очевидно, что эффективность собирания для перпендикулярного и параллельного расположений р—/г-перехода определяется соответственно соотношениями
1=(Ln+Lp)ll и 7=(L„+Lp)/d.
На первый взгляд параллельное расположение кажется более предпочтительным, ибо для полного собирания и разделения носителей наиболее существенным является распределение пар носителей в направлении, перпендикулярном р—/г-переходу: равномерная генерация носителей по глубине кристалла создает благоприятные условия для их диффузии к р—/г-переходу и последующего пространственного разделения. Разработанные на основе такого расположения р—/г-перехода по отношению к свету многопереходные матричные солнечные элементы, состоящие из большого числа микроэлементов, плоскости которых параллельны по отношению к падающему солнечному излучению (или расположены под небольшим углом к нему) действительно обладают высокой эффективностью собирания носителей в длинноволновой области спектра и позволяют получить значительную фото-ЭДС с единицы освещаемой поверхности [64, 65]. Однако расчетным и экспериментальным путем было установлено, что из-за весьма небольших размеров микроэлементов рекомбинация созданных светом пар на освещаемой поверхности играет при параллельном расположении р—/г-перехода относительно падающего излучения значительно большую роль, чем при
перпендикулярном. Вследствие этого для увеличения эффективности собирания в коротковолновой области спектра необходимо создать на обращенной к свету поверхности дополнительный слой, легированный примесью противоположного типа проводимости, т. е. использовать частично структуру с перпендикулярным расположением р—тг-перехода [66].
Если при параллельном расположении концентрация созданных светом пар М убывает от поверхности в глубь полупроводника как в п-, так и в p-области, то при перпендикулярном расположении это характерно лишь для обращенной к свету области кристалла, например тг-области, в то время как в p-области наибольшее количество пар образуется у р-п-перехода. Концентрация пар на глубине I подчиняется соотношению, полученному в результате дифференцирования выражения (1.3):
M=N0a exp (—аI),
где No—’число квантов, падающих на единицу поверхности полупроводника. Концентрация пар, уменьшающаяся в глубину полупроводника, может быть подсчитана для области поглощения полупроводникового материала с помощью зависимости а(Е) (см. рис. 1.1). Результаты таких расчетов для кремния, выполненных при нескольких значениях длины волны, показаны на рис. 1.16 15]. Вертикальные линии, ограничивающие области, определяемые диффузионной длиной носителей в материале п — и p-типа, позволяют наглядно оценить процесс собирания носителей заряда при перпендикулярном расположении р-п-перехода относительно падающего излучения (см. рис. 1.15,а).
Ординаты точек на построенных кривых пропорциональны аехр (—а/), абсциссы — расстоянию в глубь полупроводника от освещаемой поверхности, площадь между осями и каждой из кривых — потоку падающих квантов, а площадь, ограниченная кривой и ординатами, соответствующими 1=1Л+Ьп и 1=1Л—ЬР (заштрихованная часть),—току короткого замыкания кремниевой пластинки с р—га — переходом.
Таким образом, отношение заштрихованной площади к общей площади под кривой дает возможность в соответствии с соотношением (1.13) определить эффективность собирания f (при условии, конечно, что квантовый выход фотоионизации |}=1).
Планарная конструкция солнечных элементов, изображенная на рис. 1.15, а, стала основной и получила наибольшее распространение. Такие солнечные элементы были созданы из самых разнообразных материалов, причем направления оптимизации этой конструкции можно легко определить, анализируя результаты расчетов, аналогичные выполненным для кремния и представленным в графической форме на рис. 1.16.
Очевидно, что для повышения | и /кз необходимо увеличивать диффузионную длину неосновных носителей заряда по обе стороны
 |
|||
-у——■’ 1 1 ..
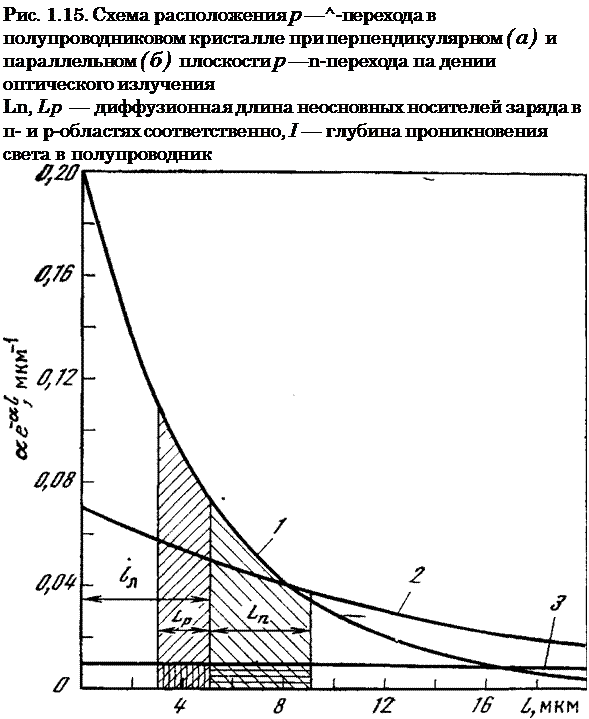 Рис, 1.16. Распределение числа созданных оптическим излучением пар электрон—дырка по глубине кремния при падении излучения разной длины волны перпендикулярно плоскости р— п-перехода
Рис, 1.16. Распределение числа созданных оптическим излучением пар электрон—дырка по глубине кремния при падении излучения разной длины волны перпендикулярно плоскости р— п-перехода
2 — 0,619 мкм,
а = 2000 см-1,
2 — 0,81 мкм, а = 700 см-1;
3 — 0,92 мкм, а = 90 см-1
р—w-перехода (Ln и Lp), что может быть достигнуто выбором соответствующих исходных материалов и сохранением высоких значений L в процессе изготовления р—п-перехода. При невозможности увеличить L в области полупроводника, примыкающей к освещаемой поверхности {Lp на рис. 1.15), необходимо приблизить р—п — переход к освещаемой поверхности, чтобы удовлетворялось соотношение Lp>ln, где 1Л — глубина р—тг-перехода, и все созданные светом носители заряда могли быть собраны и разделены полем р—п — перехода. Современные технологические методы обеспечивают малую глубину р—и-перехода [5, 13, 21].
Подобное же условие следует выполнять и для базовой области солнечного элемента (расположенной за р—^-переходом). Толщина
![]()
солнечного элемента, определяемая в основном базовой областью, не должна быть меньше глубины проникновения в полупроводник излучения длинноволновой части фотоактивной области спектра (энергия квантов Av>£g), а диффузионная длина неосновных носителей заряда в базовой области должна соответствовать толщине элемента и глубине проникновения света.
Измерение тока короткого замыкания солнечного элемента одновременно с исследованием спектрального состава ц плотности падающего на элемент оптического излучения позволяет сделать вывод об эффективности различных стадий процесса преобразования излучения в электрическую энергию, происходящих внутри элемента.
Прежде всего, конечно, полезно условиться о том, по отношению к какому — падающему или поглощенному —- потоку излучения производится оценка рассматриваемых процессов. В пределах линейной зависимости тока короткого замыкания солнечного элемента от плотности потока излучения справедливо соотношение
/кз2(М=^кзі(Я)/(1~г(Я)),
где /кз2(Я), Ікзі(К) —ток короткого замыкания солнечного элемента при заданной интенсивности соответственно поглощенного и падающего излучения; г(X) — коэффициент однократного отражения. Все три величины отнесены к одной и той же определенной длине волны.
Для нахождения г(Х) необходимо знать п и А;, а в области основной полосы поглощения, где к мало, достаточно иметь лишь данные о показателе преломления п. Для сравнительно малоизученных полупроводников, когда известно только значение ширины запрещенной зоны Eg и оптические константы еще не определены, можно воспользоваться для вычисления п эмпирическим правилом Мосса [25]:
Egnk—173.
Весьма полезна для анализа и оценки качества солнечного элемента такая характеристика, как спектральная зависимость тока короткого замыкания элемента, рассчитанная на один квант поглощенного света. Эту величину обычно называют эффективным квантовым выходом солнечного элемента (>Эф. Если N0 — число квантов, падающих на единицу поверхности полупроводника, то
![]() фэф — /к S2/N
фэф — /к S2/N
где Іц з 2 измеряется в электронах в секунду, а фэф выражается в электронах на квант (фотон).
Эффективный квантовый выход элемента зависит от двух параметров:
&Ф=Рї, (1.12)
где р — квантовый выход внутреннего фотоэффекта, определяемый числом пар электрон—дырка, создаваемых внутри полупроводника каждым поглощенным квантом за счет процесса фотоионизации; 7 — эффективность собирания носителей (или, иначе, коэффициент разделения носителей) потенциальным барьером р—«-перехода, показывающая, какая часть из общего числа пар, созданных оптическим излучением, участвует в формировании тока короткого замыкания солнечного элемента при подключении внешнего регистрирующего прибора.
Принято считать квантовый выход фотоэффекта равным единице, если каждый поглощенный квант создает одну пару электрон — дырка. Результаты выполненных с высокой точностью измерений квантового выхода внутреннего фотоэффекта для кремния представлены в работе [61] и подробно обсуждены в публикации [62]. Для этих измерений была собрана прецизионная установка, позволявшая одновременно измерять ток короткого замыкания полупроводниковых кристаллов с р—/г-переходом и суммарное (диффузное + зеркальное) отражение от их поверхности. Спектр падающего на кристалл оптического излучения измерялся с помощью зеркального монохроматора, для создания заданной температуры кристалла применялись криостат и электрическая печь, а для определения энергии квантов — калиброванный термостолбик. Отраженное от поверхности кристаллов излучение в видимой и ультрафиолетовой областях спектра (до длины волны 0,254 мкм) регистрировалось
1.4. Преобразование излучения в электроэнергию ■ 11 1 -■■■- … ……………………………….. " 1 ………….. ………………… — — ……………………………. …….. ……… ■■■
пластинкой с люминофором и установленным за ней фотоумножителем.
Квантовый выход внутреннего фотоэффекта рассчитывался па формуле
{*=/к31/(1-г)дЛ^, (1.13)
где q — заряд электрона, поскольку /к 31 выражен в энергетических единицах.
Эти измерения^ были выполнены на кристаллах с р—я-переходом, в которых фотоэлектрический эффект обнаруживается сразу — па генерируемому в цепи току без приложения внешнего смещения. Обеспечивались условия, когда эффективность собирания носителей 7=1 (или но крайней мере сохраняет постоянное значение во всем использованном диапазоне спектра), чтобы при расчете можно было пользоваться формулой (1.13). В связи с этим для экспериментов выбирались кристаллы с большой диффузионной длиной неосновных носителей заряда в верхнем легированном слое Ьл, Глубина залегания р—/г-перехода 1Л была небольшой, и соблюдалось условие ЬЛ>1Л. К тому же эксперименты проводились только в видимой и ультрафиолетовой областях спектра.
В результате анализа полученных экспериментальных данных был сделан вывод, что в широком диапазоне энергии падающих квантов (EgChv<2Eg) квантовый выход, обусловленный фотоионизацией, р в кремнии равен единице. При большой энергии квантов падающего излучения (fev>2£*, т. е. в ультрафиолетовой области спектра) начинал резко возрастать, что, вероятно, объясняется процессом ударной ионизации — возникновением вторичных пар электрон—дырка за счет избыточной кинетической энергии первичных пар.
Таким образом, можно считать, что первый акт взаимодействия оптического излучения с полупроводником (внутри кристалла) происходит практически без потерь, с эффективностью, близкой к 100 % г в широкой области спектра. Однако в большинстве полупроводников, использующихся для создания солнечных элементов, несмотря на равный единице квантовый выход фотоионизации (а также при 7>1 в ультрафиолетовой области) с увеличением энергии квантов возрастают потери в расчете на энергию одного кванта "в силу конечного значения ширины запрещенной зоны обычного полупроводникового материала [63]. Переход к солнечным элементам более — сложной структуры, например на основе каскадных систем, или к элементам с контролируемым градиентом ширины запрещенной зоны по глубине (большой у поверхности полупроводника и уменьшающейся в глубь материала, что отвечает спектральной зависимости коэффициента поглощения) позволяет полностью избавиться от таких оптических и энергетических потерь и увеличить КПД преобразования солнечного излучения в электрическую энергию.
Полупроводниковый, например кремниевый, солнечный элемент наиболее распространенной конструкции представляет собой систему из двух полупроводниковых слоев с проводимостями р — и /г-типа, находящихся в тесном контакте друг с другом. Переходная зона (граница) между областями с противоположными типами проводимости располагается внутри полупроводникового материала и называется электронно-дырочным или р—н-переходом (ранее чаще именовавшаяся запорным слоем).
В состоянии равновесия уровень Ферми во всем материале должен быть одинаковым [9—11]. Это условие обеспечивается двойным заряженным слоем в области р—п-перехода, получившим название слоя объемного заряда, и сопровождающим его электростатическим потенциалом (рис. 1.14). Высота потенциального барьера равна разности положений дна зон проводимости материалов п — и р-типов. Следует отметить, что положение уровня Ферми и, следовательно, высота барьера зависят от температуры и концентрации примесей в полупроводниковом материале по обе стороны р—п-перехода, что, с одной стороны, открывает широкие возможности по направленному изменению свойств р—п-переходов, а с другой — определяет достаточно сильную температурную зависимость его оптических и фотоэлектрических характеристик [5, 6].
Оптическое излучение, падающее на поверхность полупроводниковой структуры с р—тг-переходом, создает (в основном вблизи поверхности) пары электрон—дырка, причем концентрация пар постепенно спадает от поверхности в глубь полупроводника по направлению к р—п-переходу. В том случае, когда расстояние от поверхности до р—н-перехода меньше глубины проникновения света 1/а, пары электрон—дырка создаются и за р—п-переходом. Если переход отстоит от места возникновения пар на расстоянии, меньшем диффузионной длины, то они вследствие диффузии подойдут к р—п — переходу и разделятся под действием его поля. Электроны перейдут в электронную, а дырки—в дырочную часть перехода. На внешних металлических электродах, соединенных с р — и n-областями полупроводника, появится разность потенциалов, которая вызовет ток через нагрузочное сопротивление [12—16].
Диффундирующие к р—п-переходу неосновные избыточные носители тока будут разделяться благодаря наличию потенциального барьера. Скопление избыточных (разделенных переходом) электронов в п-области и дырок в p-области фотопреобразователя приводит к компенсации объемного заряда, Сосредоточенного у р—тг-перехода, т. е. к созданию электрического поля, противоположного по направлению к существующему.
Таким образом, одновременно с появлением разности потенциалов на внешних электродах вследствие освещения происходит изменение и потенциального барьера, существовавшего в неосвещен-
Рис. 1.14. Структура энергетических зон полупроводника в области неосвещенного р_—гс-перехода (а) и распределение электростатического потенциала (б)
 21 — ширина области объемного заряда запорного слоя; Ue — равновесный электростатический потенциал на границе п — и p-областей; Eg — ширина запрещенной воны; штриховая линия — равновесное положение уровня Ферми
21 — ширина области объемного заряда запорного слоя; Ue — равновесный электростатический потенциал на границе п — и p-областей; Eg — ширина запрещенной воны; штриховая линия — равновесное положение уровня Ферми
![]() ном р—и-переходе. Возникающая фото-ЭДС & уменьшает этот барьер, что в свою очередь
ном р—и-переходе. Возникающая фото-ЭДС & уменьшает этот барьер, что в свою очередь
приведет к возникновению встречных потоков (дополнительно к существовавшим в
равновесии) электронов из электронной и дырок из дырочной частей. Эти потоки практически равноценны току в прямом направлении, возникающему под действием приложенного к р—п-переходу электрического напряжения. Таким образом, с момента начала освещения ро мере накопления избыточной (по сравнению с равновесной) концентрации электронов в электронной части р—тг-перехода и дырок в дырочной происходит уменьшение высоты барьера, или электростатического потенциала UE (см. рис. 1.14), что вызывает увеличение тока во внешней нагрузке и возрастание плотности встречных потоков электронов и дырок через р—н-переход. Когда число создаваемых светом избыточных пар сравняется с числом пар, уходящих через р—п-переход или во внешнюю нагрузку, установится стационарное состояние. Как правило, это происходит через тысячные доли секунды после начала освещения [17, 18].
Фотоэлементы, основанные на фотоэффекте в полупроводниковых структурах с запорным слоем, так называемом вентильном фотоэффекте, непосредственно превращают падающее на них оптическое излучение в электрическую энергию, являясь, таким образом, ее генераторами, и в отличие от фотосопротивлений и фотоэлементов с внешним фотоэффектом не нуждаются в источнике внешнего напряжения.
Начиная с открытия в середине прошлого века фотоэлектрических свойств селена и создания в конце прошлого и начале нашего столетия на основе" селена и гетеросистемы медь-закись меди первых фотоэлектрических преобразователей светового излучения в небольшие электрические сигналы, делались неоднократные попытки повышения КПД таких преобразователей и превращения их в источник электрической энергии значительной мощности. Усовершенствование технологии, а также применение оптических фильтров позволили получить селеновые фотоэлементы, спектральная чувствительность которых практически повторяла кривую чувствитель
ности человеческого глаза. Улучшенные селеновые ‘фотоэлементы нашли широкое применение в качестве фотоэкспонометров в фото — и киноаппаратуре. Однако коэффициент полезного действия фотоэлементов не поднимался выше 0,5%. Успешное развитие фотоэлектрического метода преобразования энергии излучения началось лишь после создания зонной теории электронного строения полупроводников, разработки методов их очистки ж контролируемого легирования, выяснения той определяющей роли, которую играет запорный слой на границе полупроводников с противоположным типом проводимости. В 1954 г. появилось краткое сообщение о разработке кремниевого солнечного элемента с КПД около 6%, а в 1958 г. на борту советских и американских спутников Земли уже работали кремниевые солнечные батареи, снабжавшие электроэнергией электронную аппаратуру. За прошедшее время КПД солнечных элементов резко возрос, чему способствовали все лучшее понимание физических явлений, происходящих в солнечных элементах, создание все более совершенных технологических приемов их изготовления и разработка новых усовершенствованных конструкций элементов из разнообразных полупроводниковых материалов. В СССР особенно много для развития фотоэлектрического метода преобразования солнечной энергии сделали Н. С. Лидоренко, А. П. Ландсман, В. С. Вавилов, Ю. П. Маслаковец, В. К. Субашиев, А. М. Васильев, Ж. И. Алферов; в США — П. Раппопорт, М. Принс, Дні. Лоферский, М. Вольф, Г. Раушенбах, Дж. Линдмайер, Г. Брандхорст.
Большинство вентильных фотоэлементов, созданных в первые десятилетия развития фотоэлектричества,— селеновые, сернистогал — лиевые, сернистосеребряные, сернистомедные, германиевые и некоторые другие — используется по-прежнему в основном как индикаторы излучения. Кремниевые фотоэлементы/ а в последнее время и фотоэлементы из арсенида галлия и других широкозонных полупроводников благодаря высокому КПД, достигающему в настоящее время у лучших образцов 15—22% (а при использовании сложных каскадных систем на их основе даже 27—28% [60]), широко применяются как фотоэлектрические преобразователи солнечного излучения или солнечные элементы.
Фотоэлектрогенераторы для прямого преобразования энергии излучения Солнца в электрическую, собранные из большого числа последовательно и параллельно соединенных фотопреобразователей, получили название солнечных батарей. Современные солнечные батареи генерируют на свету значительную электрическую мощность и применяются как для питания радиосхем, средств связи, счетчиков космических частиц, так и для энергоснабжения большинства космических аппаратов и многих наземных автономных устройств различного назначения.
Оптические исследования тонких легированных слоев кремния и других полупроводников было бы значительно легче и точнее выполнять с помощью излучения, которое сильно поглощается материалом полупроводника. Таким, например, является ультрафиолетовое излучение с длиной волны 0,2—0,4 мкм, почти полностью поглощаемое слоями кремния толщиной всего 0,05—0,1 мкм. Однако изменение концентрации свободных носителей заряда в полупроводнике в очень широких пределах практически не влияет на его оптические свойства в коротковолновой области спектра [58]. Спектры отражения в ультрафиолетовой области помогли установить особенности зонной структуры полупроводников. Характерные для многих полупроводниковых материалов всплески отражения объясняются резким ростом показателя поглощения, что вызывается межзонными переходами при большой ширине запрещенной зоны в тех областях зависимости Е от к, где к^О [10, 11, 25],
С помощью спектров ультрафиолетового отражения также удается весьма тонко контролировать качество механической и химической полировки поверхности полупроводниковых кристаллов, что отчетливо видно из приводимых на рис. 1.11 и 1.12 спектральных зависимостей зеркального коэффициента отражения от глубины остающихся после полировки нарушений на поверхности кремния и арсенида галлия. Только после того, как глубина нарушений в результате дополнительной полировки становится меньше длины волны ультрафиолетового (0,2—0,4 мкм) и видимого (0,4—0,75 мкм) излучений, использованных при измерениях (выполненных на спектрофотометрах СФ-4, СФ-10, СФ-20, СФ-26), коэффициент отражения в этих областях спектра перестает изменяться (см. рис. 1.12).
Высокой эффективности оптического контроля способствует наличие пиков отражения, имеющихся у кремния и арсенида галлия в ультрафиолетовой области спектра. Например, контроль за состоя-
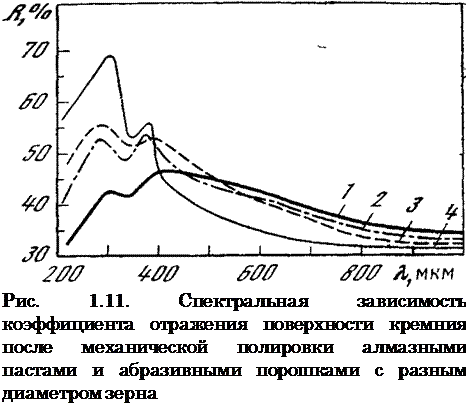 |
 |
J — 3 мкм; 2—1; 3—1; 4 — 0,1—0,2 мкм; 1, 2, 4 — время полировки 1ч; 3 — 2 ч
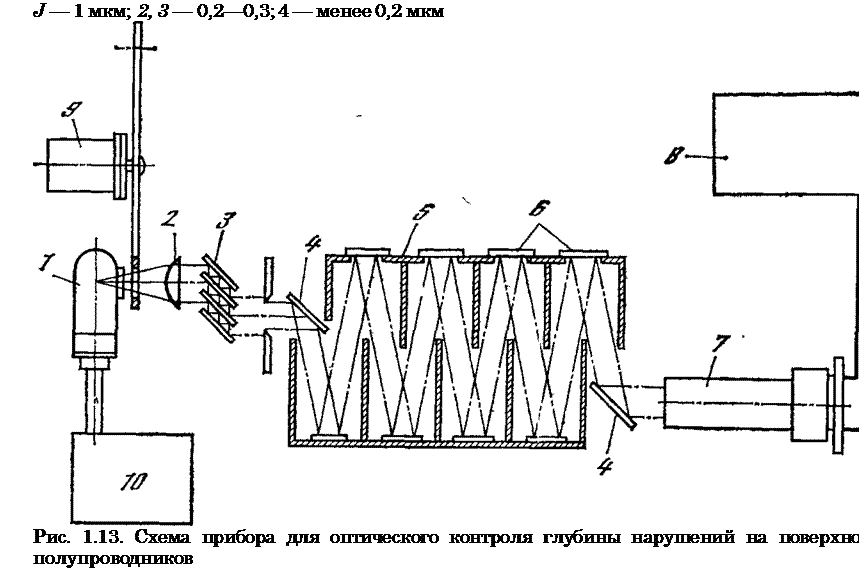 |
Рис. 1.12. Спектральная зависимость коэффициента отражения арсенида галлия после обработки в полирующем травителе и при оставшихся нарушениях ловерхности на разной глубине
1 — водородная лампа; 2 — кварцевая линза; 3 — фильтр из пластин кремния, обработанных окисью хрома; 4—плоские зеркала; 5 — корпус прибора с разделительными шторками; 6 — исследуемые пластины; 7 — фотоумножитель типа ФЭУ-57 или ФЭУ-39 с кварцевым входным окном; 8 — блок регистрации фототока; 9 — модулятор; ю — блок питания водородной лампы
нием поверхности кремния лучше вести при длине волны 0,28 мкм, где коэффициент отражения хорошо отполированного кремния достигает 70%. Для увеличения различия между коэффициентами отражения пластин с разной обработкой поверхности полезно воспользоваться прибором для наблюдения многократного отражения ультрафиолетового излучения от набора пластин с одинаковой обработкой поверхности (рис. 1.13) [59]. В этом же приборе другой набор хорошо отполированных пластин позволяет выделить из спектра источника ультрафиолетовое излучение с длиной волны 0,28 мкм, наиболее полезное для контроля состояния поверхности кремния.
Приборы, применявшиеся для контроля состояния поверхности, в которых выделение необходимого спектрального интервала осуществлялось с помощью кварцевых призм, дифракционных решеток, параболических и поворотных зеркал, более сложны по конструкция.
* * *
Таким образом, исследования спектров отражения как в ультрафиолетовой, так и в инфракрасной области дают возможность получить информацию об электрофизических и оптических свойствах кристаллов, в частности помогают оценить концентрацию свободных носителей заряда, качество обработки поверхности, степень отжига дефектов, параметры зонной структуры, в том числе ширину запрещенной зоны полупроводника и ее температурную зависимость.
Если отражение полупроводников в области основной полосы поглощения практически не зависит от степени легирования примесями, ионизирующимися при комнатной температуре, то в длинноволновой области спектра наблюдается резкий рост коэффициента отражения с увеличением количества таких примесей и, следовательно, концентрации свободных носителей в полупроводнике.
Отражение в инфракрасной области спектра
Взаимодействие излучения со свободными носителями тока можно ‘ рассматривать в рамках классической электромагнитной теории излучения [25, 32], приводящей к результатам, весьма близким к полученным квантовомеханической теорией дисперсии [33].
Теория и эксперимент. Диэлектрическая постоянная полупроводника, равная квадрату его комплексного показателя преломления в i = (n—iky, (1.6)
определяется концентрацией N и эффективной массой т* носителей заряда, зарядом электрона q и круговой частотой падающей волны со [25].
Раскрывая левую и правую части соотношения (1.6) и учитывая связь оптических и электрических свойств кристаллов, получим
![]() п2—к2=е і,
п2—к2=е і,
2пк==Апа/(д,
где а —проводимость; п и к — показатели преломления и поглощения полупроводника.
Анализ процесса электропроводности в переменном поле высокой частоты [32] приводит к следующим выражениям для проводимости о и диэлектрической постоянной вещества Єї:
0=Ад2/™*<т/(1+ш2т2)>, (1.8)
*
Єі=8о—4яХс (1-9)
при этом поляризуемость, усредненная по всем Бременам релаксации т и энергия^ свободных носителей, определяется выражением
%-_Nq2Im*< т7(1+(оЧ2)>. (1.10)
Если частота падающего излучения много больше величины 1/т и <от>1, то поляризуемость %с не зависит от т и может быть определена как
Хс ~ —Nq2/пг*ы2. (1.11)
Соотношения (1.6) — (1.11) впервые были использованы для определения эффективной массы носителей заряда оптическим методом [34]. Для определения концентрации носителей заряда использовался эффект Холла. Был исследован также спектральный ход показателей поглощения и преломления в инфракрасной области для сильнолегированного германия. Из полученных данных видно, что слагаемым к2 при расчете коэффициента отражения г (см. формулу (1.4)) можно пренебречь вплоть до длин волн порядка 15 мкм, причем это справедливо также и для других полупроводников, используемых для создания солнечных элементов.
С увеличением длины волны растет поляризуемость %с, подчиняющаяся соотношению (1.11), и уменьшается диэлектрическая постоянная в соответствии с (1.9). При достаточно большом значении Хс диэлектрическая постоянная может стремиться к нулю. Частота, при которой наступает это явление, получила название собственной частоты плазменных колебаний сор, и может быть рассчитана из следующего условия [32]:
е0=4я | Хс | =4 TcNq2/m*(op2, из которого легко получить соотношение
о)Р= (AnNq2/m*Bo)Ча
и, следовательно,
ХР= (яе 0c2m*/Nq2) v% где с — скорость света.
Явление плазменного резонанса происходит в области длин волн, где к2 мало и п также уменьшается, поскольку его изменение но-
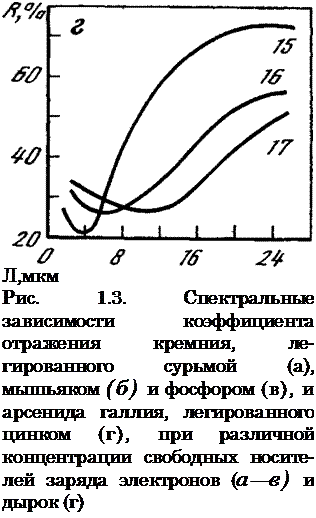 |
 |
 |
10 — 1,02* 1020;

 Л — 4,38* 10і9;
Л — 4,38* 10і9;
12 — 2,05 *1019;
13 — 1,27 1019;
14 — 7,4-І018;
15 — 1,5-1020;
16 — 3,2 10«;
17 — 1,7-101Э см-3 вторяет спектральный ход е4 в соответствии с выражением (1.7). Коэффициент однократного отражения г, определяемый по формуле (1.4), при малом значении к и 1 достигает минимального значения rmin, характеризующего на кривой спектрального отражения область плазменного резонанса.
Спектральные зависимости коэффициента отражения кремния, легированного сурьмой, мышьяком и фосфором, с концентрацией свободных носителей заряда (электронов) от 7,4 -1018 до 1,67 — •1020 см“3 [35], и арсенида галлия, легированного цинком, с концентрацией свободных носителей заряда (дырок) от 3,2* 1019 до 1,5* 1020 см”3 [36], представлены на рис. 1.3, где хорошо видны положение минимума плазменного резонанса на спектральных кривых отражения от поверхности кремния и арсенида галлия и зависимость длины волны минимального отражения от концентрации свободных носителей.
Значение Гшт определяется показателем поглощения Лс, так как при 1 коэффициент г тем меньше, чем меньше к (что видно из соотношения (1.4)). В свою очередь показатель поглощения зависит от времени релаксации, поскольку Оно влияет на проводимость. В то же время поляризуемость не зависит от т, а определяется зонной структурой и концентрацией свободных носителей.
Рис. 1.4. Зависимости концентра* ции свободных носителей заряда от длины волны плазменного минимума для p-Si (1) и n-Si (2)
 Точки — эксперимент
Точки — эксперимент
Рис 1.5. Ход лучей в спектрофотометрах ИКС-14 (а) и «Хитачи» (б) с приставками для измерения отражения
1 — источник излучения;
2 — держатель образцов;
3 — образец;
4 — малогабаритный термостат;
5 — плоские зеркала;
6 — вогнутое зеркало;
7 — монохроматор и приемник
излучения;
8 — эталонное алюминиевое зеркало
 |
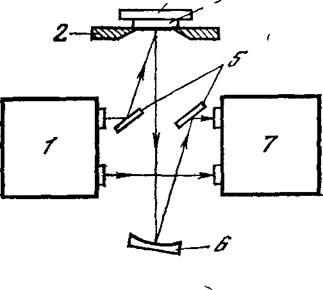 |
т
Поглощение света свободными носителями увеличивается с ростом длины волны, а повышение к приводит к возрастанию коэффициента отражения. Таким образом, спектральная зависимость коэффициента отражения легированных полупроводников проходит через минимум, что и было получено в эксперименте (см. рис. 1.3). Поляризуемость пропорциональна произведению NX С увеличением концентрации свободных носителей N то же значение поляризуемости (в частности, |хс|, при котором 1) может достигаться при меньших X. Именно поэтому при повышении концентрации свободных носителей спектральное положение Гщщ сдвигается в коротковолновую область, причем значение rm in при этом уменьшается, поскольку падает к.
Эта особенность спектров отражения легированных полупроводников в инфракрасной области может быть положена в основу простого оптического метода определения концентрации носителей N
из спектров отражения. Зависимости спектрального положения длины волны плазменного минимума для электронного сильнолегирован — ного кремния гс-типа (Xn-si) и дырочного p-типа (XP-si) от концентрации носителей (рис. 1.4) выражаются^аналитически в виде двух следующих соотношений [37]:
iVP=3,27 • 1021 Vsr2’11, iVn=6,29-1021 К-*Г2’*
хорошо аппроксимирующих экспериментальные данные. При этом концентрация носителей в эталонных образцах определялась по измерению слоевого сопротивления четырехзондовым методом с использованием кривых Ирвина, связывающих удельное сопротивление р — и и-кремния с концентрацией свободных носителей [31, 38]. Недостатком данного метода является сравнительно невысокая точность установления спектрального положения длины волны плазменного минимума для слаболегированных образцов.
Более сложные и точные методики определения концентрации подвижности и эффективной массы свободных носителей заряда по спектрам отражения легированных полупроводников описаны в работах [39—42]. В некоторых из них измеренные зависимости отражения сравниваются с эталонными кривыми в весьма широком спектральном диапазоне — от 1 до 25 мкм.
Исследование* спектров отражения от поверхности полупроводников дает возможность получить информацию не только об электрофизических свойствах кристаллов, но и о состоянии их поверхности, качестве химической и механической обработки. Это удается сделать, несмотря на то что из-за трудностей регистрации суммарного и диффузного отражения в инфракрасной области [43] измеряется, как правило, лишь зеркальная составляющая коэффициента отражения и ее температурная зависимость [44].
Методика измерений. Для измерения коэффициента отражения используется инфракрасный спектрофотометр, например отечественный марки ИКС-14 (диапазон спектра от 0,7 до 25 мкм), или японский марки «Хитачи» (измеряемый диапазон спектра от 2 до 50 мкм). Оба спектрофотометра в основном применяются для измерения коэффициента пропускания, а для измерения коэффициента отражения необходима установка специальных приставок [41, 45] между источником и приемником излучения (рис. 1.5).
Для проведения таких измерений удобна конструкция описанных в статье [44] держателя для образцов и малогабаритного термостата. Электрическая схема последнего основана на релейном принципе и может поддерживать любую заданную температуру в интервале 30—300° С с точностью ±2° С.
Измерения фонового теплового излучения исследуемых образцов показали, что даже в далекой инфракрасной области фоновое излучение при 200° С не превышает 14% от отраженного потока [44]. Фоновое излучение нагретого эталонного зеркала составляет менее 1% благодаря малой степени черноты пленок алюминия [46].

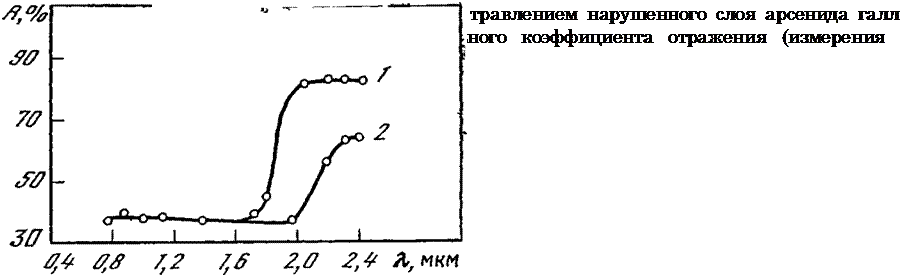 |
Рис. 1.6. Зависимость коэффициента отражения механически шлифованной поверхности арсенида галлия л-типа в инфракрасной области спектра до (1) и после удаления травлением внешнего слоя (2—5) различной толщины
Si—S5 — площади, ограниченные кривыми 1—5 на рис. 1 6

![]()
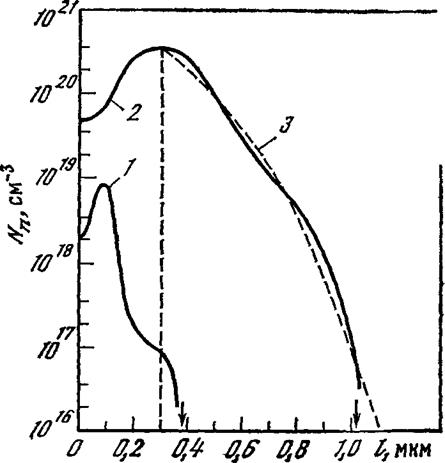 Рис. 1.9. Зависимость концентрации свободных носителей заряда в поверхностном легированном слое кремния, полученном бомбардировкой кремния p-типа ионами фосфора, от расстояния до поверхности
Рис. 1.9. Зависимость концентрации свободных носителей заряда в поверхностном легированном слое кремния, полученном бомбардировкой кремния p-типа ионами фосфора, от расстояния до поверхности
1 — до отжига, доза ионов фосфора
6 103 мкКл/см2;
2 — тот же образец после отжига
в течение 2 ч при 850° С;
3 — теоретическая кривая,
соответствующая диффузии примеси из бесконечного источника, расположенного на расстоянии 0,3 мкм от поверхности Стрелки указывают глубину залегания р—п-перехода
Оценка качества механической обработки поверхности полупроводников. Измерения спектров инфракрасного отражения при комнатной температуре, выполненные с помощью инфракрасных спектрофотометров, дают возможность оценить степень повреждений поверхности полупроводников при механической обработке, например, как это было сделано для арсенида галлия /г-типа [47] (конечно, для успешного осуществления подобного контроля необходимо, чтобы длина волны падающего излучения была соизмерима с глубиной нарушений йа поверхности). При этом контролировались сравнительно грубые нарушения, вызванные механической шлифовкой абразивом со средним диаметром зерна около 10 мкм, и для исследования был выбран диапазон спектра от 20 до 60 мкм.
В этой области на кривой отражения легированного арсенида галлия (рис. 1.6) наблюдаются два характерных минимума: при 20— 25 мкм (вызванный явлением плазменного резонанса излучения со свободными носителями заряда) и при 37—42 мкм (связанный с поглощением излучения из-за взаимодействия с тепловыми колебаниями решетки кристалла). После удаления слоя определенной толщины спектральная зависимость коэффициента отражения остается неизменной и совпадает с аналогичной зависимостью ненарушенного кристалла арсенида галлия /г-типа с такой же концентрацией примеси. Для удаления нарушенного слоя использовался травитель, состоявший из смеси серной кислоты, перекиси водорода и воды, а толщина удаляемого слоя определялась взвешиванием образцов до и после травления. Достаточно точно глубину нарушенного слоя на поверхности кристалла можно определить по зависимости площади, ограниченной кривой спектрального коэффициента отражения, от толщины удаленного чслоя (рис. 1.7). Площадь под кривой спектрального коэффициента отражения перестала возрастать после удаления нарушенного слоя глубиной 8,8 мкм. Глубина нарушений тем самым составляет около 0,9 от среднего диаметра абразивного зерна, использованного для механической шлифовки поверхности арсенида галлия.
Оценка температурной зависимости ширины запрещенной зоны. Использование малогабаритного термостата [44] дает возможность исследовать температурную зависимость коэффициента зеркального отражения от поверхности образцов, оценить изменение ширины запрещенной зоны полупроводников при росте температуры. Показанное на рис. 1.8 изменение спектрального отражения от внешней поверхности пластинки поликрист ал л ического германия р-типа с удельным сопротивлением 60 Ом-см и нанесенным на ее тыльную сторону отражающим слоем алюминия (испарением в высоком вакууме) [44] обусловлено температурным сдвигом края основной полосы поглощения германия.
Исследование свойств тонких сильнолегированных слоев полупроводников с помощью спектров отражения инфракрасного излучения не может привести к количественным результатам, когда глу-
бина проникновения излучения в материал полупроводника превышает толщину слоев. Это положение подтверждается при исследовании тонких р—тг-переходов, полученных бомбардировкой кремния ионами фосфора [48]. Методики, использованные в этих экспериментах, являются примером комплексного подхода к изучению свойств полупроводниковых структур. Были определены профиль концентрации свободных носителей заряда, глубина залегания р—п-пере — * хода и их изменение в процессе изотермического отжига.
Исследование тонких легированных слоев в солнечных элементах. В экспериментах использовался кремний p-типа с удельным сопротивлением р=1 Ом-см. Тщательно полированная поверхность, ориентированная по {1Н}, подвергалась бомбардировке сепарированным пучком ионов фосфора с энергией 30 кэВ дозой D=6-103 мкКл/ /см2. Профиль концентрации свободных носителей тока исследовался при последовательном удалении слоев кремния толщиной 160— 500 А анодным окислением в 0,04 N растворе азотнокислого калия в этиленгликоле [49]. Проводимость удаляемых слоев измерялась четырехзондовым методом. Пересчет к средней концентрации свободных носителей в удаленном слое велся с использованием данных работ [38, 50]. Общая глубина легированного слоя оценивалась по методу косого цилиндрического шлифа [51].
Коэффициенты пропускания и отражения в области спектра 1— 25 мкм определялись с помощью спектрофотометра ИКС-14 с использованием приставки для измерения коэффициента зеркального отражения (см. рис. 1.5, а).
Результаты электрических измерений. На рис. 1.9 (кривая 1) представлено распределение концентрации свободных носителей по глубине легированного слоя. У поверхности образуется относительно широкая область с отрицательным градиентом концентрации, максимум достигается на глубине около 0,12 мкм, после чего концентрация уменьшается до значения, соответствующего исходному кремнию. Ход кривой объясняется специфичностью профиля концентрации внедренных атомов [52] и радиационных дефектов: максимум концентрации сдвинут к поверхности [53—55]. Проведенные электронографические исследования поверхности кремния, подвергнутой бомбардировке ионами фосфора, обнаружили аморфизацию кремния вплоть до глубины 0,2 мкм, причем верхний слой толщиной 0,05 мкм из монокристаллического состояния перешел полностью в аморфное [48]. Количественная оценка средней по слою концентрации носителей тока (см. кривую 1 на рис. 1.9) дает значение порядка 1018 см~3, что примерно в 1000 раз меньше средней концентрации введенного фосфора (3-Ю21 см“3).
Уменьшение количества радиационных дефектов и увеличение концентрации электрически активных внедренных атомов фосфора, как известно, легко достигаются тепловым отжигом образцов (см. рис. 1,9, кривая 2). Глубина залегания р—тг-перехода увеличилась до 1 мкм. Участок кривой 2 от 0,3 до 1 мкм довольно хорошо они-
-сывается уравнением диффузии примеси из бесконечного источника в полу ограниченное тело [56]. Интегрирование кривой 2 показало, что в кремний из начального слоя толщиной 0,3 мкм продиф- фундировало 4,2% фосфора. По мере приближения к поверхности, так же как и до отжига, наблюдается уменьшение концентрации — свободных носителей тока. Электронограммы, полученные при последовательном удалении слоев, показали остаточные нарушения
 Рис 1.10. Зависимость коэффи-
Рис 1.10. Зависимость коэффи-
7/7
циента отражения кремния, /и легированного ионной бомбардировкой фосфором, при длине волны 19 мкм от темпера — ^ туры отжига
— 30
о т 7оо зоо % °с
монокристалличности до глубины 0,15 мкм, что подтверждает неполноту отжига, вследствие чего концентрация свободных носителей в этом слое не могла стать высокой.
![image023 Подпись: шающейся концентрацией свободных носителей. Этот вывод, сделанный на основании эксперимента, подтверждается расчетом. После подстановки в соотношение (1.5) Х= 19 мкм и /с—4,1 для легированного кремния [57] получим, что глубина проникновения света, на которой плотность потока излучения снижается в е раз, 1/а=0,4 мкм. Если учесть^ что в экспериментах концентрация свободных носителей в хорошо о Пожженных легированных слоях составляла 3-Ю20 см”3 [48], а в работе [57] приводится ^=4,1 для концентрации 2,9 -1019 см”3, то совпадение расчетных и экспериментальных данных по зависимости прозрачности легированного слоя в инфракрасной области от его толщины следует признать весьма хорошим.](/img/1199/image023_3.gif) |
Результаты оптических измерений. Была сделана попытка исследовать распределение концентрации свободных носителей в легированном слое по изменению коэффициента отражения в инфракрасной области спектра. Коэффициент отражения образцов, не подвергнутых отжигу после ионной бомбардировки, совпадает с коэффициентом отражения нелегированного кремния. В этом случае поверхностная концентрация свободных носителей iV^lO18 см”3, однако глубина залегания перехода настолько мала (0,2—0,3 мкм), что легированный слой оказывается в высокой степени прозрачным в окрестности Х—19 мкм. Это говорит о том, что для мелких р—п — переходов (глубина залегания <1 мкм) изменение коэффициента отражения при послойном снятии кремния не передает истинного распределения концентрации свободных носителей в легированном слое, так как значение коэффициента отражения обусловливается не только поверхностными, но и всеми нижележащими слоями с умень
Тем не менее проведенные измерения коэффициента отражения полезны. Например, они показывают, что при одинаковой глубине залегания перехода концентрация свободных носителей после теплового отжига выше при наличии пленки двуокиси кремния, препятствующей экзодиффузии фосфора.
Кроме того, по значению коэффициента отражения в инфракрасной области спектра можно судить о полноте отжига при выбранных условиях. На рис. 1.10 показано изменение коэффициента отражения при Я=19 мкм легированной ионной бомбардировкой фосфором (по описанному выше режиму) поверхности кремния после отжига в течение 2 ч при возрастании температуры отжига от 600 до 890° С. Чем выше концентрация свободных носителей в поверхностных слоях легированной области, тем больше коэффициент отражения: i?=30% при 7Vp=1016 см~3 и R—84% при Л^п=2,5-1020см~3.
В квантовой механике элементарные частицы, в том числе и электрон, рассматриваются одновременно и как волны. В связи с этим при описании движения элементарных частиц используются не только такие величины, как энергия Е и импульс р, но и, например, длина волны Л, частота v и волновой вектор к=р/Л, где Л —постоянная Планка. При этом E=hv и p=h/X. Зонную структуру кристалла часто представляют в виде диаграммы Е—к, используя при этом обычно значения энергии в электронвольтах, а волнового вектора к —в долях постоянной решетки кристалла, причем на оси к с помощью стрелок указываются направления кристаллографической ориентации, что позволяет достаточно полно отразить изменение зонной структуры в объеме кристалла.
Вид зависимости Е—к помогает понять также характер межзонных переходов в данном полупроводниковом веществе и, в частности, определить, являются они «прямыми» или «непрямыми» [10]. Если минимум зоны проводимости и максимум валентной зоны совпадают в k-пространстве, то переброс электрона через запрещенную зону за счет оптического или теплового возбуждения происходит вертикально, без изменения волнового вектора. Такие переходы называются прямыми. Если же экстремумы зон не совпадают и требуется изменение к, то в процессе переброса электрона должен участвовать посредник, например квант колебаний решетки — фонон или ион примеси, которые передадут электрону часть своей энергии. Подобные переходы получили название непрямых.
У многих полупроводников в силу сложного строения энергетических зон поглощение излучения носит смешанный характер: начавшись с непрямых переходов (в этом случае для переброса электрона — требуется меньше энергии и первоначально поглощаются фотоны небольших энергий), процесс поглощения при больших энергиях происходит уже исключительно за счет прямых переходов.
Следует отметить также, что’ значение ширины запрещенной зоны, определенное при измерениях оптического поглощения, зависит в значительной степени от концентрации свободных носителей заряда в полупроводнике, температуры и наличия в запрещенной зоне примесных уровней. Если состояния вблизи дна зоны проводимости и потолка валентной зоны заполнены носителями заряда, то оптические измерения дадут для ширины запрещенной зоны примесного полупроводника значения более высокие, чем для чистого собственного полупроводника. Если примесная зона слилась с краем ближайшей разрешенной зоны, что может произойти при сильном легировании, то ширина запрещенной зоны уменьшится. Сужение Её заметно скажется на положении края основной полосы поглощения {он сдвинется в длинноволновую область).
Коэффициент поглощения полупроводника а определяется условием, что энергия волны уменьшается в е раз на расстоянии, рав
ном 1/а:
![]() Ni=N0exp (—аZ),
Ni=N0exp (—аZ),
где iV| — плотность потока прошедших в полупроводник фотонов на глубине I; N0 — плотность потока фотонов, пересекших поверхность полупроводника (после отражения части света от поверхности).
В области спектра, где величина аI относительно мала и часть света проходит через полупроводник, расчет суммарного коэффициента пропускания Т необходимо вести с учетом многократных отражений внутри полупроводниковой пластинки по следующей формуле [25]:
гр __ (1 — г)2 exp ( — al)
1 — г2 ехр (— 2аI)
Здесь коэффициент однократного отражения от поверхности полупроводника (когда обе поверхности — внешняя и тыльная — в он— тическом смысле идентичны)
(п — 1)2+ к2
г (п + 1 )2—j— А? »
где п и к — показатели соответственно преломления и поглощения: полупроводникового материала.
Суммарный коэффициент отражения R [23] от такой пластинки (с учетом многократных отражений в ней) в общем случае (когда коэффициенты однократного отражения от внешней и тыльной поверхностей не одинаковы) может быть определен по формуле
я — Г 4- (! + Гр)2 г2 ехр (— 2а/)
0 ‘ 1 — г0г2 ехр (— 2aZ) ’
где г0 — коэффициент однократного отражения от внешней поверхности (граница воздух—полупроводник); г2 — коэффициент однократного отражения от тыльной поверхности (граница полупроводник-воздух) .
Коэффициент поглощения а материала связан с его показателем поглощения к следующим соотношением [25]:
а=4 пк/К. (1.5)
Таким образом, измеряя интенсивность оптического излучения, прошедшего через полупроводниковые образцы различной точно измеренной толщины, можно определить значения к и а данного вещества. При анализе результатов этих измерений следует помнить об отражении излучения внутри полупроводника от обеих границ раздела исследуемых пластин и об оптических потерях на внешней и тыльной поверхностях пластин. Корректные измерения, при использовании результатов которых расчет значительно упрощается и уточняется, требуют, чтобы у образцов различной толщины высокое качество обработки обеих поверхностей (и, следовательно, коэффициенты отражения — и пропускания) было одинаковым, а эффекты интерференции отсутствовали.
В спектральной области, где к мал, показатель преломления п лиожет быть найден по формулам Френеля при использовании измеренного значения коэффициента отражения от одной из поверхностей полупроводниковой пластины на границе с воздухом. Отражение от второй, тыльной поверхности лучше при измерениях исключить каким-либо экспериментальным приемом, например грубой шлифовкой этой поверхности или полировкой под углом.
Солнечные элементы в большинстве случаев представляют собой полупроводниковую пластину двухслойной структуры: на сравнительно толстом слаболегированном базовом слое, например из кремния, находится сильнолегированный внешний кремниевый слой (наиболее простая модель элемента).
В ходе расчета оптических свойств таких двухслойных структур [23] проводится усреднение коэффициента отражения по фазовому углу, или, иначе, фазовой толщине слоев (ибо при толщине слоев, .значительно превышающей длину волны, значение фазовой толщины становится недопустимо большим и сильно зависящим от незначительных изменений толщины слоев и длины волны, что не соответствует реальной физической картине). Формула для коэффициента пропускания Т такой двухслойной структуры после усреднения выглядит следующим образом:
т I Ы21 к |2 ехр (— кл гл4я/Х)
— 1 — | /о |а гг |2 ехр (— кл 1л8п/Х) ’
где go и /о — коэффициенты Френеля на границе воздух—сильнолегированный кремний; ti и г і — амплитудные коэффициенты пропускания и отражения на границе сильнолегированный кремний—базовый слой кремния; кл и 1Л — соответственно показатель поглощения и толщина сильнолегированного слоя кремния.
Зная оптические константы обоих слоев кремния и измерив оптическое пропускание двухслойной пластины кремния, можно определить толщину сильно легированного слоя (конечно, в предположении, что оба слоя кремния легированы равномерно). Коэффициент пропускания двухслойной структуры при прозрачном базовом слое, что справедливо для длинноволновой спектральной области за краем основной полосы поглощения кремния, заметно зависит от толщины сильнолегированного слоя (см. в работе [23] рис. 1.5).
Определение оптических констант сильнолегированного слоя кремния (как и других полупроводниковых материалов), что является методически наиболее сложной задачей, может быть выполнено при использовании методики, предложенной в статье [26]. Для практического осуществления этой методики необходимо иметь набор эталонных образцов исследуемого полупроводникового материала с известной концентрацией свободных носителей и измерить спектральную зависимость коэффициента отражения. Для кремния с концентрацией носителей от 2,2-1018 до 11,5-1019 см-3 такие эталонные кривые были получены в работе [26]. Дальнейший расчет тре —
тельной части е0 диэлектрической ПОСТОЯННОЙ Єї. Для чистого собственного кремния Єо=
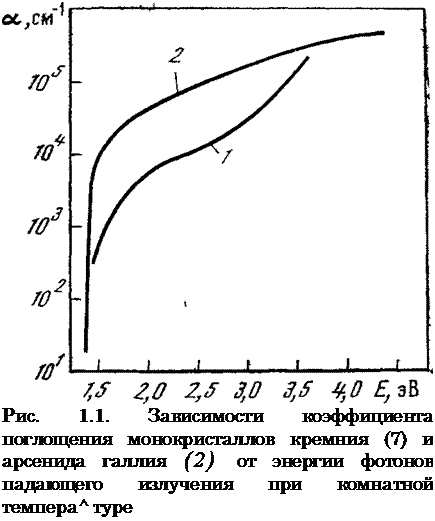 = 11,67 [27]. Значение диэлектрической постоянной Єї определяется по спектральной зависимости коэффициента отражения Я (Я) путем графической экстраполяции, затем рассчитываются пик [26].
= 11,67 [27]. Значение диэлектрической постоянной Єї определяется по спектральной зависимости коэффициента отражения Я (Я) путем графической экстраполяции, затем рассчитываются пик [26].
Таким образом, оптические методы исследования дают возможность определить геометрические толщины полупроводниковых слоев, участвующих в процессе поглощения света, оптические константы п и к и их
✓
спектральную зависимость, а также и спектральную зависимость коэффициента поглощения а полупроводникового материала (см. соотношение (1.5)).
На рис. 1.1 представлены зависимости коэффициента поглощения а от энергии фотонов падающего излучения двух наиболее часто используемых в полупроводниковой фотоэнергетике материалов — кремния [28] и арсенида галлия [29, 30]. Именно из этих материалов получены наиболее эффективные современные солнечные элементы. На рис. 1.1, как и далее в книге, если не сделано особой
 |
щенной зоны арсенида галлия, и коэффициент поглощения а быстро достигает значений 104—105 см”1. Поглощение в кремнии (в основной полосе) начинается с непрямых переходов при 1,1 эВ с участием фононов, коэффициент поглощения растет сравнительно медленно (до значений 103—104 см-1). Только при энергии фотонон около 2,5 эВ переходы зона—зона становятся прямыми — поглощение резко возрастает.
Для германия также характерны непрямые оптические переходы* начинающиеся при 0,62 эВ (коэффициент поглощения от 1 до Ю2 см-1), и только при энергии фотонов более 0,81 эВ основноа поглощение определяется прямыми переходами [27].
Следует отметить, нто значение термической ширины запрещенной зоны полупроводника, рассчитываемое по рассмотренной выше температурной зависимости электропроводности, совпадает, как правило, со значением оптической ширины запрещенной зоны, определяемым краем основной полосы поглощения, совпадающим с началом непрямых оптических переходов зона—зона»
Спектральные зависимости коэффициента поглощения (см. рис. 1.1) показывают, что, применяя кремний, можно использовать для преобразования в электрический ток большую часть солнечного спектра (излучение с длиной волны 1,1 мкм и короче), т, е. более 74% энергии внеатмосферного солнечного излучения. Для арсенида таллия фотоактивным (способным перебросить электроны через запрещенную зону) является излучение с длиной волны 0,9 мкм и менее, и в силу только этого ограничения лишь 63% энергии Солнца во внеатмосферных условиях может быть преобразовано в электрическую. Однако из-за непрямых оптических переходов и малых значений коэффициента поглощения в области края основной полосы поглощения толщина кремниевого солнечного элемента, поглощающего все фотоактивное излучение, должна быть не менее 250 мкм, в то время как аналогичная толщина солнечного элемента из арсенида галлия может составлять не более 2—5 мкм. Эту особенность спектральных характеристик поглощения необходимо учитывать при разработке высокоэффективных и дешевых тонкопленочных солнечных элементов.
Если энергия фотонов падающего излучения настолько мала, что они не могут перебросить электроны из валентной зоны в зону проводимости, то под воздействием излучения электроны могут совершать переходы внутри разрешенных зон. Это отразится на спектре поглощения в длинноволновой области непосредственно за краем основной полосы поглощения полупроводника. Данный вид поглощения, получивший название поглощения свободными носителями, проявляется тем сильнее, чем выше концентрация ионизированных примесей и, следовательно, свободных носителей заряда в полупроводниках, а также чем больше количество свободных носителей, инжектированных в полупроводник под действием света или электрического тока.
Изучение спектров поглощения длинноволнового излучения в полупроводниках привело к обнаружению еще нескольких характерных видов поглощения: на колебаниях решетки; примесного; эк — чжгонного, связанного с возбуждением пары электрон—дырка, однако не влияющего на концентрацию свободных носителей заряда, в силу того что по кристаллу в э1ч)м случае движется возбужденное состояние, а не отдельно электрон и дырка.
Экспериментальные кривые для легированного кремния, представленные на рис. 1.2, подтверждают зависимость коэффициента поглощения в инфракрасной области спектра от концентрации свободных носителей заряда [И].
Спектры поглощения дают обширную и полезную информацию о структурных особенностях кристалла, о степени его легирования, позволяют определить энергию активации примесей и, следовательно, положение занимаемых ими в запрещенной зоне энергетических уровней. С помощью спектров поглощения удается исследовать даже
 Рис. 1.2. Зависимость коэффициен — та поглощения кремния, легированного бором по разной концентрации, от энергии фотонов (измерения Про — /О3 ведены при температуре 300 К)
Рис. 1.2. Зависимость коэффициен — та поглощения кремния, легированного бором по разной концентрации, от энергии фотонов (измерения Про — /О3 ведены при температуре 300 К)
1— 3 — соответственно 6 І019, 9,7 «Ю19 и
2 Ю20 СМ-3
2
2 70
столь тонкий эффект, как присутствие в кремнии растворенного кислорода (благодаря характерной для него полосе поглощения при 9 мкм), и определить концентрацию кислорода в кремнии [31].
При образовании твердого тела, например кристалла полупроводника, атомы настолько сближаются друг с другом, что их внешние электронные оболочки перекрываются. Вместо индивидуальных орбит отдельных атомов появляются коллективные орбиты, и подоболочки атомов объединяются в зоны, единые для всего кристалла*. Характер движения электронов при этом изменяется кардинальным образом: электроны, находящиеся на определенном энергетическом уровне одного атома, получают возможность без затраты энергии переходить на подобный же уровень соседнего атома и тем самым свободно перемещаться вдоль всего кристалла.
Внутренние оболочки в изолированных атомах, а следовательно, и в кристаллах целиком заполнены. Самая же верхняя зона, образованная из уровней, на которых располагались валентные электроны, не всегда заполнена до конца. Электропроводность кристаллов, их оптические и многие другие свойства в основном определяются степенью заполнения валентной зоны и расстоянием от нее до самой верхней зоны, получившей название зоны проводимости. Электроны, попавшие из валентной зоны, например за счет теплового или оптического возбуждения, в зону проводимости, могут принимать участие в переносе электрического тока. Перемещение электронов на освободившиеся места в валентной зоне создает встречное движение положительных зарядов, называемых дырками. Положительный заряд всегда образуется в валентной зоне после ухода электрона, ведь до этого зона была электронейтральной.
Вещества, у которых валентная зона заполнена целиком, а расстояние до следующей зоны велико, называются диэлектриками. Для металлов характерно другое энергетическое строение: валентная зона заполнена частично либо перекрывается со следующей свободной зоной, зоной проводимости. Если же у вещества валентная зона заполнена целиком, но энергетическое расстояние до зоны проводимости мало (условно — менее 2 эВ), то такие вещества называют полупроводниками. Электропроводность и другие свойства полупроводников сильно зависят от внешних условий, особенно от температуры Т. С повышением Т экспоненциально растет число тепловых перебросов электронов через запрещенную зону с энергетической шириной Eg, разделяющую валентную зону и зону проводимости, увеличивается число электронов в зоне проводимости и дырок в валентной зоне, а электропроводность полупроводника а возрастает по закону
о^А0ехр (—EJ2KT), . (1.1)
где К — постоянная Больцмана; А0 — константа, характеризующая данное вещество.
Электропроводность металлов в силу постоянства концентрации свободных электронов определяется температурной зависимостью подвижности электронов и с ростом температуры медленно падает.
Если зависимость (1.1) прологарифмировать, то она примет следующий вид:
In о = InAo—Eg/lKT. (1.2)
Зависимость (1.2) можно изобразить графически в так называемых полулогарифмических координатах и получить прямую, тангенс утла наклона которой <р позволяет рассчитать важнейший параметр полупроводника, определяющий его электрические и оптические свойства — ширину запрещенной зоны Eg:
tg у=Е/2К.
Следует отметить, что зависимость логарифма электропроводное сти от 1/Т представляет собой наклонную прямую линию лишь длЯ’
*
чистых, лишенных посторонних примесей полупроводников, получивших название собственных. Легирующие примеси, вводимые в полупроводники, как правило, для придания им электронного или дырочного характера электропроводности, занимают энергетические уровни в запрещенной зоне вблизи дна зоны проводимости (доноры), легко отдающие электроны в зону проводимости при небольшом тепловом или оптическом возбуждении, или около потолка валентной зоны (акцепторы), на которые легко забрасываются электроны из заполненной нижней зоны, вследствие чего в кристалле пдявляется исключительно дырочная проводимость, не сопровождаемая движением электронов в верхней зоне.
Для примесных полупроводников зависимость In о от 1 /Т носит более сложный характер и состоит из отрезков двух наклонных прямых, соединенных горизонтальным участком. Тангенс угла наклона отрезка прямой, лежащей в области низких температур, дает возможность определить энергию активации или энергетическое положение примесных уровней в запрещенной зоне; тангенс утла наклона отрезка прямой, расположенной в области высоких температур, позволяет найти значение ширины запрещенной зоны Ег примесного полупроводника. Появление горизонтального участка объясняется постоянством концентрации электронов в зоне проводимости (донорные уровни себя исчерпали) в определенном интервале средних температур.
Характер температурной зависимости полупроводников не может быть положен сейчас в основу четкого определения полупроводников и их отличия от других веществ [11]. Теоретически и экспериментально изучены многочисленные случаи отклонения от указанных выше зависимостей. Так, в сильнолегированных полупроводниках электропроводность с повышением температуры не растет, а слабо уменьшается, почти как у металлов. Обнаружены полупроводниковые сверхпроводники, у которых электропроводность резко возрастает при приближении температуры к абсолютному нулю. Найден обширный класс полупроводников, в которых перенос заряда осуществляется ионами, а не электронами и электропроводность которых подчиняется совершенно иным закономерностям (таковы, например, стеклообразные полупроводники). В связи с этим в настоящее время правильнее определять полупроводники как класс веществ, свойства которых могут изменяться в очень широких пределах под действием различных внешних воздействий (температуры, освещения, давления, электрических и магнитных полей и др.)> Именно эта особенность полупроводников обусловила получение на их основе исключительно чувствительных фото — и термосопротивлений, электронных приборов, например диодов, транзисторов, тиристоров, детекторов электрического и магнитного полей или радиационных частиц, тензодатчиков и др., которые было бы невозможно создать из металлических или диэлектрических веществ.
М. М. КОЛТУН
Колтун М. М. Оптика и метрология солнечных элементов.— М.: Наука, 1985.— 280 с.
f
Представлены оптические и электрические характеристики солнечных элементов и батарей из различных полупроводниковых материалов. Рассматриваются способы градуировки эталонных солнечных элементов, разработанные методики измерений КПД, применяемые к наземным и внеатмосферным условиям, конструкции имитаторов солнечного излучения, пути повышения эффективности и улучшения оптических свойств фотоэлектрических преобразователей солнечной энергии, в частности, с помощью просветляющих покрытий
Для специалистов в области солнечной энергетики, оптики и метрологии полупроводниковых приборов Табл 10. Ил. 112 Библиогр. 494 назв.
Рецензенты В. А рилихес, Б. В. Тарнижевсюш
 |
||
t
К проблеме освоения энергии солнечного света привлечено в настоящее время внимание специалистов разных научных дисциплин — от химии и биологии до физики твердого тела [1]. Особенно большие успехи достигнуты на пути создания полупроводниковых солнечных элементов и батарей различных конструкций [2]. Все крупнее, легче и мощнее становятся солнечные батареи космических аппаратов и станций [3], все шире их применение на земле [4], все выше КПД и разнообразнее их свойства [5].
Около тридцати лет прошло с момента проведения первых работ, положивших начало современной фотоэлектрической энергетике [6, 7] (краткая справка научной и практической значимости их дана в статьях [8, 8а, 86]). Эти исследования, в сваю очередь, опирались на стройную теорию фотоэлектрических явлений в полупроводниках, созданную в 30—40-е годы нашего столетия. В СССР развитие этого направления физики полупроводников определили работы академика А. Ф. Иоффе и его школы, углубившие наше понимание природы фотопроводимости и фотоэлектрических явлений в полупроводниках и полупроводниковых р—^-переходах [9—12]. Результаты отечественных и зарубежных исследований в области создания фотоэлектрических приборов, преобразующих энергию излучения, в том числе солнечного, в электрическую, были полно и всесторонне обобщены в монографиях [12, 13]. Полезные теоретические и ^практические рекомендации по выбору оптимальной конструкции фотопреобразователей и описание их электрофизических характеристик даны в публикациях [14—19]. Создание надежных и легких конструкций солнечных батарей (в основном космического назначения) и вопросы воздействия на них космического излучения рассмотрены в обзорах [20—22], исследования по разработке оптимальных просветляющих, теплорегулирующих и радиационно-защитных оптических покрытий для солнечных элементов и батарей представлены в книге [23].
Настоящая монография посвящена проблемам оптики и метрологии солнечных элементов и является первой в этой области. Слова «оптика» и «метрология» недаром стоят рядом в названии книги. Только знание комплекса оптических и метрологических характеристик солнечного излучения и имитаторов Солнца, а также полупроводниковых солнечных элементов и применение разнообразных способов эталонирования численных значений параметров элементов позволяют квалифицированно оценить эффективность последних и наметить дальнейшие пути увеличения их КПД. Нет другого способа оценки качества преобразователей солнечной энер-
гии (в том числе — качества солнечных элементов), чем измерение, основанное на разумной, проверенной методике. Недаром известный оптик С. Толанский отмечал, что веками освященную формулу: увидеть значит поверить, нельзя считать верной в наше время [24]. Сегодня поверить можно только после точного измерения.
Автор выражает глубокую признательность ответственному редактору книги, научным работникам различных организаций нашей страны, коллегам, сотрудникам и аспирантам (результаты совместных исследований с ними легли в основу многих разделов настоящей книги). Большое всестороннее участие в подготовке рукописи к печати принимали Г. А. Гухман, И. В. Грачева и Т. Н. Федоровская, которым автор искренне благодарен.
Созданию солнечных элементов предшествовали детальное изучениа оптических свойств полупроводников, исследование процессов вза — имодействия света с веществом внутри полупроводникового материала, приводящих к появлению избыточных, неравновесных носителей заряда.
Для понимания оптических и фотоэлектрических свойств солнечных элементов необходимо хотя бы кратко рассмотреть качественные особенности зонной структуры полупроводников, ее отличие от электронного строения металлов и изоляторов, основные оптические характеристики полупроводниковых веществ, определяемые зонной структурой, и уже затем перейти к анализу оптических и фотоэлектрических свойств самих солнечных элементов (и, конечно, методов их измерения), а также методов определения и исследования структурных и электрофизических параметров отдельных полупроводниковых слоев элементов. Эти параметры в значительной степени определяют как характеристики, так и эффективность солнечных: элементов и батарей.
В первой главе, как и в целом в книге, не будут затрагиваться проблемы, связанные с концентрацией солнечного излучения, поступающего на поверхность солнечных элементов, и разработкой светоделительных устройств, изменяющих его спектральный состав. Обе эти проблемы достаточно полно освещены в специализированной литературе.