Как выбрать гостиницу для кошек
14 декабря, 2021
Оптические излучения различных длин волн проникают на разную глубину (поскольку эта величина существенно зависит от энергии квантов) и создают свое пространственное распределение рожденных светом пар электрон—дырка (см. рис. 1.1, 1.2). Дальнейшая судьба рожденных пар зависит от их диффузионной длины в данном полупроводниковом материале. Если она достаточно велика, то созданные светом избыточные неосновные носители заряда успеют (даже без участия тянущего электростатического поля) только за счет процесса диффузии дойти до области р—тг-перехода и будут разделены его полем. Решающую роль в эффективности этой стадии преобразования оптического излучения внутри полупроводника играет соотношение между диффузионной длиной L и расстоянием от р—w-перехода Z, на котором создаются светом пары электрон — дырка.
Рассмотрим два крайних случая расположения р—/г-перехода в полупроводниковом кристалле по отношению к направлению падения оптического излучения: перпендикулярно (рис. 1.15, а) и параллельно (рис. 1.15,6). Условимся, что в первом случае свет проникает на всю глубину кристалла и Z равно толщине полупроводниковой пластинки, а во втором — освещается вся поверхность пластинки шириной d.
Очевидно, что эффективность собирания для перпендикулярного и параллельного расположений р—/г-перехода определяется соответственно соотношениями
1=(Ln+Lp)ll и 7=(L„+Lp)/d.
На первый взгляд параллельное расположение кажется более предпочтительным, ибо для полного собирания и разделения носителей наиболее существенным является распределение пар носителей в направлении, перпендикулярном р—/г-переходу: равномерная генерация носителей по глубине кристалла создает благоприятные условия для их диффузии к р—/г-переходу и последующего пространственного разделения. Разработанные на основе такого расположения р—/г-перехода по отношению к свету многопереходные матричные солнечные элементы, состоящие из большого числа микроэлементов, плоскости которых параллельны по отношению к падающему солнечному излучению (или расположены под небольшим углом к нему) действительно обладают высокой эффективностью собирания носителей в длинноволновой области спектра и позволяют получить значительную фото-ЭДС с единицы освещаемой поверхности [64, 65]. Однако расчетным и экспериментальным путем было установлено, что из-за весьма небольших размеров микроэлементов рекомбинация созданных светом пар на освещаемой поверхности играет при параллельном расположении р—/г-перехода относительно падающего излучения значительно большую роль, чем при
перпендикулярном. Вследствие этого для увеличения эффективности собирания в коротковолновой области спектра необходимо создать на обращенной к свету поверхности дополнительный слой, легированный примесью противоположного типа проводимости, т. е. использовать частично структуру с перпендикулярным расположением р—тг-перехода [66].
Если при параллельном расположении концентрация созданных светом пар М убывает от поверхности в глубь полупроводника как в п-, так и в p-области, то при перпендикулярном расположении это характерно лишь для обращенной к свету области кристалла, например тг-области, в то время как в p-области наибольшее количество пар образуется у р-п-перехода. Концентрация пар на глубине I подчиняется соотношению, полученному в результате дифференцирования выражения (1.3):
M=N0a exp (—аI),
где No—’число квантов, падающих на единицу поверхности полупроводника. Концентрация пар, уменьшающаяся в глубину полупроводника, может быть подсчитана для области поглощения полупроводникового материала с помощью зависимости а(Е) (см. рис. 1.1). Результаты таких расчетов для кремния, выполненных при нескольких значениях длины волны, показаны на рис. 1.16 15]. Вертикальные линии, ограничивающие области, определяемые диффузионной длиной носителей в материале п — и p-типа, позволяют наглядно оценить процесс собирания носителей заряда при перпендикулярном расположении р-п-перехода относительно падающего излучения (см. рис. 1.15,а).
Ординаты точек на построенных кривых пропорциональны аехр (—а/), абсциссы — расстоянию в глубь полупроводника от освещаемой поверхности, площадь между осями и каждой из кривых — потоку падающих квантов, а площадь, ограниченная кривой и ординатами, соответствующими 1=1Л+Ьп и 1=1Л—ЬР (заштрихованная часть),—току короткого замыкания кремниевой пластинки с р—га — переходом.
Таким образом, отношение заштрихованной площади к общей площади под кривой дает возможность в соответствии с соотношением (1.13) определить эффективность собирания f (при условии, конечно, что квантовый выход фотоионизации |}=1).
Планарная конструкция солнечных элементов, изображенная на рис. 1.15, а, стала основной и получила наибольшее распространение. Такие солнечные элементы были созданы из самых разнообразных материалов, причем направления оптимизации этой конструкции можно легко определить, анализируя результаты расчетов, аналогичные выполненным для кремния и представленным в графической форме на рис. 1.16.
Очевидно, что для повышения | и /кз необходимо увеличивать диффузионную длину неосновных носителей заряда по обе стороны
 |
|||
-у——■’ 1 1 ..
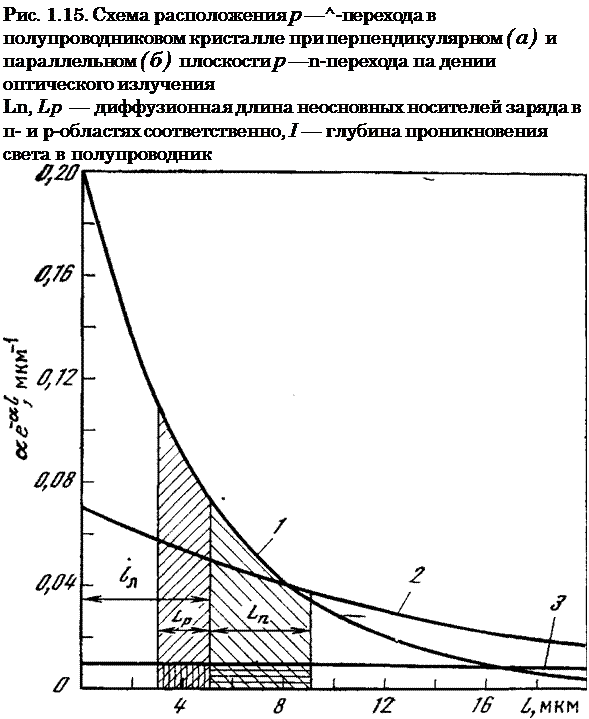 Рис, 1.16. Распределение числа созданных оптическим излучением пар электрон—дырка по глубине кремния при падении излучения разной длины волны перпендикулярно плоскости р— п-перехода
Рис, 1.16. Распределение числа созданных оптическим излучением пар электрон—дырка по глубине кремния при падении излучения разной длины волны перпендикулярно плоскости р— п-перехода
2 — 0,619 мкм,
а = 2000 см-1,
2 — 0,81 мкм, а = 700 см-1;
3 — 0,92 мкм, а = 90 см-1
р—w-перехода (Ln и Lp), что может быть достигнуто выбором соответствующих исходных материалов и сохранением высоких значений L в процессе изготовления р—п-перехода. При невозможности увеличить L в области полупроводника, примыкающей к освещаемой поверхности {Lp на рис. 1.15), необходимо приблизить р—п — переход к освещаемой поверхности, чтобы удовлетворялось соотношение Lp>ln, где 1Л — глубина р—тг-перехода, и все созданные светом носители заряда могли быть собраны и разделены полем р—п — перехода. Современные технологические методы обеспечивают малую глубину р—и-перехода [5, 13, 21].
Подобное же условие следует выполнять и для базовой области солнечного элемента (расположенной за р—^-переходом). Толщина
![]()
солнечного элемента, определяемая в основном базовой областью, не должна быть меньше глубины проникновения в полупроводник излучения длинноволновой части фотоактивной области спектра (энергия квантов Av>£g), а диффузионная длина неосновных носителей заряда в базовой области должна соответствовать толщине элемента и глубине проникновения света.