Как выбрать гостиницу для кошек
14 декабря, 2021
Оптические исследования тонких легированных слоев кремния и других полупроводников было бы значительно легче и точнее выполнять с помощью излучения, которое сильно поглощается материалом полупроводника. Таким, например, является ультрафиолетовое излучение с длиной волны 0,2—0,4 мкм, почти полностью поглощаемое слоями кремния толщиной всего 0,05—0,1 мкм. Однако изменение концентрации свободных носителей заряда в полупроводнике в очень широких пределах практически не влияет на его оптические свойства в коротковолновой области спектра [58]. Спектры отражения в ультрафиолетовой области помогли установить особенности зонной структуры полупроводников. Характерные для многих полупроводниковых материалов всплески отражения объясняются резким ростом показателя поглощения, что вызывается межзонными переходами при большой ширине запрещенной зоны в тех областях зависимости Е от к, где к^О [10, 11, 25],
С помощью спектров ультрафиолетового отражения также удается весьма тонко контролировать качество механической и химической полировки поверхности полупроводниковых кристаллов, что отчетливо видно из приводимых на рис. 1.11 и 1.12 спектральных зависимостей зеркального коэффициента отражения от глубины остающихся после полировки нарушений на поверхности кремния и арсенида галлия. Только после того, как глубина нарушений в результате дополнительной полировки становится меньше длины волны ультрафиолетового (0,2—0,4 мкм) и видимого (0,4—0,75 мкм) излучений, использованных при измерениях (выполненных на спектрофотометрах СФ-4, СФ-10, СФ-20, СФ-26), коэффициент отражения в этих областях спектра перестает изменяться (см. рис. 1.12).
Высокой эффективности оптического контроля способствует наличие пиков отражения, имеющихся у кремния и арсенида галлия в ультрафиолетовой области спектра. Например, контроль за состоя-
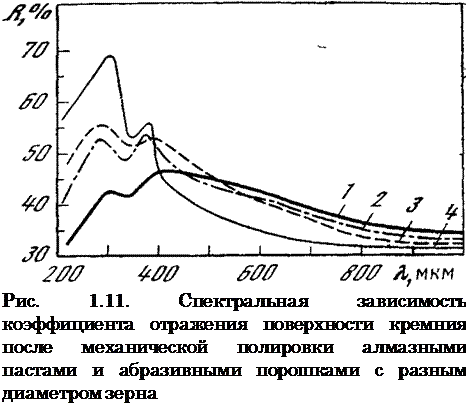 |
 |
J — 3 мкм; 2—1; 3—1; 4 — 0,1—0,2 мкм; 1, 2, 4 — время полировки 1ч; 3 — 2 ч
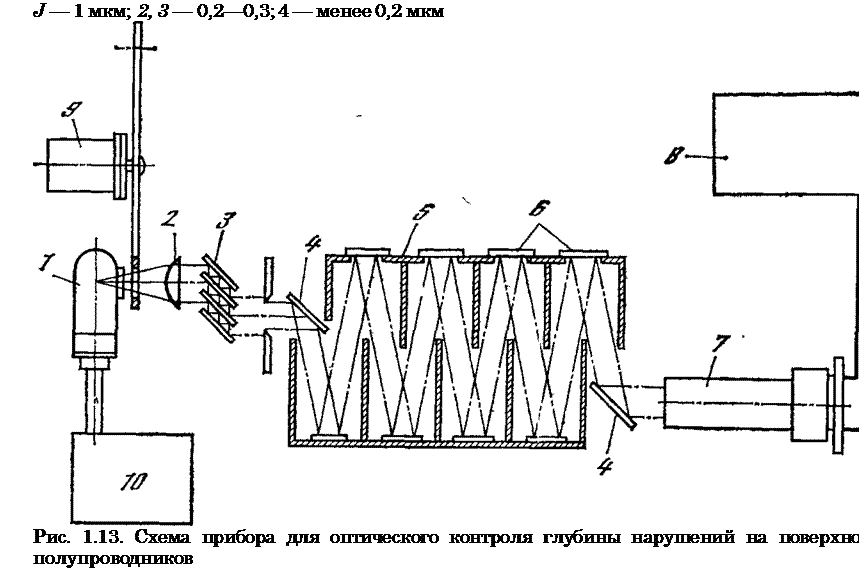 |
Рис. 1.12. Спектральная зависимость коэффициента отражения арсенида галлия после обработки в полирующем травителе и при оставшихся нарушениях ловерхности на разной глубине
1 — водородная лампа; 2 — кварцевая линза; 3 — фильтр из пластин кремния, обработанных окисью хрома; 4—плоские зеркала; 5 — корпус прибора с разделительными шторками; 6 — исследуемые пластины; 7 — фотоумножитель типа ФЭУ-57 или ФЭУ-39 с кварцевым входным окном; 8 — блок регистрации фототока; 9 — модулятор; ю — блок питания водородной лампы
нием поверхности кремния лучше вести при длине волны 0,28 мкм, где коэффициент отражения хорошо отполированного кремния достигает 70%. Для увеличения различия между коэффициентами отражения пластин с разной обработкой поверхности полезно воспользоваться прибором для наблюдения многократного отражения ультрафиолетового излучения от набора пластин с одинаковой обработкой поверхности (рис. 1.13) [59]. В этом же приборе другой набор хорошо отполированных пластин позволяет выделить из спектра источника ультрафиолетовое излучение с длиной волны 0,28 мкм, наиболее полезное для контроля состояния поверхности кремния.
Приборы, применявшиеся для контроля состояния поверхности, в которых выделение необходимого спектрального интервала осуществлялось с помощью кварцевых призм, дифракционных решеток, параболических и поворотных зеркал, более сложны по конструкция.
* * *
Таким образом, исследования спектров отражения как в ультрафиолетовой, так и в инфракрасной области дают возможность получить информацию об электрофизических и оптических свойствах кристаллов, в частности помогают оценить концентрацию свободных носителей заряда, качество обработки поверхности, степень отжига дефектов, параметры зонной структуры, в том числе ширину запрещенной зоны полупроводника и ее температурную зависимость.