Как выбрать гостиницу для кошек
14 декабря, 2021
Если отражение полупроводников в области основной полосы поглощения практически не зависит от степени легирования примесями, ионизирующимися при комнатной температуре, то в длинноволновой области спектра наблюдается резкий рост коэффициента отражения с увеличением количества таких примесей и, следовательно, концентрации свободных носителей в полупроводнике.
Отражение в инфракрасной области спектра
Взаимодействие излучения со свободными носителями тока можно ‘ рассматривать в рамках классической электромагнитной теории излучения [25, 32], приводящей к результатам, весьма близким к полученным квантовомеханической теорией дисперсии [33].
Теория и эксперимент. Диэлектрическая постоянная полупроводника, равная квадрату его комплексного показателя преломления в i = (n—iky, (1.6)
определяется концентрацией N и эффективной массой т* носителей заряда, зарядом электрона q и круговой частотой падающей волны со [25].
Раскрывая левую и правую части соотношения (1.6) и учитывая связь оптических и электрических свойств кристаллов, получим
![]() п2—к2=е і,
п2—к2=е і,
2пк==Апа/(д,
где а —проводимость; п и к — показатели преломления и поглощения полупроводника.
Анализ процесса электропроводности в переменном поле высокой частоты [32] приводит к следующим выражениям для проводимости о и диэлектрической постоянной вещества Єї:
0=Ад2/™*<т/(1+ш2т2)>, (1.8)
*
Єі=8о—4яХс (1-9)
при этом поляризуемость, усредненная по всем Бременам релаксации т и энергия^ свободных носителей, определяется выражением
%-_Nq2Im*< т7(1+(оЧ2)>. (1.10)
Если частота падающего излучения много больше величины 1/т и <от>1, то поляризуемость %с не зависит от т и может быть определена как
Хс ~ —Nq2/пг*ы2. (1.11)
Соотношения (1.6) — (1.11) впервые были использованы для определения эффективной массы носителей заряда оптическим методом [34]. Для определения концентрации носителей заряда использовался эффект Холла. Был исследован также спектральный ход показателей поглощения и преломления в инфракрасной области для сильнолегированного германия. Из полученных данных видно, что слагаемым к2 при расчете коэффициента отражения г (см. формулу (1.4)) можно пренебречь вплоть до длин волн порядка 15 мкм, причем это справедливо также и для других полупроводников, используемых для создания солнечных элементов.
С увеличением длины волны растет поляризуемость %с, подчиняющаяся соотношению (1.11), и уменьшается диэлектрическая постоянная в соответствии с (1.9). При достаточно большом значении Хс диэлектрическая постоянная может стремиться к нулю. Частота, при которой наступает это явление, получила название собственной частоты плазменных колебаний сор, и может быть рассчитана из следующего условия [32]:
е0=4я | Хс | =4 TcNq2/m*(op2, из которого легко получить соотношение
о)Р= (AnNq2/m*Bo)Ча
и, следовательно,
ХР= (яе 0c2m*/Nq2) v% где с — скорость света.
Явление плазменного резонанса происходит в области длин волн, где к2 мало и п также уменьшается, поскольку его изменение но-
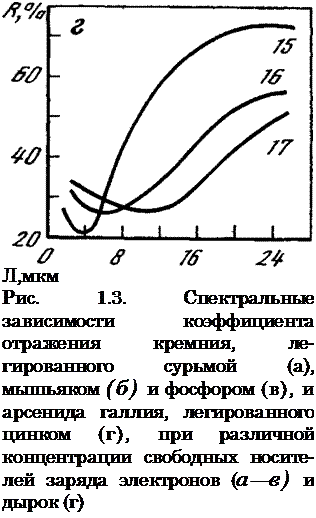 |
 |
 |
10 — 1,02* 1020;

 Л — 4,38* 10і9;
Л — 4,38* 10і9;
12 — 2,05 *1019;
13 — 1,27 1019;
14 — 7,4-І018;
15 — 1,5-1020;
16 — 3,2 10«;
17 — 1,7-101Э см-3 вторяет спектральный ход е4 в соответствии с выражением (1.7). Коэффициент однократного отражения г, определяемый по формуле (1.4), при малом значении к и 1 достигает минимального значения rmin, характеризующего на кривой спектрального отражения область плазменного резонанса.
Спектральные зависимости коэффициента отражения кремния, легированного сурьмой, мышьяком и фосфором, с концентрацией свободных носителей заряда (электронов) от 7,4 -1018 до 1,67 — •1020 см“3 [35], и арсенида галлия, легированного цинком, с концентрацией свободных носителей заряда (дырок) от 3,2* 1019 до 1,5* 1020 см”3 [36], представлены на рис. 1.3, где хорошо видны положение минимума плазменного резонанса на спектральных кривых отражения от поверхности кремния и арсенида галлия и зависимость длины волны минимального отражения от концентрации свободных носителей.
Значение Гшт определяется показателем поглощения Лс, так как при 1 коэффициент г тем меньше, чем меньше к (что видно из соотношения (1.4)). В свою очередь показатель поглощения зависит от времени релаксации, поскольку Оно влияет на проводимость. В то же время поляризуемость не зависит от т, а определяется зонной структурой и концентрацией свободных носителей.
Рис. 1.4. Зависимости концентра* ции свободных носителей заряда от длины волны плазменного минимума для p-Si (1) и n-Si (2)
 Точки — эксперимент
Точки — эксперимент
Рис 1.5. Ход лучей в спектрофотометрах ИКС-14 (а) и «Хитачи» (б) с приставками для измерения отражения
1 — источник излучения;
2 — держатель образцов;
3 — образец;
4 — малогабаритный термостат;
5 — плоские зеркала;
6 — вогнутое зеркало;
7 — монохроматор и приемник
излучения;
8 — эталонное алюминиевое зеркало
 |
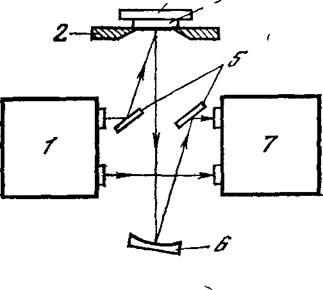 |
т
Поглощение света свободными носителями увеличивается с ростом длины волны, а повышение к приводит к возрастанию коэффициента отражения. Таким образом, спектральная зависимость коэффициента отражения легированных полупроводников проходит через минимум, что и было получено в эксперименте (см. рис. 1.3). Поляризуемость пропорциональна произведению NX С увеличением концентрации свободных носителей N то же значение поляризуемости (в частности, |хс|, при котором 1) может достигаться при меньших X. Именно поэтому при повышении концентрации свободных носителей спектральное положение Гщщ сдвигается в коротковолновую область, причем значение rm in при этом уменьшается, поскольку падает к.
Эта особенность спектров отражения легированных полупроводников в инфракрасной области может быть положена в основу простого оптического метода определения концентрации носителей N
из спектров отражения. Зависимости спектрального положения длины волны плазменного минимума для электронного сильнолегирован — ного кремния гс-типа (Xn-si) и дырочного p-типа (XP-si) от концентрации носителей (рис. 1.4) выражаются^аналитически в виде двух следующих соотношений [37]:
iVP=3,27 • 1021 Vsr2’11, iVn=6,29-1021 К-*Г2’*
хорошо аппроксимирующих экспериментальные данные. При этом концентрация носителей в эталонных образцах определялась по измерению слоевого сопротивления четырехзондовым методом с использованием кривых Ирвина, связывающих удельное сопротивление р — и и-кремния с концентрацией свободных носителей [31, 38]. Недостатком данного метода является сравнительно невысокая точность установления спектрального положения длины волны плазменного минимума для слаболегированных образцов.
Более сложные и точные методики определения концентрации подвижности и эффективной массы свободных носителей заряда по спектрам отражения легированных полупроводников описаны в работах [39—42]. В некоторых из них измеренные зависимости отражения сравниваются с эталонными кривыми в весьма широком спектральном диапазоне — от 1 до 25 мкм.
Исследование* спектров отражения от поверхности полупроводников дает возможность получить информацию не только об электрофизических свойствах кристаллов, но и о состоянии их поверхности, качестве химической и механической обработки. Это удается сделать, несмотря на то что из-за трудностей регистрации суммарного и диффузного отражения в инфракрасной области [43] измеряется, как правило, лишь зеркальная составляющая коэффициента отражения и ее температурная зависимость [44].
Методика измерений. Для измерения коэффициента отражения используется инфракрасный спектрофотометр, например отечественный марки ИКС-14 (диапазон спектра от 0,7 до 25 мкм), или японский марки «Хитачи» (измеряемый диапазон спектра от 2 до 50 мкм). Оба спектрофотометра в основном применяются для измерения коэффициента пропускания, а для измерения коэффициента отражения необходима установка специальных приставок [41, 45] между источником и приемником излучения (рис. 1.5).
Для проведения таких измерений удобна конструкция описанных в статье [44] держателя для образцов и малогабаритного термостата. Электрическая схема последнего основана на релейном принципе и может поддерживать любую заданную температуру в интервале 30—300° С с точностью ±2° С.
Измерения фонового теплового излучения исследуемых образцов показали, что даже в далекой инфракрасной области фоновое излучение при 200° С не превышает 14% от отраженного потока [44]. Фоновое излучение нагретого эталонного зеркала составляет менее 1% благодаря малой степени черноты пленок алюминия [46].

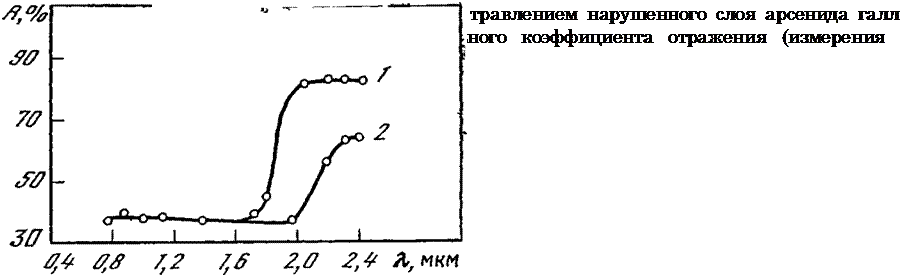 |
Рис. 1.6. Зависимость коэффициента отражения механически шлифованной поверхности арсенида галлия л-типа в инфракрасной области спектра до (1) и после удаления травлением внешнего слоя (2—5) различной толщины
Si—S5 — площади, ограниченные кривыми 1—5 на рис. 1 6

![]()
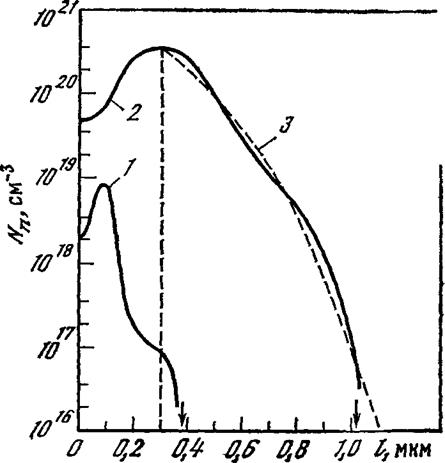 Рис. 1.9. Зависимость концентрации свободных носителей заряда в поверхностном легированном слое кремния, полученном бомбардировкой кремния p-типа ионами фосфора, от расстояния до поверхности
Рис. 1.9. Зависимость концентрации свободных носителей заряда в поверхностном легированном слое кремния, полученном бомбардировкой кремния p-типа ионами фосфора, от расстояния до поверхности
1 — до отжига, доза ионов фосфора
6 103 мкКл/см2;
2 — тот же образец после отжига
в течение 2 ч при 850° С;
3 — теоретическая кривая,
соответствующая диффузии примеси из бесконечного источника, расположенного на расстоянии 0,3 мкм от поверхности Стрелки указывают глубину залегания р—п-перехода
Оценка качества механической обработки поверхности полупроводников. Измерения спектров инфракрасного отражения при комнатной температуре, выполненные с помощью инфракрасных спектрофотометров, дают возможность оценить степень повреждений поверхности полупроводников при механической обработке, например, как это было сделано для арсенида галлия /г-типа [47] (конечно, для успешного осуществления подобного контроля необходимо, чтобы длина волны падающего излучения была соизмерима с глубиной нарушений йа поверхности). При этом контролировались сравнительно грубые нарушения, вызванные механической шлифовкой абразивом со средним диаметром зерна около 10 мкм, и для исследования был выбран диапазон спектра от 20 до 60 мкм.
В этой области на кривой отражения легированного арсенида галлия (рис. 1.6) наблюдаются два характерных минимума: при 20— 25 мкм (вызванный явлением плазменного резонанса излучения со свободными носителями заряда) и при 37—42 мкм (связанный с поглощением излучения из-за взаимодействия с тепловыми колебаниями решетки кристалла). После удаления слоя определенной толщины спектральная зависимость коэффициента отражения остается неизменной и совпадает с аналогичной зависимостью ненарушенного кристалла арсенида галлия /г-типа с такой же концентрацией примеси. Для удаления нарушенного слоя использовался травитель, состоявший из смеси серной кислоты, перекиси водорода и воды, а толщина удаляемого слоя определялась взвешиванием образцов до и после травления. Достаточно точно глубину нарушенного слоя на поверхности кристалла можно определить по зависимости площади, ограниченной кривой спектрального коэффициента отражения, от толщины удаленного чслоя (рис. 1.7). Площадь под кривой спектрального коэффициента отражения перестала возрастать после удаления нарушенного слоя глубиной 8,8 мкм. Глубина нарушений тем самым составляет около 0,9 от среднего диаметра абразивного зерна, использованного для механической шлифовки поверхности арсенида галлия.
Оценка температурной зависимости ширины запрещенной зоны. Использование малогабаритного термостата [44] дает возможность исследовать температурную зависимость коэффициента зеркального отражения от поверхности образцов, оценить изменение ширины запрещенной зоны полупроводников при росте температуры. Показанное на рис. 1.8 изменение спектрального отражения от внешней поверхности пластинки поликрист ал л ического германия р-типа с удельным сопротивлением 60 Ом-см и нанесенным на ее тыльную сторону отражающим слоем алюминия (испарением в высоком вакууме) [44] обусловлено температурным сдвигом края основной полосы поглощения германия.
Исследование свойств тонких сильнолегированных слоев полупроводников с помощью спектров отражения инфракрасного излучения не может привести к количественным результатам, когда глу-
бина проникновения излучения в материал полупроводника превышает толщину слоев. Это положение подтверждается при исследовании тонких р—тг-переходов, полученных бомбардировкой кремния ионами фосфора [48]. Методики, использованные в этих экспериментах, являются примером комплексного подхода к изучению свойств полупроводниковых структур. Были определены профиль концентрации свободных носителей заряда, глубина залегания р—п-пере — * хода и их изменение в процессе изотермического отжига.
Исследование тонких легированных слоев в солнечных элементах. В экспериментах использовался кремний p-типа с удельным сопротивлением р=1 Ом-см. Тщательно полированная поверхность, ориентированная по {1Н}, подвергалась бомбардировке сепарированным пучком ионов фосфора с энергией 30 кэВ дозой D=6-103 мкКл/ /см2. Профиль концентрации свободных носителей тока исследовался при последовательном удалении слоев кремния толщиной 160— 500 А анодным окислением в 0,04 N растворе азотнокислого калия в этиленгликоле [49]. Проводимость удаляемых слоев измерялась четырехзондовым методом. Пересчет к средней концентрации свободных носителей в удаленном слое велся с использованием данных работ [38, 50]. Общая глубина легированного слоя оценивалась по методу косого цилиндрического шлифа [51].
Коэффициенты пропускания и отражения в области спектра 1— 25 мкм определялись с помощью спектрофотометра ИКС-14 с использованием приставки для измерения коэффициента зеркального отражения (см. рис. 1.5, а).
Результаты электрических измерений. На рис. 1.9 (кривая 1) представлено распределение концентрации свободных носителей по глубине легированного слоя. У поверхности образуется относительно широкая область с отрицательным градиентом концентрации, максимум достигается на глубине около 0,12 мкм, после чего концентрация уменьшается до значения, соответствующего исходному кремнию. Ход кривой объясняется специфичностью профиля концентрации внедренных атомов [52] и радиационных дефектов: максимум концентрации сдвинут к поверхности [53—55]. Проведенные электронографические исследования поверхности кремния, подвергнутой бомбардировке ионами фосфора, обнаружили аморфизацию кремния вплоть до глубины 0,2 мкм, причем верхний слой толщиной 0,05 мкм из монокристаллического состояния перешел полностью в аморфное [48]. Количественная оценка средней по слою концентрации носителей тока (см. кривую 1 на рис. 1.9) дает значение порядка 1018 см~3, что примерно в 1000 раз меньше средней концентрации введенного фосфора (3-Ю21 см“3).
Уменьшение количества радиационных дефектов и увеличение концентрации электрически активных внедренных атомов фосфора, как известно, легко достигаются тепловым отжигом образцов (см. рис. 1,9, кривая 2). Глубина залегания р—тг-перехода увеличилась до 1 мкм. Участок кривой 2 от 0,3 до 1 мкм довольно хорошо они-
-сывается уравнением диффузии примеси из бесконечного источника в полу ограниченное тело [56]. Интегрирование кривой 2 показало, что в кремний из начального слоя толщиной 0,3 мкм продиф- фундировало 4,2% фосфора. По мере приближения к поверхности, так же как и до отжига, наблюдается уменьшение концентрации — свободных носителей тока. Электронограммы, полученные при последовательном удалении слоев, показали остаточные нарушения
 Рис 1.10. Зависимость коэффи-
Рис 1.10. Зависимость коэффи-
7/7
циента отражения кремния, /и легированного ионной бомбардировкой фосфором, при длине волны 19 мкм от темпера — ^ туры отжига
— 30
о т 7оо зоо % °с
монокристалличности до глубины 0,15 мкм, что подтверждает неполноту отжига, вследствие чего концентрация свободных носителей в этом слое не могла стать высокой.
![image023 Подпись: шающейся концентрацией свободных носителей. Этот вывод, сделанный на основании эксперимента, подтверждается расчетом. После подстановки в соотношение (1.5) Х= 19 мкм и /с—4,1 для легированного кремния [57] получим, что глубина проникновения света, на которой плотность потока излучения снижается в е раз, 1/а=0,4 мкм. Если учесть^ что в экспериментах концентрация свободных носителей в хорошо о Пожженных легированных слоях составляла 3-Ю20 см”3 [48], а в работе [57] приводится ^=4,1 для концентрации 2,9 -1019 см”3, то совпадение расчетных и экспериментальных данных по зависимости прозрачности легированного слоя в инфракрасной области от его толщины следует признать весьма хорошим.](/img/1199/image023_3.gif) |
Результаты оптических измерений. Была сделана попытка исследовать распределение концентрации свободных носителей в легированном слое по изменению коэффициента отражения в инфракрасной области спектра. Коэффициент отражения образцов, не подвергнутых отжигу после ионной бомбардировки, совпадает с коэффициентом отражения нелегированного кремния. В этом случае поверхностная концентрация свободных носителей iV^lO18 см”3, однако глубина залегания перехода настолько мала (0,2—0,3 мкм), что легированный слой оказывается в высокой степени прозрачным в окрестности Х—19 мкм. Это говорит о том, что для мелких р—п — переходов (глубина залегания <1 мкм) изменение коэффициента отражения при послойном снятии кремния не передает истинного распределения концентрации свободных носителей в легированном слое, так как значение коэффициента отражения обусловливается не только поверхностными, но и всеми нижележащими слоями с умень
Тем не менее проведенные измерения коэффициента отражения полезны. Например, они показывают, что при одинаковой глубине залегания перехода концентрация свободных носителей после теплового отжига выше при наличии пленки двуокиси кремния, препятствующей экзодиффузии фосфора.
Кроме того, по значению коэффициента отражения в инфракрасной области спектра можно судить о полноте отжига при выбранных условиях. На рис. 1.10 показано изменение коэффициента отражения при Я=19 мкм легированной ионной бомбардировкой фосфором (по описанному выше режиму) поверхности кремния после отжига в течение 2 ч при возрастании температуры отжига от 600 до 890° С. Чем выше концентрация свободных носителей в поверхностных слоях легированной области, тем больше коэффициент отражения: i?=30% при 7Vp=1016 см~3 и R—84% при Л^п=2,5-1020см~3.