Как выбрать гостиницу для кошек
14 декабря, 2021
6.1. Основные направления повышения эффективности
солнечных элементов
В настоящее время использование солнечных элементов на основе a — Si:H не приняло широкого распространения. Для улучшения качества СЭ на основе a-Si:H необходимо обеспечить:
• повышение эффективности преобразования солнечного излучения в электрическую энергию;
• увеличение стабильности основных параметров солнечных батарей к длительному действию излучения.
Решение данных проблем связано с развитием методов получения более совершенных по свойствам аморфных материалов и с усовершенствованием структур СЭ на их основе.
Для успешного совершенствования технологии формирования СЭ необходимо проведение исследований по ряду направлений:
• улучшение оптоэлектронных свойств тонких пленок a-Si:H, a-SiGe:H и ^c-Si:H;
• изучение структурно-релаксационных процессов в материалах на основе a-Si:H под освещением;
• оптимизация свойств слоев р — и «-типов, улучшение качества границы раздела между легированными и собственными слоями, исследование возможности использования буферных слоев и слоев с изменяющейся шириной запрещенной зоны по толщине;
• разработка фронтальных материалов для TCO и оптимизация границы раздела TCO/слой р-типа;
• оптимизация технологии формирования «световой ловушки»
• оптимизация морфологии границы раздела и увеличение эффективности отражения тыльного контакта СЭ;
• увеличение скорости осаждения толстых поглощающих слоев при сохранении их качества.
Одним из путей повышения эффективности солнечных элементов на основе a-Si:H является усовершенствование технологических процессов, направленное на улучшение оптоэлектронных свойств и уменьшение кон-
центрации дефектов в нелегированном и особенно в легированном слоях аморфного гидрогенизированного кремния. Это позволяет при большем значении длины дрейфа носителей заряда увеличить коэффициент формы ВАХ и соответственно получить более высокий КПД.
Ведутся интенсивные работы по улучшению свойств активного собственного слоя в солнечных батареях на основе a-Si:H и его сплавов. Одним из широко используемых методов является получение /-слоя в плазме, разбавленной водородом [105]-[107], что приводит к улучшению оптоэлектронных свойств полупроводника (уменьшению плотности состояний и увеличению параметра рт). Солнечные элементы с таким i-слоем имеют большее напряжения холостого хода. Однако осаждение данного слоя в плазме, разбавленной водородом, приводит к снижению скорости роста.
Слойp-типа в p-i-n-структуре солнечного элемента на основе a-Si:H и его сплавов наряду с созданием встроенного электрического поля в /-слое также играет роль широкозонного фронтального окна. Увеличение встроенного электрического поля в i-слое достигается повышением степени легирования и проводимости р — и n-слоев. Таким образом, для увеличения эффективности СЭ необходимо формировать слои р-типа одновременно с высокой проводимостью и минимальным поглощением света в нем. Последнее условие достигается за счет увеличения щели подвижности аморфного полупроводника. Увеличение оптической щели слоя фронтального окна p-типа вызывает также возрастание встроенного электрического поля в i-слое. В то же время повышение степени легирования бором сопровождается уменьшением щели подвижности и ростом потерь, обусловленных поглощением света в этом слое. Увеличить щели подвижности прозрачного фронтального окна возможно за счет применения широкозонного сплава a-SiC:H p-типа. Использование прозрачного окна на основе p-a-SiC:H дает возможность увеличить напряжение холостого хода уменьшением рекомбинации на p/i-границе. Дополнительно повысить напряжение их х и коэффициент формы позволяет формирование слоя a-SiC:H p-типа, в котором изменяется концентрация углерода вблизи p/i-границы. Установлено, что качество границы раздела p-a-SiC:H/i-a-Si:H улучшается, если при получении легированного a-SiC:H p-типа вместо B2H используется В(СНз)з.
Известно, что pc-Si:H легируется эффективнее аморфного гидрогенизированного кремния, при этом уровень Ферми может быть сдвинут ближе к
краю зоны проводимости, чем в легированном a-Si:H. С другой стороны, не-
124
смотря на то, что ширина запрещенной зоны pc-Si:H небольшая по сравнению с «-Si:H, поглощение света в нем меньше, чем в аморфном гидрогенизирован — ном кремнии, поскольку этот материал является непрямозонным полупроводником. Таким образом, микрокристаллический кремний перспективен для изготовления прозрачного окна в солнечных батареях с p-i — «-структурой.
Одним из важнейших факторов, приводящих к снижению КПД солнечного элемента, является рекомбинационный ток на границах раздела. Для снижения рекомбинационных потерь на p/i-переходе в р-і-«-структуре возможно размещение между этими слоями тонкого буферного слоя нелегированного широкозонного «-SiC:H, а также формирование переходного буферного слоя с плавно меняющейся шириной запрещенной зоны от широкозонного р — к i-слою. Такие буферные слои, формируемые в одном процессе при осаждении р-слоя, частично защищают его от загрязнения, эффузии водорода, диффузии бора в пленку «-Si:H i-типа. Буферный слой, уменьшая рекомбинацию на p/i-границе раздела, увеличивает спектральный отклик в голубой области спектра и может значительно увеличить напряжение холостого хода элемента. Это позволяет повысить эффективность преобразования солнечных элементов.
Установлено, что обработка поверхности p-слоя в водородной плазме перед осаждением i-слоя приводит к улучшению характеристик p/i-перехода и увеличению параметров солнечного элемента.
В то же время введение слоя TCO между слоем «-типа и задним металлическим контактом позволяет увеличить поглощение света в длинноволновой области спектра. Как и в случае p/i-границы, может быть сформирован буферный слой.
Исследования, направленные на повышение эффективности солнечных элементов на основе неупорядоченных полупроводников, связаны с получением новых гидрогенизированных сплавов с тетраэдрической координацией, что дает возможность изменять оптическую ширину щели в широких пределах (табл. 8.1) [27], [108]-[111]. В перечисленных материалах удается управлять типом и величиной проводимости за счет гидрогенизации, термообработки и легирования. Перспективным материалом для солнечных элементов является соединение «-Si1_xCx:H, так как с увеличением содержания углерода ширина щели подвижности изменяется от 1,76 до 2,2 эВ. Слои «-Si1_xCx:H обладают достаточно хорошей фотопроводимостью.
|
Аморфные сплавы на основе тетраэдрических полупроводников для СЭ, полученных методами тлеющего разряда (ТР) и реактивного распыления (РР)
|
К настоящему времени разработаны солнечные элементы на основе р-/-и-гетеропереходов, где в качестве p-слоя используется a-Sii_xCx:H p-типа. На рис. 8.1 приведены конструкции и сравнительные характеристики солнечных элементов на основе a-Si:H и a-Si1_xCx:H. Солнечные элементы на основе гетероперехода a-SiC:H/a-Si:H имеют значительно лучшие характеристики: 1к з на 38 %, их х на 13,7 % и КПД на 40 % больше, чем в элементах на основе a-S:H. Эффективность солнечных элементов на основе двойных гетеропереходов a-SiC:H/a-Si:H/p. c-Si удается повысить при использовании со стороны окна в качестве контакта микрокристаллического кремния.
|
Рис. 8.1. Конструкции и сравнительные характеристики солнечных элементов на основе a-Si:H и a-Sij-xCx:H |
Однако введение углерода и германия в состав a-Si:H ухудшает оптоэлектронные свойства аморфного полупроводника [27], [112]—[118]. Это затрудняет использование сплавов a-SiC:H и a-SiGe:H с большим содержа-
126
нием C и Ge. Так, для a-SiGe:H с шириной оптической щели менее 1,4 эВ плотность состояний становится настолько высокой, что такой материал уже не пригоден для практического применения. Производство этих сплавов в условиях разбавления плазмы водородом [105]-[107], а также использование дисилана вместо моносилана при получении a-SiGe:H и a-SiC:H и ацетилена вместо метана при получении a-SiC:H улучшает электрические и структурные свойства пленок [119], [120].
В случае разбавления плазмы водородом серьезной проблемой может стать загрязнение /-слоя. Из-за значительного понижения скорости роста и присутствия паров воды в подаваемом газе и рабочей камере в i-слой может попадать кислород, который ведет себя как донор. Это может привести к уменьшению спектрального отклика в красной области спектра солнечного элемента и снижению коэффициента формы. Специальная дополнительная очистка используемых газов позволяет решить данную проблему.
Для увеличения коэффициента формы увеличением сбора дырок в солнечных элементах с i-слоем на основе a-SiGe:H предложено формирование этого слоя с постепенно уменьшающейся шириной оптической щели за счет постепенного повышения содержания Ge. Возникает дополнительное электрическое поле в слое, и наклон валентной зоны ускоряет дырки по направлению к р-слою.
Для характеризации качества a-Si:H и его сплавов широко используется термин «материал приборного качества». Этот термин четко не определен и подразумевает материал с оптимальными для изготовления приборов свойствами, которые зависят от конкретного приборного применения. В целом оптимальные для применения в СЭ свойства собственного a-Si:H просуммированы в табл. 8.2. Необходимо иметь в виду, что многие из этих свойств взаимозависимы и изменение одного из них может привести к изменению других.
|
Таблица 8.2 Свойства собственного a-Si:H приборного качества
|
|
Свойства |
Обозначение |
Значение |
|
Энергия активации, эВ |
^a |
0,8 |
|
Произведение подвижности и времени жизни носителей, см2-В-1 |
ЦТ |
10-7 |
|
Содержание водорода, % |
CH |
8-12 |
|
Микроструктурный параметр |
R |
0-0,1 |
|
Собственные напряжения, МПа |
°i |
400-500 |
|
Плотность дефектов, эВ-1-см-3 |
Ns |
1015 |
Для получения a-Si:H p-типа применяется легирование бором, однако при этом уменьшается оптическая щель. Поэтому a-Si:H дополнительно легируется углеродом для увеличения Eg. В этом случае материал p-типа высокого качества имеет следующие свойства: Eg = 2,0 эВ, Ea = 0,5 эВ, ат = 10-5 Ом-1-см-1, а600 = 104 см-1. Для получения a-Si:H n-типа применяется легирование фосфором, при этом материал высокого качества обладает свойствами: Eg = 1,8 эВ, Ea = 0,3 эВ, ат = 10 -3 Ом-1-см-1, a600 = 4-104 см-1.
 |
 |
В начале 90-х годов началась разработка солнечных элементов на основе гетероструктур a-Si:H/c-Si (HIT structure — Heterojunction with Intrinsic Thin-layer — гетероструктуры с тонким собственным слоем a-Si:H), конструкция которого представлена на рис. 7.8 [99]—[ 104].
Рис. 7.8. Солнечный элемент
на основе гетероструктуры a-Si:H/c-Si
В 1993 г. впервые были изготовлены солнечные элементы такого типа в лабораторных условиях, а в 1997 г. началось массовое производство солнечных элементов на основе гетероструктур a-Si:H/c-Si. Компания «Sanyo» одной из первых изготовила СЭ, имеющий структуру TCO/p-a-Si:H/n-c-Si. КПД такого солнечного элемента составил 12,3 %. Последующая модификация солнечных элементов на основе гетероструктур a-Si:H/c-Si за счет формирования p-i-n-структуры TCO/p-a-Si:H/i-a-Si:H/n-c-Si привела к увеличению эффективности до 14,8 %. Использование текстурированной подложки повысило КПД до 19,5 %. Наконец, после изготовления двухсторонней структуры TCO/p-a-Si:H/i-a-Si:H/n-c-Si/i-a-Si:H/n-a-Si:H/(отражающий контакт) удалось добиться эффективности преобразования 21 %, что сравнимо с эффективностью СЭ на основе монокристаллического кремния с p-n-переходом.
При формировании солнечных элементов по данной технологии осаждение слоев аморфного гидрогенизированного кремния осуществляется при низкой температуре (~200 °С). Это позволяет использовать подложки на основе монокристаллического кремния не очень высокого качества, за счет че-
121
го снижается стоимость СЭ. В формируемых гетероструктурах a-Si:H/c-Si обеспечивается очень хорошая пассивация поверхности c-Si аморфным гид — рогенизированным кремнием, приводящая к значительному увеличению КПД СЭ. Кроме того, для солнечных элементов такого типа практически отсутствует деградация свойств со временем и наблюдается меньшая зависимость КПД от температуры по сравнению с обычными солнечными элементами из — за наличия собственного /-слоя a-Si:H и большого разрыва в валентной зоне на границе раздела a-Si:H/c-Si.

![]() Большинство современных солнечных элементов обладают одним p-n — переходом. В таком элементе свободные носители заряда создаются только теми фотонами, энергия которых больше или равна оптической ширине запрещенной зоны. Другими словами, фотоэлектрический отклик однопереходного элемента ограничен частью солнечного спектра, с энергией превышающей ширину запрещенной зоны, а фотоны меньшей энергии не используются. Один из путей преодоления этого ограничения — применение многослойных структур из двух и более солнечных элементов с различной шириной запрещенной зоны. Такие элементы называются многопереходными или каскадными. Многопереходные элементы могут достичь большей эффективности фотоэлектрического преобразования, поскольку используют значительно большую часть солнечного спектра.
Большинство современных солнечных элементов обладают одним p-n — переходом. В таком элементе свободные носители заряда создаются только теми фотонами, энергия которых больше или равна оптической ширине запрещенной зоны. Другими словами, фотоэлектрический отклик однопереходного элемента ограничен частью солнечного спектра, с энергией превышающей ширину запрещенной зоны, а фотоны меньшей энергии не используются. Один из путей преодоления этого ограничения — применение многослойных структур из двух и более солнечных элементов с различной шириной запрещенной зоны. Такие элементы называются многопереходными или каскадными. Многопереходные элементы могут достичь большей эффективности фотоэлектрического преобразования, поскольку используют значительно большую часть солнечного спектра.
В типичном многопереходном солнечном элементе (рис. 7.6) одиночные фотоэлементы расположены друг за другом таким образом, что солнечный свет сначала попадает на элемент с наибольшей шириной запрещенной зоны, при этом поглощаются фотоны с наибольшей энергией. Не поглощенные верхним слоем фотоны проникают в следующий элемент с меньшей шириной запрещенной зоны, где часть их поглощается и т. д. Проведенные расчеты показали, что идеальный каскадный СЭ с бесконечным количеством согласованных элементов может иметь КПД = 66 %.
Идея каскадных фотоэлементов, возникшая в 1960-е годы, вначале была реализована в механически стыкованных фотоэлементах [98]. Фотоэлементы с монолитной структурой впервые изготовили в США. Многослойные согласованные по периоду решетки структуры были выращены методом газофазной эпитаксии с использованием металлорганических соединений на германиевой подложке. При этом p-n-переход верхнего фотоэлемента сформировался в полупроводнике на основе твердого раствора ^^Ga^P, а нижнего — на основе GaAs. Последовательное соединение фотоэлементов и обеспечение прохождения носителей между элементами осуществлялось посредством туннельного p-n — перехода, специально сформированного между каскадами. Позднее сформировался и третий каскад с p-n-переходом в германиевой подложке. В настоящее время трехкаскадные фотоэлементы используются для оснащения космических аппаратов.
 На основе аморфных полупроводников также изготавливают каскадные солнечные элементы, при этом каждый отдельный каскад имеет p-i-n — структуру.
На основе аморфных полупроводников также изготавливают каскадные солнечные элементы, при этом каждый отдельный каскад имеет p-i-n — структуру.
 СЭ на основе аморфных материалов для формирования i-слоев помимо a-Si:H могут использоваться широкозонные a-Sii-xCx:H, a-Sii-xNx:H и узкозонные a-Sii-xGex:H полупроводники по сравнению с a-Si:H.
СЭ на основе аморфных материалов для формирования i-слоев помимо a-Si:H могут использоваться широкозонные a-Sii-xCx:H, a-Sii-xNx:H и узкозонные a-Sii-xGex:H полупроводники по сравнению с a-Si:H.
На рис. 7.7 представлена конструкция трехкаскадного солнечного элемента с тремя p-i-n-структурами на основе a-Si:H и его сплавов.
Верхний слой, поглощающий коротковолновую (голубую) область солнечного спектра, формируется из сплава на основе a-Si:H с шириной оптической щели 1,8 эВ. В настоящее время принято считать, что широкозонный сплав a-Sii-xCx:H невозможно использовать в качестве i-слоя СЭ. Это связано с тем, что после длительного освещения светом в нем образуется очень высокая плотность дефектов. Применение же тонких слоев не позволяет эффективно поглощать свет. По этой причине для формирования широкозонного i-слоя в тройных СЭ используется a-Si:H с повышенным содержанием водорода, который осаждается при пониженных температурах 150-200 °С в условиях разбавления моносилана водородом.
Для серединного элемента в качестве слоя /-типа используется сплав a-SiGe:H с содержанием германия ~10—15 %. Ширина оптической щели данного слоя 1,6 эВ идеально подходит для поглощения зеленой области солнечного спектра.
Нижняя часть солнечного элемента впитывает длинноволновую часть спектра солнечного излучения (красная и инфракрасная), для этого используется i-слой a-SiGe:H, где концентрация германия составляет от 40 до 50 % (ширина оптической щели ~1,4 эВ). Однако значительное увеличение содержания Ge сопровождается ухудшением оптоэлектронных свойств полупроводника и приводит к уменьшению коэффициента формы и напряжения холостого хода. Эта проблема может быть решена за счет оптимизации процесса осаждения, нанесения a-SiGe:H при разбавлении рабочего газа водородом, а также формирования i-слоя с изменяющимся содержанием германия, а значит, и изменяющейся шириной щели подвижности по толщине.
Следует отметить, что GeH4, используемый при получении a-SiGe:H, в несколько раз дороже моносилана и является токсичным веществом.
Непоглощенный свет отражается от заднего контакта на основе Ag/ZnO. Использование прозрачного проводящего оксида в сочетании со слоем металла увеличивает отражение от заднего электрода.
Все три элемента каскадной солнечной батареи связаны между собой сильнолегированными слоями, образующими туннельные р-«-переходы между соседними элементами. Электроны, генерируемые в верхнем элементе (см. рис. 7.7), движутся к р-«-переходу, где они рекомбинируют с дырками из нижележащего элемента. Когда скорость рекомбинации не сбалансирована с поступающим потоком носителей, происходит накопление объемного пространственного заряда, который отрицательно влияет на электрическое поле прилегающего элемента с наибольшей скоростью генерации. Очень важно обеспечить низкое сопротивление этого р-«-перехода. Перспективным является использование слоев р — и «-типа на основе микрокристаллического кремния, поскольку он более эффективно легируется по сравнению с a-Si:H.
КПД каскадных солнечных фотоэлементов, изготовленных в различных лабораториях и фирмах, представлены в табл. 7.3 (начальный КПД — КПД СЭ сразу после изготовления, стабилизированный КПД — КПД СЭ после длительного освещения).
|
КПД каскадных солнечных элементов малой площади, изготовленных в различных лабораториях и фирмах
|
Деградация КПД каскадных СЭ составляет 10-20 %, в то время как у одинарных солнечных элементов — 20-40 % (см. табл. 7.3).
В каскадном солнечном фотоэлементе общий ток ограничивается минимальным током, протекающим через один из элементов. В связи с этим необходимо согласовывать токи, протекающие через отдельные элементы, в точке максимальной мощности под освещением. Токи короткого замыкания каждого из элементов являются лишь первым приближением для такого согласования, так как необходимо учитывать соответствующие коэффициенты формы. В тройном солнечном элементе a-Si:H/a-SiGe:H/a-SiGe:H наименьший коэффициент формы имеет нижний элемент на основе a-SiGe:H, а наибольший — верхний на основе a-Si:H. Поэтому ток короткого замыкания нижнего элемента должен быть немного выше среднего, а среднего — немного выше верхнего. В оптимизированных тройных солнечных фотоэлементах эта разница в обоих случаях составляет примерно 1 мА/см2. Такого согласования добиваются за счет подбора ширины оптической щели и толщины каждого из /-слоев. Рассогласование токов легко определятся по спектральному отклику каскадных СЭ. В случае хорошо согласованных токов спектральный отклик имеет плоский вид в широком спектральном диапазоне. Если один из элементов ограничивает общий ток, то спектральный отклик не имеет такого плоского вида и по существу является спектральным откликом этого ограничивающего элемента.
В целом каскадные СЭ работают при больших напряжениях и меньших токах, чем одинарные солнечные элементы. Следствием меньших рабочих токов является уменьшение потерь на сопротивлениях.
Расчеты показывают, что максимальная величина КПД для одинарного СЭ на основе полупроводника с шириной оптической щели 1,7 эВ составляет 22 %, для тандемного СЭ на основе полупроводников с шириной оптической щели 1,95 и 1,4 эВ — 29 %, для тройного СЭ на основе полупроводников с шириной оптической щели 2,1, 1,7 и 1,25 эВ — 33 %.
В аморфном кремнии квазиуровни Ферми отстоят от границ разрешенных зон более чем на 2kT. Для такого невырожденного полупроводника выполняется статистика Больцмана и концентрацию свободных носителей можно определить по формулам
п = nc exppfn — ec)];
p = nv exP[(Ev — Ep)].
Для оценки заряда носителей, захваченных на состояния в запрещенной зоне рtrap, используются модели доноро — и акцептороподобных состояний, а также состояний амфотерного типа в щели подвижности a-Si:H. Как правило, принимается, что состояния на хвосте зоны проводимости являются акцептороподобными: они отрицательны, когда заняты электроном, и нейтральны, когда свободны от электрона. Состояния на хвосте валентной зоны имеют донороподобное поведение, доноро — и акцептороподобные состояния на хвостах зон — экспоненциальное распределение.
Принимается, что состояния, обусловленные оборванными связями, имеют амфотерное поведение, т. е. могут находиться и в доноро — и в акцептороподобном положении. Это объясняется тем, что они могут быть в трех зарядовых состояниях: положительно заряженном (свободны от электрона), нейтральном (на них находится один электрон) и отрицательном (заняты двумя электронами). В данном случае оборванная связь приводит к появлению двух энергетических уровней в щели подвижности: уровень Е+/0 соответствует переходу +/0, а уровень Е0/- — переходу 0/-. Расстояние между двумя уровнями соответствует энергии, которую необходимо затратить, чтобы на уже занятом состоянии появился второй электрон (корреляционная энергия ЕЦ). В модели структур энергетических зон в аморфных полупроводниках Мотта и Дэвиса принимается, что состояния, обусловленные оборванными связями, имеют гауссово распределение.
В этом случае заряд на доноро — и акцептороподобных состояниях равен соответственно
Ес
Pd = q I N(Е) [1 — f (Е)] dE;
Еу
Ес
Pa = — q I N(Е) f (Е¥Е,
Еу
|
|
|
|
|
|
 |

цесса захвата и два — эмиссии (рис. 7.4): r, Г4 — скорости захвата на уровень Et электрона и дырки соответственно; Г2, Г3 — скорости эмиссии электрона и дырки.
В табл. 7.1 охарактеризованы все процессы эмиссии и захвата электронов и дырок на доноро- и акцептороподобные состояния (см. рис. 7.4). В табл. 7.1 использованы следующие обозначения: Ta, Td — акцепторо — и донороподобные состояния соответственно; vth — тепловая скорость носителей; Nt — концентрация ловушек; , а° — сечение захвата ловушки
для электрона и дырки соответственно; e — , е0Р — коэффициент эмиссии
для захваченного электрона или дырки соответственно. Индексы «+», «О» и «-» означают зарядовое состояние ловушки.
Таблица 7.1
|
Процессы эмиссии и захвата электронов и дырок на доноро — и акцептороподобные состояния
|
В условиях термодинамического равновесия в соответствии с принципом детального равновесия ri = Г2 и Г3 = Г4. При этом вероятность заполнения состояния описывается функцией Ферми — Дирака:
f = [1 + exP(Et — ef)]-1.
Отсюда коэффициенты эмиссии равны
Общая скорость рекомбинации составляет
R = гі — Г2 = Г3 — Г4. (7.8)
Принимая во внимание это выражение, а также выражения для скоростей эмиссии и захвата, получаем функцию занятости:
Используя выражение (7.8) и подставляя в него выражения для Г1, Г2, Г3 и Г4, определяем эффективность рекомбинации:

![]() R 2 + 0
R 2 + 0
Лг _ ~^thanap
Nt
 |
|
Тейлор и Симмонс показали, что выражение (7.9) может быть аппроксимировано выражением
Выражение (7.10) может быть преобразовано следующим образом:

-1-1
Квазиуровень Ферми для захваченных электронов равен
![]() nan + pa p
nan + pa p
Nc a+
Аналогично функция заполнения дырок
 |
||
|
||
|
||
 |
||
 |
|
|
 |
||
|
||
 |
||
 |
||
|
||
 |
В табл. 7.2 даны пояснения к процессам, представленным на рис. 7.5.
Таблица 7.2
Процессы эмиссии и захвата электронов и дырок
на состояниях амфотерного типа
|
Процесс |
Переход |
Скорость процесса |
|
Захват электрона |
D ++ e ^ D0 |
ri = nvth°+ndbf+ |
|
Эмиссия электрона |
D0 ^D++e |
r2 = en NDBF 0 |
|
Захват электрона |
D0 + e ^ D~ |
r3 = nvth°n, NDBF 0 |
|
Эмиссия электрона |
D — ^ D0 + e |
r4 = e~n NDBF- |
|
Захват дырки |
D0 + h ^ D+ |
r5 = pvth°°pNDBF 0 |
|
Эмиссия дырки |
D + ^ D0 + h |
r6 = e+pNDBF+ |
|
Захват дырки |
D — + h ^ D0 |
r7 = pvthF~pNDBF — |
|
Эмиссия дырки |
D0 ^D-+h |
r8 = epNDBF 0 |
 |
В табл. 7.2 D означает оборванную связь, F — функцию занятости, индексы «+», «0» и «-» — зарядовое состояние оборванной связи. Коэффициенты эмиссии в этом случае равны
Функции занятости для зарядовых состояний:
![]() _______ P0 Р~________ ;
_______ P0 Р~________ ;
N+P — + P0P — + N+N0 ’
_______ N+Р~________ ;
N+P — + P0P — + N+N0 ’
N 0 N+
![]() N+P ~ + P° P ~ + N+N 0
N+P ~ + P° P ~ + N+N 0
+ + . + 0 0.0 — — . — 0 0.0 где N = щи°п + ep; N = nvth^n+ep; P = pvth° p+en; P = pvth° p+en.

Используя эти выражения, определяем эффективность рекомбинации: Лг = r1 — r2 + r3 — r4 = vth (Рп — ni У
Средний заряд, приходящийся на одну оборванную связь, равен
Q = q ( f + — f -).
Теоретический расчет вольт-амперных характеристик солнечных элементов на основе аморфных полупроводников значительно осложняется квазинепрерывным распределением электронных состояний в щели подвижности. В запрещенной зоне кристаллических полупроводников присутствуют только отдельные дискретные уровни, которые действуют как рекомбинационные центры. Рекомбинационные процессы в этом случае описываются моделью Шокли — Рида — Холла. Как правило, вкладом носителей в общий пространственный заряд, захваченных на состояния в запрещенной зоне, можно пренебречь из-за низкой плотности состояний. В щели подвижности аморфного кремния существует квазинепрерывное распределение электронных состояний, которые в значительной степени влияют на электронные свойства материала. Вкладом носителей, захваченных на состояния в запрещенной зоне, в общий пространственный заряд уже нельзя пренебрегать. Кроме того, время жизни носителей заряда в значительной степени зависит от смещения, поскольку от него зависит число состояний, участвующих в процессах рекомбинации.
Как правило, при математическом описании работы приборов на основе аморфного кремния используются следующие допущения.
1. Принимается, что перенос носителей заряда осуществляется только по распространенным состояниям.
2. Имеются резкие границы подвижности, разделяющие носители на распространенные и локализованные состояния.
3. Заполнение локализованных состояний определяется свободными носителями заряда. Принимаются во внимание только процессы захвата и эмиссии между распространенными и локализованными состояниями, а возможностью обмена носителями между локализованными состояниями пренебрегается.
Указанные допущения справедливы при комнатных и более высоких температурах.
Практически во всех случаях используются одномерные модели устройств. В то же время реальные ^—-«-структуры солнечных элементов формируются на текстурированном слое для усиления рассеяния и поглощения света. В результате толщина слоев a-Si:H не однородна по площади.
Электронный и дырочный перенос в полупроводнике описывается
системой уравнений: уравнением Пуассона и уравнениями непрерывности
109

для электронов и дырок [18], [62], [96]-[97], которые для одномерного случая выглядят следующим образом:
![]()
![]() f 8p^
f 8p^
Jp = q pppE — Dp 8X
f 8n ^
Jp = q npnE ^ Dn ~
V 8x J
где pp, pn — подвижность дырок и электронов; Dn, Dp — коэффициенты
диффузии электронов и дырок; E — напряженность электрического поля.
С другой стороны, Jp и Jn определяются градиентом квазиуровней Ферми:
В общем виде вольт-амперные характеристики солнечных элементов на основе аморфных полупроводников могут быть получены в результате решения системы уравнений (7.3)-(7.7). Далее теоретически проанализирован заряд в полупроводнике, скорости генерации и рекомбинации, что необходимо для решения этой системы уравнений.
Измерение темновых вольт-амперных характеристик СЭ позволяет найти преобладающие механизмы переноса в солнечных элементах, которые определяют коэффициент формы, а также оценить такие важные параметры, как последовательное и шунтирующее сопротивления.
 |
|||
В солнечных элементах на основе кристаллических материалов, как правило, преобладают два механизма переноса носителей: диффузионный и рекомбинационный. В этом случае темновую ВАХ СЭ можно описать с помощью двухэкспоненциальной модели. С учетом шунтирующего и последовательного сопротивлений для темновой ВАХ СЭ получим
где RH, Rш — последовательное и шунтирующее сопротивления; П1, П2 — коэффициенты идеальности для диффузионного (п1 = 1) и рекомбинационного (п2 = 1-2) механизмов переноса.
Однако не всегда, особенно для СЭ на основе аморфных полупроводников, данная модель применима для описания темновой ВАХ, так как необходимо учитывать присутствие других механизмов переноса. В научно-технической литературе отмечается, что в этом случае могут действовать эффект Пула—Френкеля и туннелирование. Наличие указанных механизмов переноса может увеличить значения коэффициента идеальности превышающего 2.
Механизм Пула—Френкеля представляет собой ускоренный электрическим полем процесс термовозбуждения электрона с ловушек в зону проводимости. В этом случае запишем выражение
|
qP1/2 E1/2 ] |
* |
f qV 1 |
-1 |
|
|
2kT |
niW |
exp |
12kT J |
|
Iпф к exp |
или
|
T ЛГ.3/2 |
і 1 >75 я + to to __ 1 |
* |
f qV 1 |
||
|
1 пф x T exp |
2kT |
niW |
exp |
12kT J |
-1 |
где E — электрическое поле в области рекомбинационного центра; Р = q/ns
(s — диэлектрическая проницаемость); nj — собственная концентрация но*
сителей; W — эффективная толщина области пространственного заряда;.
Для СЭ с высокой плотностью дефектов возможно присутствие механизма туннелирования. Ток при туннелировании описывается соотношением
It = I03 exp (AV), (7.1)
где 103 = B exp(a£g (T ))(B — коэффициент, отвечающий за вероятность
туннелирования; a — коэффициент, не зависящий от температуры; Eg(T) — ширина запрещенной зоны, зависящая от температуры; A — коэффициент, не зависящий от температуры).
В работах Матсууры показано [93]-[95], что в гетероструктурах на основе аморфного гидрогенизированного кремния преобладает механизм многоступенчатого туннелирования с захватом и эмиссией носителей заряда (рис. 7.3).
При этом механизме дырки из валентной зоны c-Si ^-типа перемещаются в аморфный полупроводник от одного локализованного состояния к другому, которые различаются по энергии на величину порядка kT, за счет многоступенчатых процессов туннелирования. Подобное перемещение носителей продолжается до тех пор, пока скорость туннелирования не становится меньше скорости эмиссии дырок в валентную зону либо скорости ре-
 |
||
комбинации дырок с электронами из зоны проводимости аморфного полупроводника. Конечная точка туннелирования дырок находится вблизи края области обеднения аморфного полупроводника, где скорость туннелирования снижается из-за уменьшения величины электрического поля. В этом случае I03 в выражении (7.1) определяется как
 |
где B — постоянная, зависящая от вероятности туннелирования носителей; op, on— сечения захвата для электронов и дырок соответственно; vth — термическая скорость; Ny, Nc — эффективные плотности состояний в валентной зоне и зоне проводимости аморфного полупроводника соответственно; Ej, Ey, Ec, Ef — энергии, соответствующие уровням Ферми и ловушек, краям валентной зоны и зоны проводимости.
Наибольшей эффективности солнечных элементов удалось достичь при использовании p-i-n-структур (рис. 7.1) [12], [17], [18], [21], [27], [30], [49], [92]. Широкая нелегированная /-область a-Si:H обеспечивает поглощение света и соответственно эффективную работу элемента. В отличие от кристаллических солнечных элементов на основе p-n-переходов, где носители заряда, имея большую диффузионную длину (100-200 мкм), достигают электродов и в отсутствие электрического поля, в солнечных элементах на основе a-Si:H носители заряда могут достигать электродов в основном только за счет внутреннего электрического поля, т. е. за счет дрейфа носителей заряда, так как диффузионная длина дырок в a-Si:H очень мала (~100 нм). Поскольку в простом p-n-переходе на основе a-Si:H область сильного электрического поля очень узка и сосредоточена вблизи перехода, а диффузионная длина носителей заряда мала, то в большей части солнечного элемента не происходит
101
эффективного разделения носителей заряда, генерируемых за счет поглощения света. Следовательно, для получения эффективных солнечных элементов на основе аморфного гидрогенизированного кремния необходимо создать во всей области оптического поглощения света (i-область) однородное и максимальное внутреннее электрическое поле.
pin
|
|
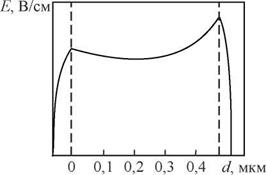 |
Рис. 7.1. Энергетическая зонная диаграммаp-i-n-структуры (а)
и расчетное распределение электрического поля (б)
В условиях термодинамического равновесия и отсутствия освещения p и n-слои в p-i-n-структуре имеют положительный и отрицательный заряды соответственно, что и приводит к образованию электрического поля в і-слое. При освещении p-i-n-структуры свет проходит через тонкое фронтальное окно p-типа, поглощается в толстом і-слое, где генерирует электронно-дырочные пары, разделение которых происходит электрическим полем в і-слое. Как правило, толщина і-слоя находится в диапазоне от 200 до 500 нм, а слоев p — и n-типа — в диапазоне от 10 до 30 нм. Дырки и электроны, генерируемые светом в слоях n — и p-типа, не вносят вклад в фототок СЭ из-за малого времени жизни носителей в сильнолегированных слоях a-Si:H. На рис. 7.1 представлены энергетическая зонная диаграмма p-i-n-структуры и расчетное распределение электрического поля в і-области a-Si:H толщиной 0,5 мкм. В данном случае напряженность электрического поля во всей і-области превышает 104 В/см и длина дрейфа дырок ртЕ (рт = 3-10-9 см2/В) составляет 0,5 мкм, т. е. соизмерима с размерами области поглощения (і-область).
Наклон зон в і-слое приводит к тому, что уровень Ферми в этом слое в области, прилегающей к p-слою, смещен в сторону потолка валентной зоны, а в области, прилегающей к n-слою, — в сторону дна зоны проводимости (см. рис. 7.1). В результате часть состояний в оптической щели в і-слое вблизи p — и n-слоев приобретает положительный и отрицательный заряд
соответственно. Эти заряженные дефекты усиливают электрическое поле вблизи p/i и n/i-границ раздела. В то же время электрическое поле в объеме i-слоя уменьшается.
Свойства p/i-границы раздела оказывают существенное влияние на характеристики СЭ и их стабильность при освещении. Введение слоя собственного широкозонного a-SiC:H на границе p/i-раздела увеличивает напряжения холостого хода из-за уменьшения рекомбинации на границе раздела. Формирование слоя с изменяющимися содержанием C и шириной запрещенной зоны дополнительно увеличивает напряжение холостого хода и коэффициента формы. Однако введение этого слоя сопровождается дополнительной деградацией характеристик СЭ, так как он влияет на перераспределение электрического поля при освещении.
Критическое влияние на характеристики СЭ оказывает граница раздела TCO/p-слой. Дырки из p-слоя рекомбинируют на границе TCO/p-слой с электронами из высоколегированного (до уровня вырождения) слоя TCO n-типа. В зависимости от качества TCO/p-слоя может произойти заметное обеднение аморфного p-слоя, что создаст барьер на границе TCO/p-слой.
Наличие хвостов зон в слое a-Si:H ведет к уменьшению встроенного поля в i-области и напряжения холостого хода СЭ по сравнению с теоретически оцениваемой из зонной энергетической диаграммы величиной их х.
|
Al/Ti (~100 нм) |
ITO (~70 нм) |
|
|
n-слой (~20 нм) |
n-слой (~20 нм) |
|
|
a-Si:H (~700 нм) |
a-Si:H (~500 нм) |
|
|
p-слой (~8 нм) |
p-слой (~20 нм) |
|
|
ITO (~60 нм) |
Сталь |
|
|
Стекло |
|
f f hv |
a б
Рис. 7.2. p-i-n-структура на стеклянной (а) и стальной (б) подложке При изготовлении p-i-n-структур солнечные элементы с лучшими параметрами удается получить, когда первым создается p-слой (рис. 7.2). Это объясняется тем, что при получении p-слоя используется небольшое количество бора (<1018 см3), а значит, существенного загрязнения нелегированного слоя не происходит. В то же время, если первым осаждать «-слой, то наличие остаточного фосфора изменяет свойства /-слоя. Создание p-слоя на поверхности прозрачного проводящего электрода обеспечивает хороший электрический контакт с электродом. Однако рекомендуется создавать достаточно тонкую p-область (10 нм), чтобы основная часть света поглощалась в /-области. Кроме того, в этом случае сокращается путь, проходимый дырками до электрода, и увеличивается эффективность их сбора.
Вторая конструкция солнечного элемента (рис. 7.2, б) отличается от первой тем, что в качестве подложки используется металлическая фольга, в частности из нержавеющей стали, и освещение осуществляется со стороны прозрачного электрода, контактирующего с n-областью. Это обеспечивает большую величину плотности тока короткого замыкания, которая достигается за счет отражающей способности металлической подложки и меньшего оптического поглощения света пленками a-Si:H, легированными фосфором (n-область), по сравнению со слоями, легированными бором.
Ток короткого замыкания и выходная мощность солнечного элемента увеличиваются введением отражающего слоя и использованием текстурированной подложки. Это позволяет увеличить поглощение той части фотонов, которая слабо поглощается i-слоем. Задний отражающий слой вдвое увеличивает путь, проходимый фотоном. Более ощутимый эффект дает применение текстурированной подложки. В этом случае в результате отражения от текстурированной поверхности подложки обеспечиваются условия полного внутреннего отражения. Свет как бы захватывается солнечным элементом. Таким образом удается до 25 % увеличить ток короткого замыкания.
В общем фронтальная поверхность вносит основной вклад в рассеяние света в СЭ на длинах волн от 450 до 650 нм, а тыльная поверхность — более 650 нм. Таким образом, для усиления эффекта «захвата солнечного света» в максимальном диапазоне длин волн необходимо, чтобы СЭ имели развитую фронтальную и тыльную поверхности.
Свойства слоя прозрачного проводящего оксида существенно влияют на характеристики формируемого СЭ. Такие слои должны обладать высокой прозрачностью для солнечного излучения, иметь низкое удельное поверхностное сопротивление, чтобы минимизировались потери на последовательном сопротивлении, обеспечивать низкое контактное сопротивление к слою p-типа. Высокое контактное сопротивление приводит к понижению напряжения холостого хода и коэффициента формы. Значительно влияет на контактное сопротивление между слоями SnO2 и a-SiC:H p-типа температура осаждения. Кроме того, TCO должен быть стойким к водородному восстановлению при плазмохимическом осаждении других слоев.
Для формирования фронтального электрода используются прозрачные проводящие оксиды: SnO2:F, ІП2О3 — SnO2 (ITO) ZnO:Al. Они обладают высокой прозрачностью (>90 %), большой шириной запрещенной зоны (>3,5 эВ), низким удельным поверхностным сопротивлением (<10 Ом).
Очень эффективным является повышение КПД каскадных СЭ при использовании TCO, которые обеспечивают увеличение поглощения за счет многократного внутреннего отражения солнечного света. Однако в сильно текстурированных слоях наблюдается понижение напряжения холостого хода в СЭ с более тонкими /-слоями из-за увеличения плотности дефектов в /-слое. Известно, что в солнечных элементах на основе a-Si:H, формируемых на слое SnO2, их х снижается с уменьшением толщины р-слоя.
Для формирования текстурированного диоксида олова используется метод химического осаждения из газовой фазы при атмосферном давлении и температуре 550 °С. Оксид цинка и оксид индия-олова (ITO) наносятся с помощью методов распыления или испарения при более низких температурах и, как правило, не являются текстурированными. Неровная поверхность оксида цинка может быть получена в результате травления в HCl. Применение оксида цинка приводит к образованию высокого контактного сопротивления с a-Si:H. Для получения более низкого контактного сопротивления можно использовать слои легированного микрокристаллического кремния.
Перспективным материалом для формирования TCO является ZnO. Прозрачность слоя SnO2 ухудшается в плазме из-за его химического восстановления, что приводит к заметному поглощению в слое. Кроме того, SnO2 менее прозрачен в видимой области спектра (пропускание составляет 94 %), чем ZnO (пропускание составляет 97 %). Это уменьшает ток короткого замыкания СЭ с TCO на основе SnO2 на 10 %. Проблемы использования ZnO связаны с образованием барьера на контакте ZnO/a-SiC:H p-типа, сложностью обеспечения чистого лазерного скрайбирования, высоким шунтирующим током.
Рассмотрим текстурированные стеклянные подложки со слоем TCO (рис. 7.2, а). После формирования р-/-п-структуры осаждается задний отражающий слой. Наилучшими отражающими характеристиками обладает
Ag, применяется также Al. Однако на границе раздела Si/Ag отражение ухудшается из-за взаимной диффузии элементов. Для предотвращения этого между Si и Ag вводится буферный слой ZnO. Для получения текстурированной поверхности, рассеивающей свет, осаждение слоев Ag и ZnO производят при высоких температурах: от 100 до 400 °С. Однако для СЭ на стеклянной подложке температура осаждения заднего слоя TCO ограничена из-за того, что p-i-n-структура уже сформирована. Со временем отражение контакта ZnO/Ag ухудшается, что приводит к уменьшению тока короткого замыкания на 3-4 %. Подобного эффекта не наблюдается при использовании заднего отражающего контакта ZnO/Al.
В солнечных элементах, изготовленных на подложке из нержавеющей стали (рис. 7.2), формируется текстурированный задний отражающий слой из Ag или Al, на который осаждается задний слой TCO, p-i-n-структура и фронтальный слой TCO. Формирование металлической сетки Ag на слое TCO снижает удельное поверхностное сопротивление.
Для одинарных СЭ оптимальной шириной оптической щели для материала i-слоя является 1,7 эВ. При использовании такого полупроводника получают напряжение холостого хода до 0,9 В и коэффициент формы ~0,75.
Важнейшую роль в использовании пленок a-Si:H для создания солнечных элементов сыграл тот факт, что оптическое поглощение a-Si:H в 20 раз превышает оптическое поглощение кристаллического кремния. Для существенного поглощения видимого солнечного света достаточно получить пленки a-Si:H толщиной 0,5—1,0 мкм вместо использования дорогостоящих кремниевых подложек толщиной 300 мкм. Кроме того, перспективна и технологическая возможность получать слои аморфного кремния в виде тонких пленок большой площади. В данной технологии отсутствуют технические потери, связанные с резкой, шлифовкой и полировкой, при изготовлении элементов солнечных батарей на основе монокристаллического кремния. Преимущества солнечных элементов на основе a-Si:H по сравнению с аналогичными поликристаллическими кремниевыми элементами обусловлены более низкими температурами их изготовления (573 К), что позволяет использовать дешевые стеклянные подложки с нанесенными на их поверхность прозрачными проводящими оксидами (ТСО), выполняющими функцию электродов токосъема. Данные факторы ведут к снижению срока окупаемости солнечных элементов на основе аморфного кремния, и в перспективе стоимость подобных СЭ будет значительно снижена.
Важное достоинство СЭ на основе a-Si:H — отсутствие вредных, токсичных веществ в изготовленных солнечных фотоэлементах.
Для обеспечения эффективной работы солнечных элементов необходимо, чтобы были выполнены следующие требования:
• оптический коэффициент поглощения а активного слоя полупроводника выбирается достаточно большим, чтобы обеспечить поглощение существенной части энергии солнечного света в пределах толщины слоя;
• необходимо, чтобы генерируемые при освещении электроны и дырки эффективно собирались на контактных электродах с обеих сторон активного слоя;
• солнечный элемент должен обладать значительной высотой барьера в полупроводниковом переходе;
• необходимо обеспечить малое полное сопротивление, включенное последовательно с солнечным элементом (исключая сопротивление нагрузки) для снижения потерь мощности (джоулево тепло) в процессе работы;
• тонкие пленки, входящие в состав солнечного элемента, должны быть однородны по толщине на большой площади, чтобы исключить эффект закорачивания шунтирования активной области.
Оптическая ширина запрещенной зоны пленок a-Si:H, применяемых при создании солнечных элементов, как правило, изменяется в пределах 1,7…1,8 эВ. Ширина зависит от условий осаждения пленок и концентрации водорода. Экспериментально установлено, что содержание водорода уменьшается с повышением температуры подложки. В слоях a-Si:H, используемых в солнечных элементах, концентрация водорода обычно составляет 5-15 ат. %.
Другими важными параметрами, определяющими эффективность работы солнечных элементов, являются подвижность и время жизни фотоге — нерированных носителей заряда. Экспериментальные измерения дрейфовой подвижности электронов в слоях a-Si:H показали, что при комнатной температуре ~ 10-1см2/В и с повышением температуры увеличивается с энер
гией активации ~ 0,19 эВ. Величина подвижности электронов по делокализованным состояниям составляет приблизительно 10 см2/В-с. Величина дрейфовой подвижности дырок для слоев a-Si:H:B при комнатной температуре составляет ~ 6-10-4 см2/В-с и с повышением температуры увеличивается с энергией активации ~ 0,35 эВ. Время жизни неравновесных носителей заряда в a-Si:H обычно составляет 10-30 мкс при плотности инжекци — онного тока ~ 10 мА/см2.
Для определения влияния температурной обработки на свойства слоистых пленок a-Si:H, содержащих нанокристаллические включения, проводился отжиг пленок с оптимальным L = 16 нм в вакууме в течении одного часа при температурах 350, 450, 550 °С. Модификация структуры слоистых пленок a-Si:H на кремниевой подложке исследовалась с помощью электронной микроскопии [87]-[89]. После отжига в вакууме при 450 °С в течение одного часа слоистая структура пленок a-Si:H, полученных в циклическом режиме, заметно размывается (рис. 6.25, а), а отжиг при температуре 550 °С в течение часа делает пленку практически однородной по сечению (рис. 6.25, б). Для пленок a-Si:H, отожженных при температуре 450 и 550 °С наблюдалось некоторое увеличение размера и числа нанокристаллических включений (рис. 6.26). Так после отжига при 450 °С средняя площадь увеличилась с 20 до 60 нм2, а после отжига при 550 °С — до 75 нм2. Это соответствует возрастанию среднего диаметра кристаллитов с
4- 5 до ~ 8-9 нм, соответственно. Процесс кристаллизации в пленках весьма затруднен, о чем свидетельствует малое изменение объемной доли нанокри
сталлической фазы после температурной обработки. Доля занимаемая нанокристаллической фазы увеличилась с 1 % для неотожженной пленки до 4 % после отжига при 450 °С и до 7 % при 550 °С (см. рис. 6.25). При оценке объемной доли кристаллической фазы в пленке после отжига при 550 °С, считая, что нанокристаллиты имеют форму сферы, получаем величину равную примерно 2 %. Столь малая объемная доля нанокристалличекой фазы также не была обнаружена методом рамановской спектроскопии (см. рис. 6.9, б).
 ,L —
,L —
30 нм
а
Рис. 6.25. Фотография ПЭМ в светлопольном контрасте
сечения пленки a-Si:H осажденной с использованием
промежуточного отжига в водородной плазме после отжига
в вакууме при 450 °C (а) и 550 °C (б) в течение одного часа
Следует отметить, что при практически двукратном увеличении объемной доли нанокристаллов после отжига пленок при 450 и 550 °С, характер их распределения по площади сечения, показанный на гистограммах (см. рис. 6.26), меняется незначительно и не происходит существенного сдвига плотности распределения в сторону больших размеров. Это говорит о том, что после отжига при 550 °С объемная доля нанокристаллов возрастает не за счет роста размеров нанокристаллов, а за счет увеличения их числа.
На основании полученных результатов было выдвинуто предположение, что в слоистых пленках при отжиге в вакууме образование кристаллитов происходит в слоях однородного аморфного гидрогенизированного кремния, и рост нанокристаллитов сдерживается интерфейсами с повышенным содержанием водорода. Это подтверждается исследованиями структурных модификаций после отжига в вакууме тонких свободных пленок a-Si:H, осажденных на подложки из NaCl.
Исследования проводились на двух видах пленок:
1) пленки, полученные в непрерывном режиме в течение 6 мин толщиной ~ 40 нм (без отжига слоев в водородосодержащей плазме);
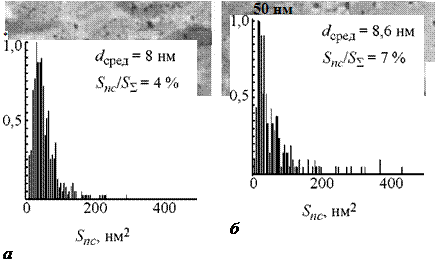 |
Рис. 6.26. Фотографии ПЭМ в темнопольном контрасте поверхности
пленок a-Si:H осажденных с использованием промежуточного отжига
в водородной плазме после отжига в вакууме при T = 450 °C (а)
и 550 °C (б) и соответствующие им гистограммы распределения
нанокристаллитов по площади сечения
2) слоистые пленки, полученные методом циклического осаждения с промежуточной откачкой при смене газовой смеси. Отжиг каждого из трех слоев толщиной 12 нм в водородосодержащей плазме проводился в течении 3 мин при удельной мощности ВЧ-разряда — 200 мВт/см2 и давлении газовой смеси (80 %Ar + 20 %H2) — 25 Па. В исходном состоянии нанокристаллических включений в пленках не наблюдалось.
Результаты электронномикроскопического исследования образцов, термически отожженных при 450 °С в течение 30 мин, приведены на рис. 6.27. После отжига при 450 °С в обеих пленках наблюдается формирование нанокристаллических включений, размером 10-12 нм, занимающих площадь 1-2 %. Появление нанокристаллической фазы в пленках a-Si:H отражается на микродифрактограммах (рис. 6.27). Это позволяет судить об объемной доле кристаллической структуры, которая составляет единицы процентов.
 |
Дальнейшее повышение температуры отжига в вакууме показало, что после термообработки при температуре 750 °С пленки кремния, полученные в режимах 1 и 2, характеризуются совершенно различной структурой (рис. 6.28). Пленка, полученная непрерывным плазмохимическим осаждени-
ем, имеет поликристаллическую структуру и состоит из достаточно крупных (1 мкм и более) кристаллитов (см. рис. 6.28, а). На микродифрактограмме видны рефлексы от отдельных кристаллитов. В то же время пленка, полученная с применением промежуточного отжига в водородной плазме, содержит кристаллиты, типичные размеры которых составляют 10-12 нм (рис. 6.28, б), а отсутствие диффузных колец на микродифрактограмме свидетельствует о преобладающей доле нанокристаллической фазы. Из анализа электронных дифрактограмм следует, что в поликристаллических пленках кремния превалируют кристаллиты с ориентацией [111] по нормали к поверхности.
Таким образом, в слоистых пленках средний размер кристаллитов не превышает толщину слоя, осаждаемого за цикл. Это позволяет управлять размером и долей нанокристаллических включений кремния, что может быть использовано при создании люминесцентных пленок.
|
Рис. 6.29. Зависимости Oph и Oph/Od от температуры отжига для пленки a-Si:H, полученной циклическим методом с L = 16 нм Зависимости темновой и фотопроводимости слоистых пленок от температуры отжига представлены на рис. 6.29. При температурах отжига выше 350 °С наблюдается резкое увеличение темновой проводимости, снижение фотопроводимости и, как результат, уменьшение фоточувствительности пленок a-Si:H до 8-104 (см. рис. 6.29). После отжига при температуре 450 °С фоточувствительность снижается до 102, а после отжига при 550 °С фоточувствительность практически полностью утрачивается. Очевидно, что столь малая объемная доля нанокристаллической фазы не может приводить к увеличению проводимости исходя из представлений теории протекания, а рост темновой проводимости Od, по-видимому, связан с увели- |
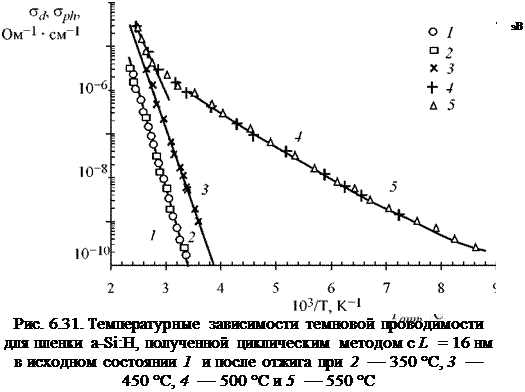 |
чением плотности состояний в пленке a-Si:H. По мере повышения температуры термообработки происходит эффузия водорода, приводящая к повышению плотности локализованных состояний. Как видно из рис. 6.30, концентрация водорода Ch в пленке a-Si:H уменьшается с 17 % в исходной пленке до 10 % — после отжига при 350 оС, 6 % — при 450 оС, а при температурах термообработки выше 500 оС становится менее 2 % [77].
Процесс эффузии водорода сопровождается уменьшением энергии активации Ea с 0,9 до 0,71 эВ после отжига при 450 °С, что связано с уменьшением ширины зоны. При температурах отжига выше 500 °С происходит изменение характера температурной зависимости темновой проводимости. На рис. 6.31 имеются два участка [80]: в области температур больше 380 К — экспоненциальный участок с энергией активации 0,51 эВ соответствует зонной проводимости — при температурах меньше 380 К — проявляется прыжковая проводимость по оборванным связям вблизи уровня Ферми и температурная зависимость описывается выражением для прыжковой проводимости:
®d(T) = A exp [-(T0/T)m] , где A = 80 Ом-1-см-1, T0= 2,8-106 К, m = 0,325.
Зависимость темновой проводимости аналогична для пленок аморфного кремния c малым содержанием водорода (2-3 %) и свидетельствует о высокой степени дефектности материала, вызванной эффузией водорода из пленки.
|
Рис. 6.32. Кинетика изменения фотопроводимости, приведенной к начальной величине, для пленки a-Si:H, полученной циклическим методом с L = 16 нм в исходном состоянии и после отжига при температурах 350 и 450 °С Отжиг в вакууме пленки, полученной циклическим методом с оптимальным L = 16 нм, позволяет еще больше повысить ее стабильность. На рис. 6.32, где представлены результаты по фотоиндуцированной деградации для этой же пленки до отжига и после отжига в вакууме при температурах 350 и 450 °С в течении одного часа. Из полученных данных практический интерес представляет отжиг при 350 °С, после которого стабиль- |
ность пленок значительно возрастает при сохранении отношения Oph/od равного 8-104. Пленки осажденные в циклическом режиме непосредственно при температуре 350 °С обладают очень малой фоточувстительностью CTph/CTd = 6 и энергией активации 0,48 эВ.
На основании исследования пленок a-Si:H, полученных методом циклического осаждения, можно сделать следующие выводы:
1. Впервые с помощью метода циклического осаждения были получены слоистые пленки аморфного гидрогенизированного кремния, содержащие нанокристаллические включения на границах слоев, обладающие повышенной фоточувствительностью (соотношение op^/^d достигает 107 при освещенности 100 мВт/см2) и стабильностью (изменение фотопроводимости в 2,5 раза меньше после воздействия дозы облучения 120 Дж/см2 по сравнению с однородными пленками).
2. Повышение фоточувствительности слоистых пленок a-Si:H обусловлено снижением темновой проводимости, что связано с увеличением концентрации водорода.
3. Показано, что образование нанокристаллических включений в пленках a-Si:H происходит непосредственно в процессе отжига в плазме за счет осаждения кремния из разбавленного водородом остаточного моносилана.
4. Обнаружено, что пленки, получаемые циклическим методом осаждения, характеризуются неоднородным распределением водорода по толщине, что приводит к возникновению дублетов в спектрах фотопроводимости. Неоднородность распределения водорода сохраняется после отжига при температуре не более 450 °С в вакууме, что подтверждается теоретическим расчетом перераспределения концентрации водорода, находящегося в сильных связях с кремнием.
5. Выявлено, что средний размер нанокристаллических включений в слоистых пленках после отжига в вакууме вплоть до температуры 750 °С не превышает толщину слоев пленок a-Si:H, осаждаемых за один цикл, что позволяет управлять размером и содержанием нанокристаллических включений в пленках a-Si:H.
6. На основе слоистых пленок аморфного гидрогенизированного кремния, содержащих нанокристаллические включения, созданы фото приемные структуры с барьером Шоттки, обладающие высокой спектральной чувствительностью (не менее 0,04 А/Вт) в диапазоне 200-400 нм и максимальной чувствительностью 0,2 А/Вт на длине волны 480 нм [90], [91].
Для выяснения процессов, протекающих при циклическом осаждении, представляют интерес исследования по спектрам ИК поглощения зависимостей концентрации водорода и типа связи от толщины слоя L, осаждаемого за цикл, для пленок a-Si:H (рис. 6.11). Видно, что в пленках, полученных в непрерывном режиме, концентрация водорода составляет 8 ат.%, а в пленках, полученных с использованием промежуточного отжига в водородной плазме, содержание водорода выше.
Следует отметить что, с уменьшением толщины слоя L до 12 нм возрастает концентрация водорода и доля SiH2-связей. Это свидетельствует о том, что при отжиге в водородной плазме происходит обогащение пленки водородом. Уменьшение соотношения связей SiH/SiH2 с ростом концентрации водорода может быть обусловлено тем, что водород в виде SiH2-связей пассивирует поверхность нанокристаллических включений кремния [71]. При даль-
79
|
|
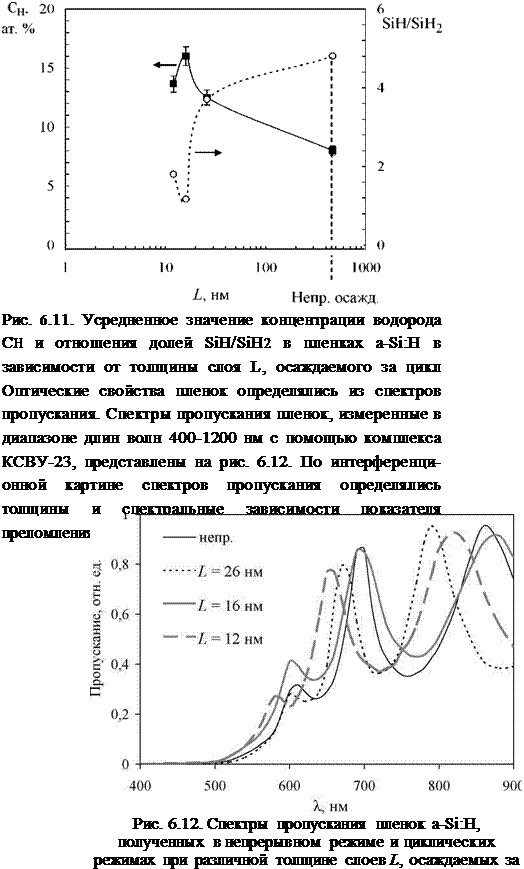 |
 |
(a — n — hv)1/2 от hv (рис. 6.13), по которой определяется оптическая ширина запрещенной зоны a-Si:H по Тауцу.
Рис. 6.14. Зависимость оптической ширины запрещенной зоны Eg,
энергии активации темновой проводимости Ea и показателя преломления
на длине волны 800 нм от толщины слоя, осаждаемого за цикл L
преломления (на длине волны 800 нм) от толщины слоя, осаждаемого за цикл L представлены на рис. 6.14. Зависимости коррелирует с зависимостью концентрации водорода от L (см. рис. 6.11). С ростом концентрации водорода с 8 до 16 ат. % при уменьшении L до 16 нм величина Eg увеличивается от 1,82 до 1,85 эВ, а показатель преломления уменьшается от 3,75 до 3,35. Затем с уменьшением концентрации водорода наблюдается падение величины Eg = 1,81 эВ и рост показателя преломления.
Для определения темновой проводимости Gd и фотопроводимости Gph
пленок а-SnH на ситалловых подложках формировались тонкопленочные резисторы с алюминиевыми электродами с расстоянием между электродами 0,2 мм и коэффициентом формы 0,018. Измерения показали, что величина тока линейно растет с увеличением напряженности электрического поля до 500 В/см. Все измерения проводились при напряженности поля 100-250 В/см. Фотопроводимость измерялась на длинах волн 365 и 436 нм. В этом случае преимущественное поглощение фотонов происходит в приповерхностном слое толщиной порядка 100 нм. Измерения осуществлялись на установке, которая позволяла проводить исследования в двух режимах освещения: на длинах волн 365 и 436 нм с интенсивностью 0,17 мВт/см2 и в видимой области спектра с интенсивностью 100 мВт/см2 [75].
|
Рис. 6.15. Зависимость темновой и фотопроводимости, а также их отношения от толщины пленки, осаждаемой за цикл |
Полученные зависимости темновой oj и фотопроводимости Oph, а
также их отношения от толщины слоя, осаждаемого за цикл L, представлены на рис. 6.15. С уменьшением L фоточувствительность возрастает. Причем рост фоточувствительности связан с уменьшением темновой проводимости. При дальнейшем уменьшении толщины пленки, осаждаемой за цикл, наблюдается увеличение темновой проводимости. Уменьшение тем — новой проводимости является отличительной чертой получаемых пленок.
Наибольшей фоточувствительностью обладают пленки, полученные в циклическом режиме с толщиной осаждаемых за цикл слоев 12-16 нм. Их фоточувствительность Oph / Od при освещении AM1 (100 мВт/см2) достигает величины 107, что как минимум на порядок превосходит максимальные значения фоточувствительности, достигаемые на пленках a-Si:H.
|
Рис. 6.16. Температурная зависимость темновой проводимости (до и после освещения) и фотопроводимости (при освещенности 4 и 90 мВт/см2) для однородной пленки a-Si:H Температурные зависимости темновой проводимости до и после освещения (30 мин, 90 мВт/см2) и фотопроводимости при освещенности 4 и 90 мВт/см2 для пленки, полученной в постоянной газовой смеси, представлены на рис. 6.16. Рассмотрим аналогичные зависимости для пленки, полученной в циклическом режиме с толщиной слоя, осаждаемого за цикл L = 16 нм, которая соответствует максимальной фоточувствительности (рис. 6.17). Измерение температурных зависимостей проводилось в диапазоне температур 100-470 К при медленном нагреве пленок a-Si:H после их предварительно- |
го отжига при температуре 190 °С в вакууме 1,33-10-4 Па в течение 30 мин. Измерения фотопроводимости осуществлялись при кратковременном освещении пленок галогенной лампой с инфракрасным фильтром [80].
|
Рис. 6.17. Температурная зависимость темновой проводимости (до и после освещения) и фотопроводимости (при освещенности 4 и 90 мВт/см2) для пленки, полученной в циклическом режиме с L = 16 нм Во всем температурном интервале темновая проводимость экспоненциально зависит от температуры: |
®d (T =^0 exp(-£a / kT).
Значения энергии активации темновой проводимости Ea 0,8-0,9 эВ из представленного выражения характерны для зонной проводимости a-Si:H, т. е. перенос носителей происходит по делокализованным состояниям. Зависимость Ea от L показана на рис. 6.14.
Для пленок, полученных методом циклического осаждения с оптимальной толщиной осаждаемого за цикл слоя, практически отсутствует эффект температурного гашения фотопроводимости и наблюдается слабое различие между температурными зависимостями темновой проводимости до и после освещения. Это является подтверждением более высокого качества пленок, полученных циклическим методом.
В зависимости от толщины слоя L изменение таких параметров пленок как содержание водорода, отношение долей SiH к SiH2, оптическая ширина запрещенной зоны, темновая проводимость и энергия активации взаимосвязано и характеризуются общей тенденцией. С уменьшением толщины L на-
84
блюдается возрастание концентрации водорода, сопровождающееся увеличением оптической ширины запрещенной зоны и энергии активации, уменьшением темновой проводимости. При этом возрастает доля Sffl^-
связей. При толщине слоев менее 10 нм наблюдаются спад концентрации водорода, уменьшение оптической ширины запрещенной зоны, энергии активации, доли SiH2 связей и рост темновой проводимости. Анализ полученных зависимостей позволяет считать, что L = 12-16 нм является оптимальной толщиной слоя, осаждаемого за цикл.
На основании анализа экспериментальных данных была предложена модель, согласно которой в течении одного цикла за время отжига в водородной плазме водород диффундирует на глубину меньшую чем толщина слоя осаждаемого за предыдущий цикл. При периодическом чередовании осаждения и отжига это приводит к неравномерному распределению водорода и, следовательно, к модуляции ширины запрещенной зоны Eg по толщине пленки [81].
Таким образом, пленки a-Si:H, полученные в циклическом режиме, обладают варизонной структурой, заключающейся в периодическом чередовании слоев с большей Eg (интерфейсы, обогащенные водородом и содержащие нанокристаллические включения) и меньшей Eg (слои однородного a-Si:H) (рис. 6.18).
|
Рис. 6.18. Энергетическая диаграмма, распределение водорода и схематическое изображение среза для пленки a-Si:H, полученной в циклическом режиме осаждения 85 |
При планарной конфигурации электродов перенос носителей осуществляется по слоям с меньшей и, следовательно, обладающих большей проводимостью. По мере уменьшения L эффективная площадь сечения этих слоев уменьшается, что приводит к снижению темновой проводимости.
Варизонная структура пленки объясняет обнаруженную характерную особенность пленок, полученных циклическим методом. Эта особенность заключается в возникновении дублетов в спектрах фотопроводимости таких пленок, в отличии от спектров пленок, полученных в непрерывном режиме, имеющих один максимум [82], [83]. Спектры фотопроводимости пленок a-Si:H снимались с использованием комплекса КСВУ-23 и электрометра В7-30. Спектры фотопроводимости для пленок, полученных в непрерывном режиме и циклическом режиме с различной толщиной слоев L, показаны на рис. 6.19.
Возникновение дублетов связано с вариацией ширины зоны по толщине пленки, вызванной неоднородным распределением водорода. Длинноволновый максимум соответствует поглощению в областях с меньшей шириной зоны, а коротковолновый — в областях с повышенной концентрацией водорода и, следовательно, большей шириной зоны. Различие в положении пиков составляет примерно 0,2 эВ, которое хорошо коррелирует с флуктуацией оптической ширины запрещенной зоны за счет неравномерного распределения водорода. С уменьшением L возрастает вклад в фотопроводимость областей с повышенным содержанием водорода.
|
Рис. 6.19. Спектры фотопроводимости пленок a-Si:H, осажденных в непрерывном и циклическом режиме с различной толщиной слоев |
Подтверждением связи возникновения дублетов с неоднородным распределением водорода является поведение спектров фотопроводимости после отжига в вакууме при различных температурах. Спектры фотопроводимости для пленок с L = 16 нм, отожженных при разных температурах, представлены на рис. 6.20. С ростом температуры отжига, наряду с общим смещением спектров в длинноволновую область, связанным с эффузией водорода из пленок, приводящем к уменьшению оптической ширины зоны, происходит параллельный сдвиг положения пиков. Сдвиг свидетельствует о том, что положение пиков определяется концентрацией водорода, и, следовательно, является подтверждением того, что возникновение дуплета обусловлено наличием в пленке областей с различным содержанием водорода. После отжига пленок в течении часа при температурах вплоть до 450 °С не происходит полного размытия этих двух пиков на спектрах фоточувствительности, что свидетельствует о сохранении неоднородности распределения концентрации водорода по толщине пленок после термообработки.
|
Рис. 6.20. Спектры фотопроводимости пленки, полученной в циклическом режиме с L = 16 нм, после отжига в вакууме при различных температурах Для подтверждения предложенной модели о варизонной структуре пленки необходимо получить данные о распределении водорода по толщине. С этой целью проводился расчет диффузионных профилей в пленке после ее отжига в водородной плазме и после отжига в вакууме. При расчете диффузии водорода использовались экспериментальные данные о коэффициенте диффузии, полученные в [21], в которой приведе- |
ны данные по исследованию диффузии дейтерия в дегидрированных пленках a-Si:H. Схематическое изображение температурных зависимостей коэффициентов диффузии из плазмы и из твердого источника приведены на рис. 6.21, а [84]. Коэффициент диффузии подчиняется классическому активационному закону:
D = D>Qexp(-Ed / kT ).
Однако энергии активации коэффициента диффузии Ed для этих случаев сильно различаются. Авторы объясняют различия в диффузии из твердого и газофазного источников распределением по энергиям связей кремнийводород в матрице аморфного кремния. Схематическое представление плотности состояний водорода и пространственного распределения ловушек в аморфной матрице представлены на рис. 6.21, б. Авторы полагают, что при диффузии из плазмы транспорт водорода идет по мелким ловушкам, соответствующим малым энергиям связи (например, междоузельные состояния) с Ed~ 0,5 эВ. При диффузии из твердого источника транспорт водорода идет по глубоким ловушкам, соответствующим слабым Si-H-связям с Ed порядка 1,2…1,5 эВ и сильным Si-H-связям с энергией активации более 1,9 эВ [21].
А
v Плазма
 0,5 эВ
0,5 эВ
1,2.1,5 эВ
![]() > 1,9 эВ Твердый ‘источник
> 1,9 эВ Твердый ‘источник
————————————- >
1/T
а б
Рис. 6.21. Схематическое изображение температурной зависимости
коэффициента диффузии водорода в пленках a-Si:H (а)
и распределения плотности состояний (ПС) водорода по энергии связи (б)
Таким образом, коэффициенты диффузии для водорода, находящегося в сильных связях с кремнием будут меньше, чем для водорода, находящегося в слабых связях, и существенно меньше, чем коэффициент диффузии водорода из плазмы.
Исходя из полученных коэффициентов диффузии водорода из плазмы, был произведен расчет профиля распределения концентрации водорода в
пленках a-Si:H после ее отжига в водородной плазме в течение 30 с при 250 °С, что соответствует условиям циклического осаждения. Расчет сделан для диффузии из бесконечного источника:
![]() ґ v
ґ v
 Ch (x) = C s erfc
Ch (x) = C s erfc
где концентрация на поверхности C$ определялась по интегральной концентрации, которая приравнивалась к величине концентрации водорода, полученной по ИК-спектрам:
L Ch (x) dx = СИК.
0
 |
Из расчетного профиля распределения (рис. 6.22) видно, что за время отжига в плазме водород успевает продиффундировать на толщину порядка 3 нм, что намного меньше чем толщина слоя, осаждаемого за цикл [85]. Эти результаты хорошо согласуются с данными просвечивающей электронной микроскопии (см. рис. 6.8, а), на фотографиях которой можно выделить светлые участки размером ~ 2-3 нм, соответствующие областям, наиболее обогащенным водородом.
Поскольку за электрофизические свойства пленок a-Si:H, главным образом, отвечают сильные Si-H-связи, то наибольший интерес представляет оценка изменения распределения водорода, находящегося в сильных связях
с кремнием, в процессе осаждения и после отжига в вакууме. Предполагается, что в областях, подвергшихся обработке в водородной плазме, концентрация сильных Si-H-связей превосходит их концентрацию в объеме.
Для оценки изменения распределения водорода по толщине пленки в процессе ее роста и после отжига в вакууме был сделан расчет диффузии водорода из конечного твердого источника без учета эффузии. Для этого необходимо решить уравнение диффузии:
д2 N _ 1 N дх2 D dt ‘
 |
В качестве начального распределения водорода был взят простейший случай: 100 % от исходного содержания водорода на участке толщиной 2 нм с резкими краями (рис. 6.23).
 |
|||
Для граничных условий, полученных исходя из симметричности задачи:
решение выглядит следующим образом:
|
Г 2 |
||||
|
2к +1) х |
exp |
1 1 Ь of. |
42 (2k +1)2 4, |
|
х _0 |
|
N(х, t) _ X Ck cos к _1 |
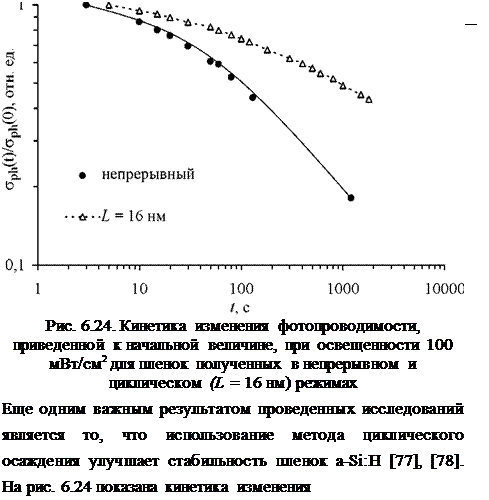 |
При расчете использовались следующие параметры для определения коэффициента диффузии: D0 = 10-4 см2-с-1 и Ed = 1,9 эВ, которые подтверждаются данными [133]. На рис. 6.23 представлены расчетные профили распределения водорода до отжига и после отжига в вакууме в течении пяти часов при 250 °С и в течении одного часа при 450 °С. Результаты расчета показали, что после отжига в течении пяти часов при 250 °С (т. е. в условиях осаждения) начальная неоднородность распределения водорода практически полностью сохраняется. После отжига в течении одного часа при 450 °С происходит частичное размытие концентрации водорода, однако неоднородность распределения водорода сохраняется. Таким образом, в исходном случае неоднородного распределения по толщине водорода, находящегося в сильной связи с кремнием, неоднородность распределения сохраняется даже после отжига при температуре 450 °С. Это можно объяснить сохранением пиков фотопроводимости после отжига пленок даже при 450 °С.
нормированной фотопроводимости при освещенности 100 мВт/см2 для пленок a-Si:H, полученных в непрерывном и циклическом режимах. Для пленок a-Si:H при циклическом осаждении с отжигом в водородной плазме эффект Стеблера-Вронского выражен значительно слабее. Подобный результат приводится в работе [86], авторы которой отмечают фактическое отсутствие эффекта Стеблера-Вронского в наностуктурированных пленках a-Si:H. Следует заметить, что с точки зрения временной стабильности оптимальными являются пленки a-Si:H, у которых толщина слоев, осаждаемых за один цикл, составляет 16 нм.
Повышение стабильности пленок, получаемых в циклическом режиме, обусловлено повышением качества слоев однородного аморфного гид — рогенизированного кремния, находящихся между областями, содержащими нанокристаллические включения. Они снимают механические напряжения в аморфной матрице, создавая возможность для роста менее напряженной сетки с меньшей концентрацией слабых связей, и, следовательно, менее подверженной деградации.