Как выбрать гостиницу для кошек
14 декабря, 2021
Несмотря на то, что до настоящего времени единой теории некристаллических материалов не существует, многие оптические и фотоэлектрические свойства могут быть объяснены исходя из представлений о зонном распределении энергетических состояний в аморфных полупроводниках [25]-[30], [33]. Однако отсутствие дальнего порядка приводит к существенному отличию структуры энергетических зон кристаллических и неупорядоченных полупроводников. В связи с этим перед рассмотрением собственно оптического поглощения в аморфных полупроводниках необходимо представить особенности структуры энергетических зон в неупорядоченных полупроводниках. В них отсутствует дальний порядок, поэтому основные положения зонной теории кристаллов в данном случае оказываются неприменимыми.
В начале 50-х годов А. Ф. Иоффе сформулировал эмпирическое правило, из которого следует, что за полупроводниковые свойства в материалах отвечает ближний порядок. Сохранение ближнего порядка в неупорядоченных полупроводниках объясняет зонный характер распределения в них энергетических состояний.
Аморфные материалы, так же как идеальные полупроводники, имеют делокализованные состояния, благодаря которым электроны и дырки могут свободно перемещаться. Однако отсутствие дальнего порядка приводит к тому, что для них длина свободного пробега значительно ниже, чем в кристаллическом материале. Когда эта зависящая от энергии длина свободного пробега становится сравнимой с межатомным расстоянием, носители заряда локализуются.
Исследования об электронной структуре аморфных полупроводников и предположение о наличии хвостов зон в некристаллических полупроводниках были представлены А. И. Губановым в 1963 г. [34].
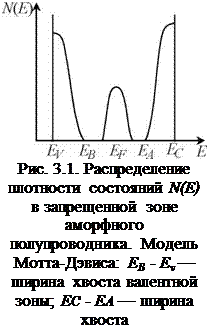 Конкретные расчеты и оценка реальных неупорядоченных систем были проведены в работах Мотта [26]-[28], [30], [35]. Согласно идеям Мотта в неупорядоченных полупроводниках должны существовать хвосты локализованных состояний на краях валентной зоны и зоны проводимости, а также граничные энергии, разделяющие локализованные состояния от распространенных [35]. На основе этих исследований было разработано несколько моделей структуры энергетических зон в неупорядоченных полупроводниках. Согласно Мотту и Дэвису (рис. 3.1) хвосты локализованных состояний довольно узкие и распространяются в запрещенную зону на несколько десятых долей электронвольта. Уровень Ферми закрепляется в узкой зоне компенси
Конкретные расчеты и оценка реальных неупорядоченных систем были проведены в работах Мотта [26]-[28], [30], [35]. Согласно идеям Мотта в неупорядоченных полупроводниках должны существовать хвосты локализованных состояний на краях валентной зоны и зоны проводимости, а также граничные энергии, разделяющие локализованные состояния от распространенных [35]. На основе этих исследований было разработано несколько моделей структуры энергетических зон в неупорядоченных полупроводниках. Согласно Мотту и Дэвису (рис. 3.1) хвосты локализованных состояний довольно узкие и распространяются в запрещенную зону на несколько десятых долей электронвольта. Уровень Ферми закрепляется в узкой зоне компенси
 зоны пповопимости
зоны пповопимости
разупорядочения аморфного полупроводника они увеличиваются и в модели Мотта-Дэвиса имеют экспоненциальное распределение. Пик глубоких состояний описывается гауссовым распределением.
В идеальном кристалле энергетические состояния не могут существовать внутри запрещенной зоны, а в аморфном полупроводнике имеется некоторое множество локализованных состояний. Носители могут перемещаться с локализованных состояний только в том случае, если они получат дополнительную, значительную энергию. В результате отношение подвижностей носителей заряда по делокализованным и локализованным состояниям превышает три порядка. Поэтому диапазон энергий от Ey до Ec называется в аморфных полупроводниках щелью подвижности. Именно этот аналог запрещенной зоны, энергетической щели в кристаллических полупроводниках и обеспечивает наличие полупроводниковых свойств у аморфных материалов. В кристалле оптическая и электронная энергетические щели равны.
В аморфном материале электронные свойства описываются щелью подвижности, а оптические свойства связаны с оптической щелью, которая обычно меньше щели подвижности приблизительно на 50-100 мэВ [35].
В неупорядоченных полупроводниках, в отличие от кристаллических, отсутствует дальний порядок [25]-[30]. Вместе с тем установлено, что в неупорядоченных полупроводниках существует ближний и средний порядок. Для полупроводниковых материалов с преобладанием ковалентного типа химических связей ближний порядок определяется взаимодействием ковалентно связанных атомов и распространяется на первую и частично вторую координационные сферы. Средний порядок определяется взаимодействиями электронов неподеленных пар, ван-дер-ваальсовым взаимодействием и формируется атомами, входящими частично во вторую координационную сферу и координационные сферы более высоких порядков.
Для аморфных полупроводников с тетраэдрической координацией их кристаллических аналогов первое координационное число остается близким к четырем (4 ± 0,1), радиус первой координационной сферы соответствует (с отклонениями, как правило, не более 0,06 А) межатомному расстоянию в кристалле. Это свидетельствует о сохранении тетраэдрической структуры материалов в твердом некристаллическом состоянии. Однако упаковка тетраэдров в аморфной и кристаллической фазах различна, что вызывает потерю дальнего порядка в аморфной фазе.
В настоящее время для описания атомной структуры неупорядоченных тетраэдрических полупроводников, как правило, используют модели непериодической непрерывной сетки с произвольным значением двугранного угла, определяющий угол скручивания двух соседних тетраэдров. Центрами этих тетраэдров являются соседние атомы, а скручивание происходит вокруг оси — линии вдоль связи, соединяющей эти атомы. Произвольные значения двугранных углов приводят к существованию наряду с шестичленными пяти- и семичленных колец, что сопровождается некоторым изменением длин и углов связей. В такой трехмерной сетке содержится значительное число структурных дефектов в виде оборванных связей.
Введение в аморфный кремний атомов водорода кардинально меняет свойства материала. С увеличением содержания водорода радиус первой координационной сферы остается неизменным, а первое координационное число и плотность материала уменьшаются. Уменьшение первого координационного числа связано с замещением части связей кремний-кремний (Si-Si) на связи Si-H и Si-H2. Однокоординированные атомы водорода насыщают химическую связь атома кремния.
В пленках a-Si:H в зависимости от условий получения содержатся два типа связей водорода [31], [32]: первый (обязательный) связан с наличием случайным образом распределенного моногидрида Si-H, второй — обусловлен присутствием полигидридов типа (Si-H)n, где n > 1, и кластериро — ванного Si-H. Полигидридные конфигурации обнаруживаются в пленках с выраженной микроструктурой и характерны для соединительной ткани между колоннами.
Благодаря периодической структуре кристаллического материала носители заряда могут иметь большую длину свободного пробега до взаимодействия с несовершенствами решетки, что определяет высокую подвижность электронов и дырок. Формирование неупорядоченной сетки атомов приводит к тому, что в a-Si:H подвижность носителей заряда значительно ниже, чем в кристаллическом кремнии. Подвижность электронов находится на уровне 10 см2/В-с и на два порядка выше подвижности дырок.
Положили начало широкому исследованию аморфных тетраэдрических полупроводников работы У Спира и П. Ле Комбера [23], [24]. В 1973 г. ученые обнаружили, что пленки аморфного кремния, получаемые путем разложения моносилана SiH4 в плазме тлеющего разряда, обладают необычно высокими электронными свойствами. В 1975 г. они отметили, что свойства пленок a-Si: H можно изменять в широких пределах путем контролируемого введения в газовую фазу небольших добавок диборана B2H или фосфина PH3. В 1976 г. Д. Карлсоном и К. Вронски были впервые созданы солнечные элементы на основе a-Si: H (КПД СЭ составлял 2,4 %), после чего началось активное развитие области применения аморфных полупроводников [25]-[30].
Впервые солнечный элемент на основе p-i-n-структуры был изготовлен в 1980 г. группой ученых Хамакава. В том же году фирма «Sanyo» впервые использовала СЭ на основе a-Si: H в коммерческих целях для питания ручных калькуляторов, началось массовое производство солнечных элементов на основе аморфного кремния.
К достоинствам a-Si: Н относятся:
• дешевизна устройств на его основе и их технологическая совместимость с устройствами на основе монокристаллического кремния c-Si;
• возможность получения тонких пленок практически на любых подложках — в отношении как материала, так и размеров;
• радиационная стойкость, обеспечивающая стабильную работу приборов в условиях воздействия жесткого ионизирующего излучения;
• более высокие по сравнению с монокристаллическим кремнием коэффициент поглощения и фоточувствительность, обусловленные разупоря — доченностью структуры a-Si: H и наличием в ней водорода.
При увеличении температуры диффузионные длины в Si и GaAs возрастают, поскольку коэффициент диффузии не изменяется либо увеличивается, а время жизни неосновных носителей возрастает при повышении
42
 |
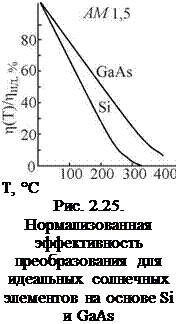 солнечных элементов на основе Si и GaAs » width=»178″ height=»324 «/> солнечных элементов на основе Si и GaAs » width=»178″ height=»324 «/> |
температуры. Увеличение диффузионной длины неосновных носителей приводит к росту 1к з. Однако этот эффект невелик и составляет порядка 0,07 %/К (рис. 2.24).
Рис. 2.24. ВАХ солнечного элемента
при различных температурах

Принимая во внимание, что 1ф >> I01, из уравнений (2.17) и (2.21) с учетом закона действующих масс для носителей заряда
фототок, а значит, и ток короткого замыкания 1к з прямо пропорционален
интенсивности излучения (рис. 2.26). В то же время в соответствии с выра-
43
жением (2.22) напряжение холостого хода Ux x имеет логарифмическую зависимость от интенсивности излучения.
В космических условиях выходная мощность солнечных элементов понижается в связи с тем, что облучение частицами высоких энергий на удаленных орбитах приводит к образованию дефектов в полупроводнике.
Из выражений (2.37) и (2.40) видно, что фототок снижается с уменьшением диффузионных длин Ln и Lp. Время жизни избыточных неосновных носителей при облучении полупроводника частицами высоких энергий меняется по закону
1 = — + КгФ, (2.46)
I IQ
где iq — исходное время жизни; К — постоянная; Ф — доза радиации.
Из выражения (2.46) следует, что скорость рекомбинации неосновных носителей пропорциональна исходной концентрации рекомбинационных центров и их концентрации, вводимой в полупроводник в процессе облучения и пропорциональной дозе попадающих на полупроводник частиц.
Поскольку диффузионная длина равна VDI, a D слабо зависит от облучения (или от уровня легирования), соотношение (2.46) можно записать в виде
![]() ■Хт + КФ,
■Хт + КФ,
LQ
 исходная диффузионная длина; К = K/D.
исходная диффузионная длина; К = K/D.
Для повышения радиационной стойкости в солнечные элементы вводится литий, который легко диффундирует и образует комплексы с радиационными точечными дефектами. Очевидно, Li нейтрализует дефекты и препятствует деградации времени жизни. Для снижения числа частиц высоких энергий, достигающих элемента в космическом пространстве, перед лицевой поверхностью элемента должно помещаться защитное покрытие (например, содержащая церий тончайшая бумага).
2.5.2. Соединение отдельных солнечных элементов
Отдельные солнечные элементы на практике не используются. Отдельный солнечный элемент имеет низкие значения /к з и их х, в частности, кремниевый СЭ площадью 2 см2 — напряжение холостого хода 0,50,6 В и ток короткого замыкания от 30 до 60 мА.
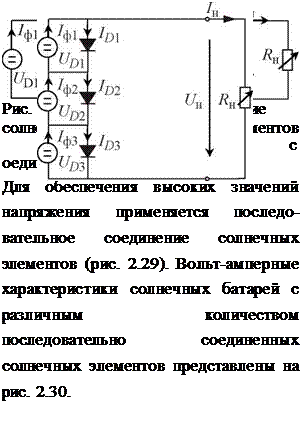 |
 |
Если необходимо обеспечить высокие значения тока, используется параллельное соединение солнечных элементов (рис. 2.27). Вольт-амперные характеристики солнечных батарей с различным количеством параллельно соединенных солнечных элементов представлены на рис. 2.28.
Рис. 2.29. Последовательное Рис. 2.30. ВАХ СЭ, соединенных
соединение солнечных элементов последовательно
Последовательно-параллельное соединение элементов в большую батарею позволяет подводить к нагрузке одновременно большие напряжения и токи.
2.5.1. Эквивалентная схема и вольт-амперная характеристика реального солнечного элемента
В любом солнечном элементе существуют потери мощности, обусловленные паразитными сопротивлениями. Во многих случаях достаточно ввести сосредоточенные последовательное Rn и шунтирующее Rm сопротивления в эквивалентную схему (рис. 2.20). Шунтирующие источник тока диод и Rm, а также включенное последовательно с ними сопротивление Rn должны обеспечивать на выходе напряжение U и ток I [21].
Последовательное сопротивление обусловлено объемным сопротивлением подложки, сопротивлением контактов на лицевой и обратной сторонах подложки. Шунтирующее сопротивление вызвано главным образом токами утечки через ^-«-переход. Каналы объемных утечек создаются инородными микро — и макровключениями в материале ^-«-перехода. Каналы поверхностных утечек образуются при интенсивной рекомбинации электронно-дырочных пар через непрерывный ряд энергетических состояний на поверхности полупроводника, возникающих из-за нарушения валентных связей, а также при прохождении тока по загрязнениям в местах выхода ^-«-перехода на поверхность [17].
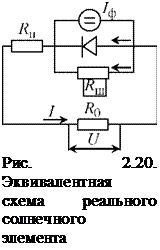 Для получения более точной картины, особенно в случае применения в приборах тонких пленок, оказывающих сопротивление протеканию тока, следует использовать различные модели распределенного сопротивления, рассчитываемые численными и аналитическими методами.
Для получения более точной картины, особенно в случае применения в приборах тонких пленок, оказывающих сопротивление протеканию тока, следует использовать различные модели распределенного сопротивления, рассчитываемые численными и аналитическими методами.
Суммируя токи, протекающие в ветвях эквивалентной схемы, получаем уравнение вольт-амперной характеристики реального фотоэлемента
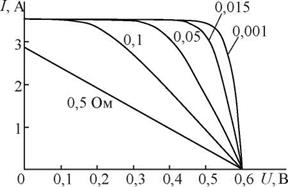 |
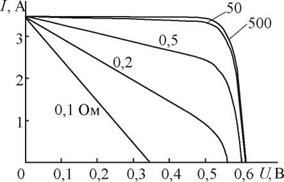 |
Последовательное и шунтирующее сопротивления обусловливают потери в СЭ, которые приводят к уменьшению коэффициента формы и напряжения холостого хода. Поэтому знание этих параметров очень важно для совершенствования технологии изготовления солнечных элементов.
Рис. 2.21. ВАХ солнечного элемента Рис. 2.22. ВАХ солнечного элемента
с различным значением сопротивления Rп с различным значением сопротивления Rш
Как правило, Rш велико, поэтому вторым слагаемым в уравнении (2.45) можно пренебречь.
Падение напряжения на последовательном сопротивлении оказывает значительно более существенное влияние на вольт-амперную характеристику, чем
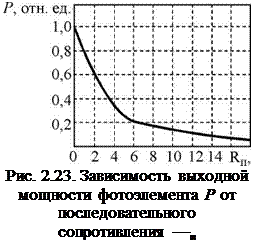 падение напряжения на шунтирующем сопротивлении (рис. 2.21 и 2.22).
падение напряжения на шунтирующем сопротивлении (рис. 2.21 и 2.22).
Как видно из рис. 2.23, при увеличении последовательного сопротивления от 0 до 5 Ом мощность уменьшается более чем на 70 %.
Допустимое значение R№ обеспечивающее малые потери мощности, приближенно может быть найдено, предполагая, что рабочая точка характеристики элемента отвечает режиму максимальной мощности, когда полные потери можно представить в виде Jm2Ru [21]. Тогда доля потерь мощности ZH определяется как
ZH ‘^т^п/(‘^т^т) JmRn/Vm ~ Jx. з-^^х. х.
При условиях JR з = 40 мА/см2 и ¥х х = 0,6 В, чтобы доля потерь была
меньше 3 %, последовательное сопротивление квадратного сантиметра площади элемента не должно превышать 0,5 Ом.
Аналогично доля потерь мощности на шунтирующем сопротивлении записывается в виде
 Zш Vm^Rm/(Jm Vm) Vm/JmRm
Zш Vm^Rm/(Jm Vm) Vm/JmRm
Для того чтобы потери, обусловленные Rm, не превышали 3 %, —ш каждого квадратного сантиметра площади солнечного элемента должно быть больше 500 Ом. Этот приближенный анализ обеспечивает достаточно точные результаты при ZH и Zm, не превышающих 5 %. При небольших потерях мощности ¥х х и ток 1к з почти не изменяется, а наиболее существенная причина этих потерь — относительное уменьшение коэффициента формы.
Предельный термодинамический КПД идеального преобразователя солнечной энергии определяется как

![]() Лпред ~
Лпред ~
V " " с J
где Т — температура приемника; Тс — температура источника.
Спектр излучения Солнца может быть аппроксимирован спектром излучения абсолютно черного тела, нагретого Тс = 5800 К. Тогда для температуры приемника Т ~ 300 К можно получить Рпред — 93 ^% [17].
Определение предельного теоретического КПД, исходя из наиболее общих принципов, представлено в работе [19]. Расчеты сделаны на основе принципа детального равновесия при рассмотрении потоков излучения в системе, состоящей из Солнца, которое считается абсолютно черным телом, и солнечного элемента. Для условия отсутствия концентрирования сол
нечного света авторы определили предельный теоретический КПД = 30 % при оптимальной ширине запрещенной зоны полупроводника 1,1 эВ, что близко к ширине запрещенной зоны Si.
В работе [20] для единичного солнечного элемента и теоретически максимального коэффициента концентрации солнечного излучения С = 46 200 (определяется как отношение излучаемой с единицы поверхности Солнца мощности к плотности мощности солнечного излучения в окрестностях Земли [17]) был получен предельный КПД = 40 %. Для неограниченного количества элементов в каскадной структуре предельный КПД = 68 % при С = 1 и КПД = 87 % при С = 4,6-104 [21].
 |
Однако солнечный фотоэлемент преобразует только часть падающей
![]() Электрическая энергия
Электрическая энергия
Рис. 2.9. Потери энергии в солнечном элементе: Rш — шунтирующее
сопротивление; Rп — последовательное сопротивление
Анализ распределения потерь энергии падающего излучения в кремниевом солнечном элементе (КПД = 16,6 %, ff = 0,78) при работе в условиях AM 1,5 проведен в работе [21]:
• термализация (передача энергии решетке) горячих носителей заряда, возникающих при поглощении фотонов с энергией hv > Eg — 29,2 %;
• прохождение через элемент фотонов низких энергий hv < Eg, не сопровождающееся генерацией электронно-дырочных пар — 18,8 %;
• неполное собирание фотогенерированных носителей заряда — 4,5 %;
• рекомбинационные потери носителей заряда в переходе, определяемые диодными параметрами — 19,2 %;
• потери мощности в диоде при прямом напряжении смещения, равном Vm, омические потери мощности I2R на последовательном и шунтирующем сопротивлениях — 4,7 %;
• потери на отражение (отражение света от фотоприемных поверхностей) — 2,0 %;
• потери на затенение поверхности контактной сеткой — 4,0 %;
• нефотоактивное поглощение (поглощение света просветляющим покрытием, дефектами и т. д.) — 1,0 %.
Из перечисленного видно, что наибольшими в СЭ являются потери на термализацию горячих носителей заряда.
Проникновение излучения через поверхность фотоэлемента. Первым явлением, вызывающим потерю падающей энергии, является отражение излучения от поверхности полупроводника. Отражение в значительной мере определяется состоянием поверхности, а также зависит от физических параметров полупроводника. В соответствии с расчетами для материалов со структурой алмаза и шириной запрещенной зоны 1,0—1,5 эВ следует ожидать отражения около 30 %. Для кремния отражение в видимой области спектра составляет около 40 %. Чтобы уменьшить потери, вызванные отражением, на поверхности кремния создается просветляющий слой, например из SiO2.
КПД проникновения, показывающий, какая часть падающей энергии проникает через поверхность полупроводника в глубь пластинки, определяется из выражения
! Ex(1 — Rx)dX
^пр = ^——————- , (2.24)
! Exd x
0
где Rx — отражение; Ex d X — часть энергии падающего излучения в промежутке длин волн от X до X + dX.
Поглощение излучения. Часть излучения, проникающего в глубь полупроводника, поглощается в нем. Остальная часть излучения проходит через
всю толщину пластины и бесполезно поглощается задним металлическим электродом. КПД поглощения излучения в полупроводнике находится из выражения
![]()
![]() I ek(1 — R0P-exp(-a®)] dк 0________
I ek(1 — R0P-exp(-a®)] dк 0________
да
I Ek(1 — Rk) dk
0
где a — коэффициент поглощения; ® — толщина пластины.
Количество энергии, теряемой в результате поглощения задним электродом, определяется коэффициентом поглощения излучения и толщиной полупроводниковой пластинки, в которой выполнен ^-«-переход. Обычно до заднего электрода доходит очень малая часть излучения в длинноволновой части спектра.
Генерация носителей заряда. Не вся поглощенная в объеме полупроводника энергия идет на генерацию пар электрон-дырка. Часть ее тратится на образование экситонов и возбуждение колебаний кристаллической решетки, что приводит к повышению температуры полупроводника. Поглощение, связанное с генерацией пар электрон-дырка, определяется квантовым выходом внутреннего фотоэффекта Цк.
КПД генерации, определяющий ту часть поглощенной полупроводником энергии, которая вызывает образование пар электрон-дырка, находится по формуле
ко S
I ЦкEk(1 — Rk)[1 — exP(-a®)] dк Цг = -°5—— . (2.26)
I Ek(1 — Rk)[1 — ЄХР (-a®)] dк о
Край собственного поглощения определяет длинноволновую границу ко5 спектральной характеристики прибора. Так как для к > ко5 имеем Цк = 0, то верхний предел интегрирования в числителе ограничивается ко5. Это свидетельствует о том, что для данного спектра излучения КПД генерации цг является функцией ширины запрещенной зоны Eg.
На рис. 2.1о представлен спектр солнечного излучения и кривые, определяющие максимальную величину энергии с данной длиной волны, которая может идти на генерацию пар электрон-дырка в полупроводниках с
 |
разной шириной запрещенной зоны. Приведенные кривые рассчитаны для случая, не учитывающего отражение от поверхности и проникновение излучения до заднего электрода, т. е. R ^ = 0 и ю = да.
Рис. 2.10. Спектр солнечного излучения и кривые,
определяющие величину энергии излучения с длиной волны,
используемой для генерации пар электрон-дырка в различных
полупроводниках: 1 — Eg = 2,5 эВ [GaP], 5,8-1016 пар/с;
2 — энергия для генерации пар электрон-дырка в полупроводнике
с шириной запрещенной зоны Eg; 3 — Eg = 1,1 эВ [Si], 2,8-1017 пар/с;
4 — спектр солнечного излучения; 5 — Eg = 0,68 эВ [Ge], 4,2-1017 пар/с
Как видим, энергия длинноволновой части спектра, соответствующая энергии квантов, меньшей чем Eg полупроводника, полностью теряется. В связи с этим количество полезно поглощенных фотонов уменьшается при увеличении Eg полупроводника. Однако с увеличением ширины запрещенной зоны относительно возрастает поглощение в области максимума солнечного спектра, где фотоны имеют более высокую энергию. Поэтому существует оптимальная ширина запрещенной зоны, при которой часть энергии спектра, идущая на генерацию пар электрон-дырка, наибольшая (рис. 2.11).
Рекомбинация и ток. В прохождении электрического тока во внешней цепи принимают участие те пары электрон-дырка из общего количества образованных в объеме полупроводника, которые генерируются на расстоянии от перехода, не большем диффузионной длины. Остальные пары, которые рекомбинируют перед их разделением потенциальным барьером, определяют токовые потери. КПД фотоэлемента по току вычисляется по формуле
^0 s
J £>хЛхEx(1 — Rx)^ — exP(-аю)] dX Лі = -^ , (2.27)
J ЛхEx(1 — Rx)[1 — exP(-аю)] dx 0
где Qx — коэффициент разделения носителей.
 Рекомбинация и напряжение. Как уже отмечалось, фотоны с энергией, значительно превышающей ширину запрещенной зоны полупроводника, образуют пары электрон-дырка, энергия которых в момент образования намного больше средней энергии равновесных носителей заряда. Однако избыток энергии быстро теряется в результате соударения с атомами решетки, поэтому энергия образованных носителей почти сразу приближается к средней энергии равновесных носителей в зонах (процесс термализации горячих носителей). Потеря энергии носителей при переходах внутри зоны вызывает потерю напряжения в солнечном фотоэлементе.
Рекомбинация и напряжение. Как уже отмечалось, фотоны с энергией, значительно превышающей ширину запрещенной зоны полупроводника, образуют пары электрон-дырка, энергия которых в момент образования намного больше средней энергии равновесных носителей заряда. Однако избыток энергии быстро теряется в результате соударения с атомами решетки, поэтому энергия образованных носителей почти сразу приближается к средней энергии равновесных носителей в зонах (процесс термализации горячих носителей). Потеря энергии носителей при переходах внутри зоны вызывает потерю напряжения в солнечном фотоэлементе.
Потеря напряжения, обусловленная переходом одного электрона, определяется отношением
еЕф = еЕфХ hv hc
где Eф — фотоЭДС, вырабатываемая электроном на контактах элемента,
hv — поглощенная электроном энергия в момент генерации в зоне.
 |
||
КПД по напряжению для всех действующих фотонов определяется по формуле
В выражении (2.28) не учитываются потери напряжения, обусловленные его падением на последовательном сопротивлении ^-«-перехода.
Умножая значение КПД отдельных процессов, определяемых в выражениях (2.24)-(2.28), находим результирующую эффективность
ЄЕф I hQX^XEx(1 — Rx)[1 — exP(-а®)] dE
 nc 0_________________________________________
nc 0_________________________________________
IE, d E 0
Выбор оптимального полупроводника. На рис. 2.12 приведена зависимость идеальной эффективности солнечного элемента при 300 К от ширины запрещенной зоны. Одна кривая соответствует обычному излучению (C = 1), а другая — х1000 концентрированного солнечного излучения (C = 1000). Небольшие осцилляции на ней связаны с характером поглощения излучения в атмосфере. Видно, что кривая эффективности имеет широкий максимум, в пределах которого КПД слабо зависит от Eg. Поэтому все полупроводники, которые имеют ширину запрещенной зоны от 1 до 2 эВ, относятся к материалам, пригодным для создания солнечных элементов. Существует ряд факторов, снижающих идеальную эффективность, вследствие чего реальные значения эффективности преобразования ниже идеальных.

![]()
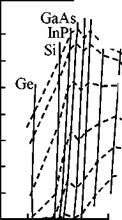 % %
% %
 28
28
24
20
16
12
8
4
0
0,2 0,6 1,0 1,4 1,8 2,2 2,4 2,6 2,8 3,0
Eg, эВ
Рис. 2.13. Зависимости теоретического КПД
идеального солнечного элемента
с гомопереходом от ширины запрещенной
зоны полупроводника
Соотношение между теоретическим КПД солнечных элементов с гомопереходом и шириной запрещенной зоны полупроводника в условиях АМ 0 при различных температурах представлено на рис. 2.13 в отсутствии рекомбинационных потерь носителей заряда на поверхности. Максимум
кривых расположен вблизи энергий 1,4—1,5 эВ. При повышенных температурах максимумы смещаются в область больших значений ширины запрещенной зоны [21].
На рис. 2.14 представлена зависимость максимального КПД солнечного фотоэлемента от ширины запрещенной зоны полупроводника для трех значений концентраций доноров и акцепторов. Кривые получены в результате расчетов, выполненных для германия Eg = 0,7 эВ, кремния Eg = 1,1 эВ, ан — тимонида индия Eg = 1,6 эВ и гипотетического полупроводника Eg = 2,0 эВ аппроксимацией спектра солнечного излучения спектром излучения абсолютно черного тела с температурой T = 5760 К и интегральной излучательной способностью 0,1 Вт/см2. Потери на отражение и во внутренних сопротивлениях фотоэлемента не учтены.
|
|
Eg, эВ
Рис. 2.14. Зависимость максимального КПД солнечного элемента от ширины запрещенной зоны полупроводника
КПД фотоэлемента увеличивается по мере повышения концентрации примесей. Это связано с тем, что при увеличении концентрации примесей уровень Ферми в обеих областях p-n-перехода перемещается в направлении границ запрещенной зоны, благодаря чему увеличивается высота потенциального барьера в переходе. Оптимальный полупроводник для преобразования солнечной энергии должен иметь ширину запрещенной зоны около 1,6 эВ (см. рис. 2.14).
В действительности распределение солнечной энергии на Земле далеко от идеального и связано с тремя основными источниками атмосферного поглощения, а именно: газами (O2, N2 и др.), водяным паром и пылью. В результате атмосферного поглощения ослабляется ультрафиолетовая часть солнечного
спектра. Влияние названных источников поглощения можно описать, если ввести длину оптического пути (воздушная масса AM) и количество водяного пара в атмосфере w. Поглощение будет тем больше, чем больше AM и w.
С учетом изменения солнечного спектра под влиянием географических и атмосферных условий поток фотонов Q(Eg), способных генерировать пары электрон-дырка в полупроводнике с шириной запрещенной зоны Eg, определяется как
![]() Q (Eg )= s Q M >
Q (Eg )= s Q M >
Eg h
![]() где Q(v) — поток фотонов с энергией hv на отрезке А — = 10 5 •см_1;
где Q(v) — поток фотонов с энергией hv на отрезке А — = 10 5 •см_1;
vmax — максимальная частота в спектре солнечного излучения.
Зависимость потока фотонов Q(Eg) и плотности тока, которые образовали бы генерированные этими фотонами пары при их полном разделении, представлена на рис. 2.15. Поглощение в атмосфере приводит к уменьшению плотности тока и количества фотонов в полупроводнике. Соответствующие изменения наблюдаются в зависимости от максимальной теорети-
 |
ческой величины КПД солнечного элемента и от ширины запрещенной зоны полупроводника (рис. 2.16).
Чем сильнее поглощается излучение атмосферой, тем при более низком значении Eg достигается оптимальная величина Лтах(см. рис. 2.16). С другой стороны, для полупроводников с меньшим значением Eg влияние
атмосферы проявляется слабее, а характеристики солнечных элементов на их основе становятся сопоставимыми с характеристиками солнечных элементов на основе более широкозонных материалов.
ФотоЭДС солнечного элемента при комнатной температуре определяется как
Для достаточно больших интенсивностей излучения, при которых
1ф >> Is, единица в формуле (2.29) может быть опущена.
Если рассматривать ^-«-переход, в котором концентрация примесей в диффузионном слое p-типа значительно больше, чем в исходной пластине «-типа, (что имеет место в солнечных элементах), то плотность тока насыщения определяется уравнением
1
![]()
![]() 2
2
Lh 1h
где p« — равновесная концентрация дырок в «-области; Dh, Lh, ih — соответственно коэффициент диффузии, диффузионная длина и время жизни дырок. Подставляя известные выражения
1
![]() «n =——— ,
«n =——— ,
е^ер« где ре, р« — подвижность электронов и удельное сопротивление материа
 |
ла, для фотоЭДС солнечного элемента из кремния с базой перехода «-типа при температуре 300 К находим
Если на лицевую поверхность солнечного элемента (см. рис. 2.2) падает монохроматический свет с длиной волны X и энергией фотонов hv > Eg, зависимость скорости генерации электронно-дырочных пар от расстояния х от поверхности полупроводника определяется выражением [12]
G(X, x) = a(X)F(X)[1 — R(X)]exp[- a(X)x], (2.31)
где a(X) — коэффициент поглощения; F(X) — плотность потока падающих фотонов в единичном спектральном интервале; R (X) — доля фотонов, отражающихся от поверхности.
Генерируемый светом в солнечной батарее фототок может быть найден из уравнения непрерывности для избыточных носителей. При низком уровне инжекции одномерное стационарное уравнение непрерывности для дырок в полупроводнике и-типа имеет вид
Gp _ Рп _ Рп° _ IJ = 0. (2.32)
F Xp e dx
Уравнение непрерывности для электронов в полупроводнике p-типа
п p — п Р0 1 dJ
Gn —p—— Р0 —1 dJn = 0. (2.33)
хп e dx
Отсюда плотность тока дырок и электронов определяется выражениями
|
Jp ePppnE eDp dx, |
(2.34) |
|
dnp |
|
|
Jn = ePnnpE ^ eDn d ‘ (AJv |
(2.35) |
В этих выражениях Jp и Jn — плотность дырочного и электронного токов. В солнечном элементе с резким p-n-переходом и постоянными уровнями легирования по обеим сторонам перехода (рис. 2.17) электрическое поле вне обедненной области отсутствует. Из выражений (2.31), (2.32), (2.34) можно получить уравнение, описывающее распределение неосновных носителей дырок в и-области
Dp—pn _ pn—pn0 + aF (1 — R)exp(-ax) = 0. (2.36)
dx X p
Общее решение этого уравнения имеет вид
pn — pn0 = Ach(x/Lp) + Bsh(x/Lp) — Cexp(- ax) , где Lp = (DpXp)1/2 — диффузионная длина; A, B, C — константы.
34
Использование в уравнении (2.36) частного решения pn — pno = C exp(- ax) позволяет определить C:
 C = aF(1 — R)tp / (a2Lp -1).
C = aF(1 — R)tp / (a2Lp -1).
Константы A и B определяются в реРис. 2.17. Размеры солнечного
зультате использования граничных условий элемента и характерные длины на фронтальной поверхности (при x = 0), даффузии не°сн°вных шоттелет где происходит рекомбинация, и на границе обедненной области. Первое условие может быть получено, если учесть, что при x = 0 плотность диффузионного тока равна плотности поверхностного рекомбинационного тока
DP d(Vn0) = SP(Pn — Pn0),
где Sp — скорость поверхностной рекомбинации.
Второе граничное условие справедливо для границы области пространственного заряда, где избыточная концентрация неосновных носителей мала, что связано с их удалением полем из области обеднения. Таким образом,
Pn — Pn0 = 0 при x = Xj.
Подстановка этих граничных условий в уравнение (2.36) позволяет получить выражение для избыточной концентрации дырок:
Pn — Pn0 = [aF(1 — R)V(a2LP2 — 1)] (SpLp / Dp +aLP ) х
—ax ■
sh[(xj — x) / Lp ] + e j [(SpLp / Dp)sh(x / Lp) + ch(x / Lp)] — ax
(SpLp / Dp)sh(xj / Lp) + ch(xj / Lp)
Тогда плотность дырочного фототока, генерируемая фотонами с длиной волны X, на краю обедненной области равна
элемента с р-базой при заданной длине волны падающего излучения и предполагая, что время жизни носителей, их подвижность и уровень легирования в этой области постоянны.
Чтобы найти электронный фототок, собираемый из подложки, необходимо использовать уравнения (2.31), (2.33) и (2.35) при следующих граничных условиях:
np — Про = 0 при x = Xj + W, (2.39)
где H — полная толщина солнечного элемента; W — ширина обедненной области.
Условие в выражении (2.39) означает, что избыточная концентрация неосновных носителей вблизи края обедненного слоя равна нулю, а в (2.38) — определяет скорость поверхностной рекомбинации вблизи омического контакта на тыловой поверхности.
Использование этих граничных условий позволяет определить плотность электронного фототока, генерируемого фотонами с длиной волны X, на краю обедненной области р-базы (x = Xj + W):
где Hi — толщина квазинейтральной области р-базы.
В дополнение к диффузионным составляющим фототока, собираемым в квазинейтральных n — и p-областях (уравнения (2.37) и (2.40) соответственно), необходимо учесть дрейфовую компоненту, возникающую в области обеднения. Электронно-дырочные пары, генерируемые светом в области обеднения, выносятся из этой области электрическим полем еще до того, как успевают рекомбинировать между собой. Поэтому фототок обедненного слоя в единичном спектральном интервале равен числу фотонов, поглощаемых в этом слое в единицу времени:
Jdr = eF(1 — R)exp(- axj)[1 — exp(- aW)]. (2.41)
Таким образом, фототок, генерируемый в солнечном элементе светом с длиной волны X, определяется суммой выражений (2.37), (2.40) и (2.41)
Jl(X) = Jp(X) + Jn(X) + Jdr(X). (2.42)
Полная плотность фототока, протекающего при освещении элемента на основе p-n-перехода солнечным светом со спектральным распределением F(X), можно получить интегрируя выражение (2.42):
X2
Jф = I [Jp (X) +Jn (X) + Jdr (X)]dX,
X1
где X1 и X2 — коротковолновая и длинноволновая границы поглощения.
Для типичного солнечного элемента на основе p-n-перехода X1 = 0,3 мкм. Красная граница поглощения определяется шириной запрещенной зоны полупроводника. Связь между длиной волны красной границы поглощения Xqs, мк, и шириной запрещенной зоны полупроводника Eg, эВ, описывается
 |
уравнением
Для кремния (Eg = 1,12 эВ при T = 300 К) красная граница поглощения находится вблизи 1,1 мкм.
Выражение (2.42) позволяет рассчитать спектральный отклик солнечного фотоэлемента. Спектральным откликом называется число собираемых электронов, приходящихся на один падающий фотон при данной длине волны.
Спектральный отклик SP равен фототоку Jl(X) (выражение (2.42)), деленному на величину eF, при наблюдаемом (внешнем) отклике, либо деленному на величину eF (1 — R), при внутреннем спектральном отклике
J p (X) + Jn (X) + Jdr (X)
SR = -^———- ^——— d^-L. (2.43)
eF (X)[1 — R(X)]
Если спектральный отклик известен, полная плотность фототока, протекающего при облучении элемента солнечным светом со спектральным распределением F(X), равна
X 2
JL = e j F(X)[1 — R(X)]SR(X)dX.
XI
Коротковолновый край спектральной зависимости Q(X) определяется в основном сбором носителей из фронтального слоя, а длинноволновый край — из базовой области.
В СЭ на основе непрямозонных полупроводников значительная часть излучения с hv > Eg генерирует электронно-дырочные пары глубоко в базовой области, что обусловливает пологую спектральную зависимость Q в длинноволновом участке спектра фотоответа вследствие рекомбинации части генерированных носителей в объеме базы и на тыльной поверхности.
В СЭ на основе прямозонных полупроводников благодаря более резкому краю поглощения значения Q имеют более резкий подъем в длинноволновой части спектра. Однако «поверхностное» поглощение в этом случае начинается при больших значениях X, что приводит к более быстрому спаду значений Q при уменьшении X, из-за рекомбинации фотогенериро — ванных носителей на фронтальной поверхности [17].
Реальный внутренний спектральный отклик для кремниевого солнечного элемента с p-базой существенно отличается от идеальной ступеньки (рис. 2.18 [12]). При расчетах использовались следующие параметры прибора: Nd = 5-1019 см-3, Na = 1,5-1016 см-3, ip = 0,4 мкс, in = 10 мкс, Xj = 0,5 мкм, H = 450 мкм, Sp (лицевая поверхность) = 104 см/с, Sn (тыльная поверхность) = да. На рис. 2.18 приведены также спектральные зависимости вклада каждой из трех компонент тока. При поглощении фотонов с низкими энергиями основная доля носителей генерируется в базовой области, поскольку коэффициент поглощения в Si при этом мал. Если же энергия фотонов превышает 2,5 эВ, основной вклад в фототок вносит лицевой слой. При энергиях фотонов выше 3,5 эВ а превышает 106 см-1 и спектральный отклик полностью определяется лицевым слоем. Поскольку величина Sp предполагается достаточно большой, поверхностная рекомбинация на лицевой поверхности элемента приводит к значительному уменьшению спектрального отклика по сравнению с идеальным значением. При aLp >> 1 и axj >> 1 спектральный отклик приближается асимптотически к величине, которая определяется фототоком лицевой стороны перехода, равной
![]() 1 + S p/aDp
1 + S p/aDp
SR =———————- p——- p—————-
(SpLp / Dp)sh(Xj / Lp) + ch(Xj / Lp)
Скорость поверхностной рекомбинации Sp сильно влияет на спектральный отклик, особенно при высоких энергиях фотонов. На рис. 2.19 приведены кривые спектрального отклика, рассчитанные для прибора с теми же параметрами (см. рис. 2.18). При этом скорость Sp изменялась в диапазоне
102…106 см/с. Наблюдается сильное уменьшение спектрального отклика при увеличении Sp. Из выражения (2.44) следует, что при заданной величине Sp спектральный отклик улучшается при увеличении диффузионной длины Lp. В общем случае для роста спектрального отклика в диапазоне используемых длин волн следует уменьшать Sn и Sp и увеличивать Ln и Lp.
|
1,0 |
1 |
Полный |
|
и 0,8 |
. 1 Идеаль ный | "отклик |
^■»■»отклик |
|
0,6 |
Базо- Лицевой |
|
|
А 0,4 сЗ Он |
: |
вая об — слой |
|
1 II |
ласть Обедненный |
|
|
Спект о КЗ |
||
|
слой |
|
0 1 2 3 4 5 |
|
hv, эВ |
 Рис.2.18. Рассчитанный внутренний
Рис.2.18. Рассчитанный внутренний
спектральный отклик кремниевого
элемента с р-базой
Итак, наблюдается резкое падение коэффициента собирания в коротковолновой области, вызванное плохими диффузионными и рекомбинационными параметрами легированного слоя, определяется неполным собиранием носителей из базы [18].
Увеличить Q можно за счет уменьшения поверхностной рекомбинации. Это достигается тщательной обработкой поверхности полупроводника с целью устранения рекомбинационных центров. Кроме того, эффективная скорость поверхностной рекомбинации зависит от наличия потенциального барьера, что также дает принципиальную возможность снижения рекомбинации.
В арсениде галлия скорость поверхностной рекомбинации значительно выше, чем в кремнии. Выращивание на поверхности GaAs тонкого широкозонного слоя из твердого раствора AlxGa1-xAs (x = 0,75-0,9) позволяет существенно снизить скорость поверхностной рекомбинации на гетерогранице благодаря близости периодов решеток GaAs и AlAs и меньшему числу оборванных валентных связей на гетерогранице, чем на свободной поверхности GaAs [22]. Потенциальный барьер на гетерогранице препятствует попаданию носителей тока, генерированных в узкозонном материале, на поверхность широкозонного слоя. В этом случае величина коэффициента
собирания в коротковолновой области определяется спектральной зависимостью показателя поглощения широкозонного слоя твердого раствора. При малых толщинах этого слоя (< 0,1 мкм) возможно сохранение высокой фоточувствительности и для самого коротковолнового участка солнечного спектра (при X < 0,4 мкм).
Второй путь повышения Q связан с уменьшением толщины лицевого легированного слоя для того, чтобы сделать неэффективный легированный слой более прозрачным для фотонов солнечного спектра [18]. Однако создание мелких переходов ограничивается возрастанием сопротивления растекания токов. Кроме того, в тонких легированных слоях резко возрастает влияние рекомбинации на внешней поверхности. Для мелких переходов существует проблема создания металлических контактов, обусловленная возникновением объемных шунтов, которая также ограничивает уменьшение толщины слоя. Все это создает некоторую оптимальную толщину поверхностного легированного слоя.
Третий путь направлен на повышение чистоты полупроводникового слоя, что резко уменьшит объемную безызлучательную рекомбинацию. Потребуются необходимые разработки технологии получения высококачественных исходных материалов и приборов, которые не ухудшали бы исходные параметры. В настоящее время значительное ухудшение параметров базы возникает в результате термообработки элементов. Кроме того, большое количество рекомбинационных дефектов возникает при создании ^-и-перехода за счет введения посторонних примесей.
Наконец, четвертый путь повышения эффективности собирания носителей связан с созданием в слоях фотопреобразователя встроенных электрических полей, способствующих дрейфу неосновных носителей к р-п-переходу.
Спектральная чувствительность солнечного элемента определяет диапазон значений длин волн оптического излучения, в котором практически возможно использовать данный фотоэлемент.
Ток короткого замыкания 1к з (см. рис. 2.8) соответствует максимальному току, который может протекать через фотоэлемент под освещением, когда он замкнут сам на себя (R = 0). Если принять U = 0, то из выражения (2.18) определяем величину тока короткого замыкания
Ік. з = — 1ф. (2.20)
Таким образом, ток короткого замыкания равен фотогенерируемому солнечным элементом току.
Напряжение холостого хода солнечного элемента Ux. х (см. рис. 2.8) соответствует напряжению на разомкнутых клеммах фотоэлемента (R = да). Оно может быть получено, если принять в уравнении (2.18) I = 0
![]()
![]()
![]() ТТ kT.
ТТ kT.
Uх. х = ln
e
Из выражения (2.21) следует, что их х может быть повышено за счет увеличения отношения Іф/І5 Этого можно добиться, снижая темновой ток либо в результате увеличения уровня легирования подложки (см. уравнение (2.17)), либо увеличения времени жизни неосновных носителей. Увеличение тока короткого замыкания (см. уравнение (2.20)) также может привести к повышению напряжения холостого хода, однако эффект не так заметен, как в случае уменьшения темнового тока. На практике увеличения их. х добиваются за счет создания поля на обратной стороне пластины в результате введения р+-слоя и формирования структуры p-p+. Подобная структура не только обеспечивает отражение неосновных носителей назад в область p-n-перехода, но также уменьшает контактное сопротивление тыльного электрода. В результате все основные параметры солнечного
элемента — 1к. з, Ux. х, фактор формы, КПД улучшаются. Напряжение холостого хода для кремниевых солнечных батарей с ^-«-переходом находится в диапазоне от 0,5 до 0,7 В в зависимости от конструкции солнечного элемента, уровня легирования и т. д.
С учетом выражения (2.19) получаем
 |
|
При большом уровне освещения, когда 1ф/^ >> 1, имеем
При малом уровне освещения, когда Іф/Is << 1, используем разложение в ряд Тейлора
![]() Pysi и
Pysi и
hvL
Таким образом, при малом уровне возбуждения напряжение холостого хода пропорционально интенсивности света.
Максимальная вырабатываемая солнечным элементом выходная мощность обозначена на рис. 2.8 точкой Pm (Pm = ImUm, где Im, Um — соответствующие максимальной вырабатываемой мощности значения тока и напряжения).
Выходная мощность равна
P = IU = IsU(e4U/kT — 1) — ^U.
 |
Условие максимума выходной мощности можно найти, при dP/dU = 0. Отсюда получаем
|
|
 |
|
|
|
Величина Em соответствует максимальной энергии, выделяемой в нагрузке при поглощении одного фотона с условием оптимального согласования фотоэлемента с внешней цепью. Поскольку величина Em зависит от Is,
она зависит от параметров материала (например т, D, уровень легирования). Идеальная эффективность преобразования реализуется при оптимальном выборе параметров материала, когда величина Is минимальна.
Важным параметром, характеризующим качество солнечных элементов, является коэффициент формы, или коэффициент заполнения вольтамперной характеристики k:
 UmIm их. хІк. з
UmIm их. хІк. з
Отсюда
Pm = U хІк. з.
Из уравнения (2.23) следует, что коэффициент формы указывает, насколько реальная ВАХ солнечного фотоэлемента отличается от идеальной, которая представляет собой прямоугольную ступеньку с напряжением их х и током Ік з.
Коэффициент формы для кремниевых солнечных батарей с p-n-пере- ходом находится в диапазоне 0,75…0,85, для СБ на основе GaAs — в диапазоне 0,79…0,87.
В СЭ электронно-дырочные пары могут быть генерированы солнечным излучением как в n-, так и в p-области, в зависимости от того, на какой глубине произошло поглощение фотонов с данной энергией. Электрическое поле вблизи p-n-перехода осуществляет разделение носителей заряда и сбор электронов в n-области, а дырок — в p-области. Однако часть неосновных носителей тока может быть потеряна в результате рекомбинации. Эффективность процесса собирания фотогенерированных носителей оценивается с помощью коэффициента собирания носителей заряда Q. Коэффициент собирания носителей заряда равен отношению количества электронно-дырочных пар, разделенных полем p-n-перехода, к общему количеству генерированных светом электронно-дырочных пар
Q j
ЧФ0
23
где Фо — плотность потока фотонов, падающих на поверхность элемента.
Величина Q сильно зависит от коэффициента поглощения, т. е. от длины волны излучения [17].
Идеальная спектральная зависимость коэффициента собирания носителей заряда для полупроводника с шириной запрещенной зоны Eg представляет собой ступеньку: он равен 0 при hv < Eg и равен 1 при hv > Eg (рис. 2.18). Реальная спектральная характеристика имеет вид кривой с максимумом. Максимальное значение Q для обычных преобразователей близко к единице и для кремния соответствует области X — 0,8-0,9 мкм, а для GaAs X — 0,7-0,8 мкм. При достаточно больших длинах волн коэффициент поглощения уменьшается и при а^-0 величина Q также стремится к нулю, поскольку Q ~ а. На границе собственного поглощения спектральная чувствительность и коэффициент собирания обращаются в нуль. Для кремния край собственного поглощения находится при X = 1,1 мкм, для GaAs — при X = 0,9 мкм [18].
 |
|||
Наконец, эффективность преобразования солнечного элемента (или КПД) равна отношению максимальной выходной мощности к мощности падающего излучения Ризл:
Величину фотоЭДС, которая устанавливается в состоянии равновесия при освещении перехода излучением постоянной интенсивности, можно получить из уравнения вольт-амперной характеристики (см. уравнение (2.16)).
Эквивалентная схема идеального солнечного элемента на основе ^«-перехода представлена на рис. 2.6. Через р-«-переход течет ток, который равен Is _eeU^k -1]. Ток насыщения Is для идеального фотоэлемента определяется выражением (2.17). ^-«-переход шунтируется нагрузкой (сопротивление R), в которую отбирается ток I. Параллельно р-«-переходу расположен генератор тока с силой тока 1ф, описывающий возбуждение неравновесных носителей солнечным излучением.
Рис. 2.6. Эквивалентная схема солнечного элемента
Вольт-амперная характеристика такого прибора представлена выражением
I = ЦееШТ — і) — /ф. (2.18)
Величина фототока 1ф определяется числом избыточных носителей заряда, созданных светом и дошедших до p-n-перехода, и равна
1ф = J’qP = eYPSIи/^v, (2.19)
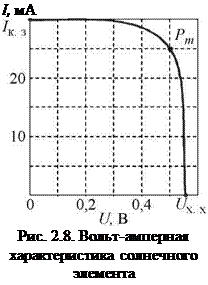
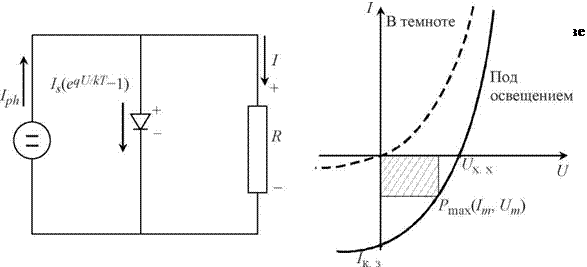 |
где Jф — плотность фототока; S — площадь p-n-пе- рехода; у — доля непрорекомбинировавших пар носителей заряда, пришедших к p-и-переходу; Р — квантовый выход; 1и — интенсивность излучения.
Это выражение справедливо для случая, когда весь падающий на полупроводник свет поглощается.
Из выражения (2.18) следует, что график вольт-амперной характеристики (ВАХ) освещенного p-n-перехода может быть получен путем перемещения всей темновой ВАХ вдоль оси токов вниз на величину 1ф (рис. 2.7).
Уравнение ВАХ остается справедливым при освещении фотоэлемента светом произвольного спектрального состава, изменяется лишь значение фототока 1ф.
Поскольку ВАХ под освещением проходит через четвертый квадрант, направление тока через p-n-переход противоположно полярности приложенного напряжения (рис. 2.8). Это означает, что прибор в данном случае служит источником энергии. Если освещенный переход нагружен сопротивлением, то в цепи течет фототок без применения внешнего источника напряжения.
1.4.1. Фотовольтаический эффект вp-n-переходах
На p-n-переходах существует контактная разность потенциалов [14]—[16]. Этот потенциальный барьер обусловлен электрическим полем, которое появляется в результате диффузии основных носителей заряда через p-n — переход. При термодинамическом равновесии положение уровня Ферми во всей системе постоянно и энергетическая схема p-n-перехода отображена на рис. 2.5. В этом случае токи обусловлены свободными носителями заряда, генерируемыми за счет теплового возбуждения, и в равновесии суммарный ток равен 0.
|
Рис. 2.5. Энергетическая схема p-n-перехода и токи носителей заряда при термодинамическом равновесии (а) и освещении (б), (в) Предположим теперь, что на p-n-переход падают фотоны с энергией, большей, чем ширина запрещенной зоны. В результате поглощения фотона возникает электронно-дырочная пара. Под действием внутреннего поля в p-n-переходе созданные светом носители заряда движутся в противоположных направлениях: дырки — в p-область, а электроны — в «-область. Эти перешедшие через p-n-переход носители заряда создадут добавочный ток. Так как перешедшие в p-область избыточные дырки уменьшают отрицательный объемный заряд, то энергетические уровни в p-области снижаются, в результате чего происходит понижение потенциального барьера. |
Следовательно, разделение фотогенерированных носителей электрическим полем в приконтактной области р-«-перехода приводит к возникновению разности потенциалов, приложенной к р-«-переходу в прямом направлении, называемой фотоЭДС. Это эквивалентно приложению напряжения U в прямом направлении к неосвещенному р-«-переходу
Электроны из «-области и дырки из p-области, преодолевая пониженный потенциальный барьер, будут инжектированы в другую область, где они станут неосновными носителями заряда и рекомбинируют. При этом токи, обусловленные инжектированными носителями заряда, направлены из p — в «-область. Стационарное состояние установится тогда, когда число создаваемых светом электронно-дырочных пар сравняется с числом носителей заряда, уходящих через пониженный потенциальный барьер р-«-перехода. Если р-«-переход соединен с внешней цепью, то можно измерить фотоЭДС. Следовательно, освещенный р-«-переход действует как фотоэлемент.
Процесс преобразования солнечной энергии в электрическую можно условно разбить на четыре стадии: 1) поглощение света; 2) генерация электронно-дырочных пар; 3) разделение носителей заряда р-«-переходом; 4) сбор носителей заряда на электродах.
Эти четыре стадии преобразования солнечной энергии можно выделить в работе практически всех существующих солнечных элементов. Непродуктивная работа любой из этих стадий приводит к понижению эффективности преобразования энергии солнечного элемента в целом.
Рекомбинационный ток через p-n-переход солнечной батареи обусловлен рекомбинацией электронов и дырок через глубокие уровни в области объемного пространственного заряда. Электроны из n-области не проникают в p-область, а захватываются глубокими уровнями в области объемного заряда p-n-перехода. На эти же уровни попадают и дырки из p-области. В результате рекомбинации носителей глубокие уровни освобождаются, и процесс может повториться.
Использование статистики Шокли — Рида — Холла позволяет получить следующее выражение для рекомбинационного тока:
enWA j
Ir = I02[exp (eV/mkT) — ^ 102 = , J,
2УІ X«0X p0
где I02 — ток насыщения; W — ширина обедненной области; тП0, Тр0 — время жизни неосновных носителей электронов и дырок в р — и «-области соответственно; m — коэффициент идеальности; Aj — площадь поперечного сечения.
Для I02 можно также записать
 г ^3/2
г ^3/2
102 о Т exp
Величина коэффициента m изменяется от 1 до 2 в зависимости от положения глубокого уровня в запрещенной зоне. В частности, m = 2, когда рекомбинация электронно-дырочных пар происходит на уровне в середине запрещенной зоны, и m < 2, когда рекомбинационный центр расположен не в середине запрещенной зоны.
Диффузионный ток в большей степени зависит от температуры, чем рекомбинационный, поскольку Id ~ nfeeUkT, а Ir ~ щееи1кТ. Для типичных кремниевых солнечных батарей на основе p-n-перехода инжекцион — ный ток находится в диапазоне от 10-8 до 10-12 А/см2, в то время как величина рекомбинационного тока зависит от плотности рекомбинационных центров в области объемного пространственного заряда. Наличие реком-
бинационного тока в темновом токе заметно при малых и средних прямых смещениях и уменьшается при высоких прямых смещениях. Для солнечных батарей на основе высококачественных полупроводников рекомбинационным и туннельным токами можно пренебречь.